

湿台清洗中颗粒去除的新概念
今日头条
描述
摘要
对于亚微米或深亚微米 ULSI 的制造,完全抑制在硅晶片表面产生的颗粒和污染非常重要。清洁需求的传统概念是使用化学成分(APM、氨和过氧化氢混合物)发挥主要作用。不幸的是,SC-1 (APM) 对表面损伤有负面影响。近年来,它已被修改为加入更稀的溶液,以减少由氢氧化铵引起的表面微观粗糙度。在本文中,提出了一种新思路,即使用去离子水快速倾倒冲洗 (QDR) 模式从对话设置转变为改进模式。使用 DIW 进行修改的修改配方可以在加工过程中完全去除颗粒。
介绍
随着半导体器件特征尺寸的不断缩小。需要了解颗粒去除机制并认识到其优点和局限性。在本文中,一些粒子去除模型被修改为能够去除软粒子变形。研究了改进的 RCA 晶片清洗,使用/不使用兆声波能量增强和各种冲洗技术,用于深亚微米半导体器件制造。
对湿法清洁的需求,提出用于半导体工艺的无颗粒基板变得越来越重要。随着半导体器件的缩小,硅和二氧化硅衬底对污染的敏感性增加。特别是在亚微米和深亚微米超微集成电路的制造过程中,基板的表面微结构和表面清洁度将增加其对器件性能和可靠性至关重要的重要性。本文还介绍了一项综合研究,使用表面分析和检测技术来测试各种清洁配方下的颗粒去除率,包括 (1) Mega-sonic-on 和 (2) 快速转储冲洗 (QDR) 模型。
背景
随着半导体器件按比例缩小,超清洁表面变得更加重要。在器件制造中,传统的 RCA 清洗工艺和稍微改变的工艺在过去的三年中一直在使用. 对用于半导体加工的清洁、无颗粒基板的需求变得越来越重要。随着器件尺寸的减小,硅和二氧化硅衬底对污染的敏感性增加。
实验
使用 8 英寸 Si (100) P 型外延晶片作为基板进行颗粒去除效率实验。对于有意的颗粒污染,裸硅晶片通过覆盖厚的氧化晶片(> 1000A) 并浸入 HF 溶液中。带有落下粒子的 C/W 的详细过程如图 1 所示。
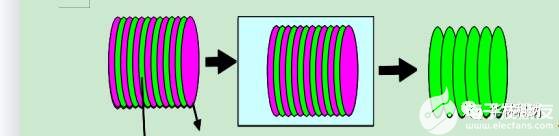
兆声波输出功率从 150 瓦到 600 瓦不等,分为五个级别。众所周知,兆声波可以安全地去除颗粒。图 6 显示,当兆声波输出功率增加时,颗粒去除率也在增加。正如 Heui-Gyun Ahn、Sang-Young Kim 和 Jeng-Gun Lee 报道的那样 兆声波束平行于晶片表面。图案化晶圆清洗可以模拟为晶圆表面的质量转移。一般情况下,开启兆声功率可以提高颗粒去除率,在各种输出功率下提高6~28%左右。尤其是在去除颗粒时实施的兆声功率输出将在450W的兆声功率下具有最佳条件。
结论
这与对话配方(模式 A)有一些不同,包括:(i) 增加了 10 秒的空闲时间和 (2) 使用冷 DIW。修改后的配方比去除粒子的对话配方更有效。使用改进的 QDR 模式 B 配方,PRE(颗粒去除率效率)超过 94%。
审核编辑:汤梓红
-
为什么在塑料颗粒在测量前要清洗2021-10-18 967
-
湿法清洗系统对晶片表面颗粒污染的影响2022-03-02 794
-
SPM引入的颗粒FSI无法去除,不知为何?2011-04-14 0
-
SPM引入的颗粒,为何FSI也无法去除?2011-04-14 0
-
关于刷洗清洗过程中的颗粒去除机理的研究报告2022-01-18 681
-
湿法清洗过程中硅片表面颗粒的去除2022-02-17 2669
-
半导体工艺—晶片清洗工艺评估2022-03-04 2905
-
湿法和颗粒去除工艺的简要概述2022-04-08 1522
-
湿法和颗粒去除工艺详解2022-04-11 830
-
湿法清洗过程中的颗粒沉积和去除研究2022-06-01 7263
-
湿法清洗中去除硅片表面的颗粒2022-07-05 2325
-
RCA清洗中晶片表面的颗粒粘附和去除2022-07-13 1897
-
湿清洗过程中硅晶片表面颗粒去除2023-03-30 2347
-
在湿台工艺中使用RCA清洗技术2023-12-07 756
-
去除晶圆表面颗粒的原因及方法2024-11-11 410
全部0条评论

快来发表一下你的评论吧 !

