

单片SPM系统的清洗技术
今日头条
1191人已加入
描述
摘要
单片SPM系统使用了大量的化学物质,同时满足28nm以下的清洁规格。 本文描述了在集成系统Ultra-C Tahoe中使用批量SPM系统和单晶片清洗,结果达到了技术规范,使用了不到单晶片系统中使用的80%的SPM化学物质。
介绍
采用干法和湿法相结合的方法开发了传统的有机光刻胶条工艺。 然而,基于反应性等离子体灰化的干燥处理也存在一些问题,如等离子体损伤、抗爆裂、不完全去除抗蚀剂,以及副产品再沉积,需要后续进行湿剥离/清洗。 为了避免等离子体问题,采用了以硫酸和过氧化氢水溶液(SPM在80℃-150℃)等酸性化学物质为基础的湿汽提工艺。
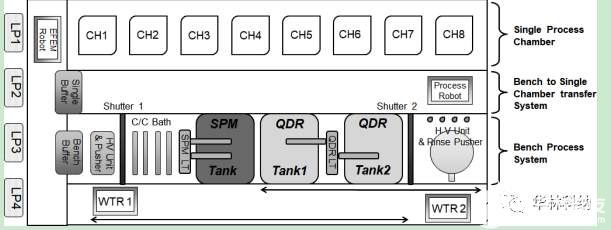
图1:Ultra C太浩清洗系统的简化装置

图2:使用超音波装置或氮气喷雾装置的单片清洗装置
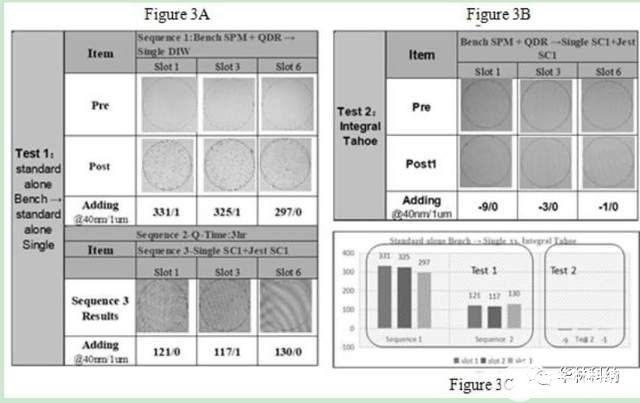
图3:独立工作台、独立单晶片和Ultra-C Tahoe整体清洗性能对比
审核编辑:汤梓红
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
SPM在工业清洗中的应用有哪些2025-12-15 900
-
半导体清洗中SPM的最佳使用温度是多少2025-11-11 754
-
槽式清洗和单片清洗最大的区别是什么2025-06-30 1645
-
spm清洗会把氮化硅去除吗2025-04-27 1296
-
spm清洗和hf哪个先哪个后2025-04-07 1802
-
SPM45H 中的智能功率模块 Motion SPM®2022-11-15 652
-
Mini DIP SPM® 中的智能功率模块 Motion SPM®2022-11-14 680
-
SPM光刻胶剥离和清洗工艺详解2022-07-11 10555
-
基于RCA清洗系统的热模型以及清洗液的温度控制法2022-04-15 1679
-
机房带电清洗养护技术的应用2020-09-10 3003
-
SPM2和SPM3智能功率模块简述2018-10-24 2537
-
pcb清洗技术。绝对有用2012-07-23 3124
-
SPM引入的颗粒FSI无法去除,不知为何?2011-04-14 1745
全部0条评论

快来发表一下你的评论吧 !

