

光刻胶剥离和光掩模清洁的工艺顺序
今日头条
描述
本文一般涉及处理光掩模的领域,具体涉及用于从光掩模上剥离光致抗蚀剂和/或清洗集成电路制造中使用的光掩模的设备和方法。
光掩模是涂有金属层的透明陶瓷衬底,该金属层形成电子电路的图案。在集成电路的制造过程中,薄膜通常用于密封光掩模使其免受颗粒污染,从而隔离和保护光掩模表面免受来自光掩模图案焦平面的灰尘或其他颗粒的影响。为了以高成品率生产功能性集成电路,光掩模和薄膜需要无污染。光掩模的污染可能发生在光掩模本身的制造过程中,也可能发生在光掩模的使用过程中集成电路制造过程中的光掩模,特别是光掩模加工和/或处理过程中的光掩模40。一种类型的污染是光掩模表面的有机/分子污染。光掩模表面上的有机/分子污染物,例如化学污渍或残留物,降低并降低了透射率特性45和/或光掩模的特性,最终影响被制造的半导体器件的质量。
光刻过程中影响集成电路质量的另一种污染是微粒污染。颗粒污染物可以包括任何小颗粒,例如灰尘颗粒,它们可以在光掩模上或者夹在光掩模和薄膜之间。
光刻过程中投射的是从光掩模表面剥离光刻胶。类似于集成电路器件的制造,在光掩模的制造过程中,光致抗蚀剂被施加到光掩模的表面,并且光和/或紫外线辐射以期望的电路图案被施加到光掩模表面。
在光掩模制造过程中和作为集成电路维护的一部分,光掩模的制作和清洁10个晶圆厂。常规方法使用硫酸和过氧化氢的高温混合物(“SPM”)来在第二步中剥离光致抗蚀剂和浓缩的氢氧化铵/过氧化氢(“APM”)的高温混合物,以进一步清洁光掩模。
目前,光致抗蚀剂清洗过程通常在单个掩模喷雾清洁器工具上完成。目前的清洁技术包括喷涂/刷洗清洁,这种清洁使用混合的SPM,然后是氨清洁。现有技术工艺的问题在于,它们经常遭受不良的化学混合或非常差的冲洗,导致表面上的高硫含量,这由于雾度而对随后的掩模制造或照相工艺产生负面影响。
因此,本次的目的是提供一种用于光致抗蚀剂剥离和/或光掩模清洗的方法和系统,该系统在集成电路制造过程中增加了器件产量、减少光掩模上的缺陷和/或污染。也增加了光掩模的寿命。
进一步优选的是,当应用于光掩模时,自组装膜基本上没有气泡。无气泡SOM的使用增强了兆声声学传输,并导致污染物去除的改善。该系统还可以包括向光掩模提供臭氧化去离子水(DIO)的装置和在低于30℃的温度下向光掩模提供氢氧化铵和过氧化氢的稀水溶液的装置。可配备一个在线冷却器,以确保dAPM得到充分冷却。还可以包括向光掩模供应干燥流体的装置。
图1是根据本发明实施例的适于剥离和/或清洁光掩模的湿式工作台系统的示意图。

图2是根据本发明实施例的适于剥离和/或清洁光掩模的单晶片系统的示意图。

图3是一对照片,比较了根据本发明在清洁之前和清洁之后光掩模上的污染。
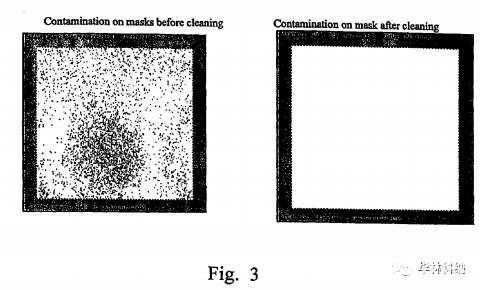
图4是显示二元光掩模清洁粒子50的曲线图,光掩模的暗区域和亮区域的结果。图5是显示an的清洁。

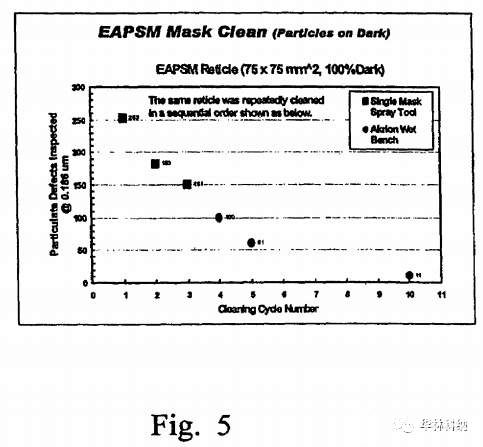
结果的曲线图
根据本发明实施例的具有100%暗区的EAPSM掩模。
审核编辑:汤梓红
-
图形反转工艺用于金属层剥离的研究2009-10-06 10531
-
Futurrex高端光刻胶2010-04-21 4006
-
Microchem SU-8光刻胶 2000系列2018-07-04 4831
-
光刻胶2018-07-12 3016
-
光刻胶在集成电路制造中的应用2018-08-23 7442
-
浅谈EUV光刻中的光刻胶和掩模等材料挑战2023-04-13 3085
-
光刻胶的图形反转工艺2024-07-09 2460
-
光刻胶的类型及特性2025-04-29 10752
-
光刻胶剥离液及其制备方法及白光干涉仪在光刻图形的测量2025-05-29 1573
-
减少光刻胶剥离工艺对器件性能影响的方法及白光干涉仪在光刻图形的测量2025-06-14 1095
-
低含量 NMF 光刻胶剥离液和制备方法及白光干涉仪在光刻图形的测量2025-06-17 979
-
用于 ARRAY 制程工艺的低铜腐蚀光刻胶剥离液及白光干涉仪在光刻图形的测量2025-06-18 1106
-
金属低蚀刻率光刻胶剥离液组合物应用及白光干涉仪在光刻图形的测量2025-06-24 980
-
针对晶圆上芯片工艺的光刻胶剥离方法及白光干涉仪在光刻图形的测量2025-06-25 1342
-
光刻胶剥离工艺2025-09-17 2543
全部0条评论

快来发表一下你的评论吧 !

