

 半导体清洗液中溶解氢气对晶圆清洗的影响
半导体清洗液中溶解氢气对晶圆清洗的影响
今日头条
描述
在最近的半导体清洁方面,以生物碱为基础的RCA清洁法包括大量的超纯和化学液消耗量以及清洁时多余薄膜的损失; 由于环境问题,对新的新精液和清洁方法的研究正在积极进行。 特别是在超纯水中混合气体,利用Megasonic进行功能水清洁,是为了解决传统RCA清洁液存在的问题而进行的清洁液。
本研究将高纯度的氢气作为气体接触器; pHasorⅡ和可调节循环速度的水泵, 用BPS-3持续超纯水与氢气混合的方法制备了氢气水,用溶解氢浓度计、DHDI-1确定了氢气水的浓度。 在0.1 MPa压力下,在3LPM的氢气流出速度下,得到了最大2.0 ppm的氢气水,为了评价氢气水的基础特性,测定了氢气浓度变化下的pH值、表面能。 同时测量了压力变化下的半衰期,评价了其在bath型清洁器中应用的可行性。 氢水的清洁力利用Si3N4颗粒被任意污染的硅晶片,在bath和梅叶式清洁器中,将氢水浓度和兆芯形态及添加剂变化后的清洁效率分别与现有的SC-1清洁液进行比较。
在功能水发生装置中,在卸压的情况下,观察到平均半衰期为20分钟, 确定了在压力保持的情况下,氢数的浓度保持不变,对于pH值,随着氢数浓度的逐渐增加而减小,在2.0 ppm的浓度下,pH值为5.3左右,表面张力与超纯相比,可以确定无显著变化。在Bath型的清洁器中,认可megasonic对氢的清洁效率进行了测量,测量结果与相同条件下实验的超纯水相似,比SC-1低。 而在梅叶式洗脱机上进行了同等条件的实验,结果表明,在氢水洗脱机中,由于添加剂的影响,具有较高的颗粒去除效率,可以替代SC-1。
本论文是用反应性BCl3等离子体对GaAs进行干法蚀刻后,对其结果进行研究分析的。 此时采用的蚀刻工艺参数为BCl3等离子体中气体流量、工艺压力和RIE尺功率的变化。 首先将工艺压力固定在75 mTorr,然后改变BCl3流量(2.5~10 sccm)进行了试验。 并将BCl3的流量固定在5sccm,然后改变工艺压力(47~180 mTorr),进行了蚀刻实验。 最后在47 mTorr和100 mTorr各自的工艺压力下,改变RF尺功率(50~200 W)进行了实验。
在GaAs等离子体蚀刻结束后,采用表面落差测量仪对表面的落差和粗糙度进行了分析; 随后利用所得结果进行了蚀刻率、蚀刻表面粗糙度、蚀刻选择比等蚀刻特性评价。 并利用光学发光分析仪对蚀刻工艺中样品尺产生的磁偏置和BCl3等离子体气体进行了等离子体的状态实时分析。
总结所产生的GaAs的蚀刻结果可以发现,将5sccm的BCl3气体流量和RF尺功率固定在100W时,蚀刻率在47 mTorr时最高,其值为0.42微米/min。 GaAs的蚀刻速度随着工艺压力的增加而降低,在180 mTorr时蚀刻率为0.03微米/min,几乎没有蚀刻。 此外,我们还将工艺压力设置为75 mTorr, 当RF尺功率固定在100 W,BCl3气体流量从2.5 sccm变化到10 sccm时,在10 sccm的BCl3气体流量下测得最高蚀刻率为0.87微米/min。
GaAs随压力蚀刻后的表面粗糙度比较光滑,最大为2纳米左右,在几乎未蚀刻的180 mTorr条件下降低到约1纳米。 在本实验条件下,GaAs对感光剂的蚀刻选择比最大约在3:1以内。
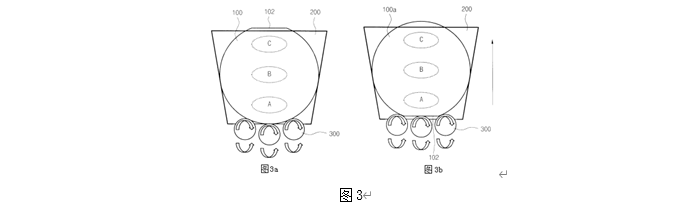
审核编辑:汤梓红
-
超声波清洗的工作原理2009-06-18 9627
-
半导体清洗设备2016-09-05 15056
-
怎样清洗液晶显示器|如何清洗液晶显示器2008-06-10 1161
-
半导体清洗工艺全集2011-12-15 4604
-
硅晶圆表面金属在清洗液中的行为2022-03-21 894
-
Si晶圆表面金属在清洗液中的应用研究2022-03-28 1636
-
用于硅晶圆的全新RCA清洗技术2022-04-21 2517
-
半导体晶圆清洗设备市场 2023-2030分析2023-08-22 2820
-
半导体晶圆清洗设备市场:行业分析2023-04-03 3784
-
全自动晶圆清洗机是如何工作的2025-01-10 1715
-
半导体单片清洗机结构组成介绍2025-04-21 2324
-
硅清洗液不能涂的部位有哪些2025-07-21 945
-
晶圆清洗工艺有哪些类型2025-07-23 2709
-
标准清洗液sc1成分是什么2025-08-26 2123
-
半导体制造中晶圆清洗设备介绍2026-01-27 1078
全部0条评论

快来发表一下你的评论吧 !

