

应用材料公司以技术助力极紫外光和三维环绕栅极晶体管实现二维微缩
电子说
描述
Ÿ 应用材料公司利用 Stensar™CVD取代旋涂镀膜以扩展二维极紫外光逻辑微缩
Ÿ 预览最广泛的三维环绕栅极晶体管技术产品组合,包括两种全新的IMS™系统
2022 年 4 月 21 日,加利福尼亚州圣克拉拉市——应用材料公司推出了旨在帮助客户利用极紫外光(EUV)继续推进二维微缩的多项创新技术,并详细介绍了业内最广泛的下一代三维环绕栅极晶体管制造技术的产品组合。
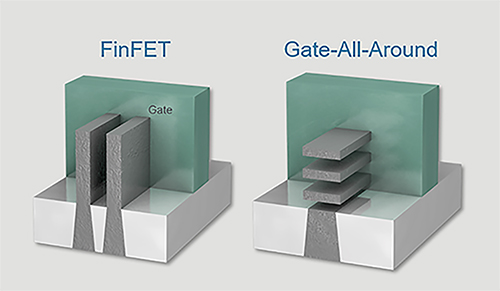
环绕栅极(GAA)晶体管将成为自2010年FinFETs问世以来芯片行业最大的设计转变之一
材料工程的创新为GAA晶体管提供了功率和性能的提升
要在未来若干年内提升晶体管密度,芯片制造商正在寻求互补的两条道路。其一是延续传统的摩尔定律二维微缩,也就是使用 EUV光刻和材料工程打造出更小的特征。另一条则是使用设计技术协同优化(DTCO)和三维技巧,对逻辑单元布局进行巧妙优化,这样无需对光刻栅距进行任何更改即可增加密度。后一种方法包括后段连线和环绕栅极(GAA)晶体管,即使面临传统二维微缩的减缓,仍将有力推动逻辑密度在未来几年内的持续增长。通过将这些技术有机结合,可以帮助芯片制造商完成逻辑芯片在未来的迭代进化,同时实现功率、性能、面积、成本和上市时间(即 PPACt)的同步改善。
应用材料公司高级副总裁、半导体产品事业部总经理珀拉布∙拉贾博士表示:“应用材料公司的核心战略是成为赋能客户的PPACt赋能企业™,依托我们现有的七大创新,支持客户利用EUV继续推进二维微缩。同时,我们还详细介绍了GAA晶体管的颠覆性制造方法,该方法与现今FinFET晶体管截然不同。不仅如此,应用材料公司已经准备好了覆盖范围最广泛的GAA制造产品线,包含涉及外延生长、原子层沉积和选择性材料刻蚀的全新生产步骤,以及两项全新的用于制造理想GAA氧化栅极和金属栅极的集成材料解决方案(Integrated Materials Solutions™)。”
二维微缩的扩展
极紫外光(EUV)光刻的出现使芯片制造商得以产出更小的特征,并增加晶体管密度。但行业目前的现状是:要继续利用EUV进行微缩困难重重,迫切需要全新的沉积、刻蚀和量测方法。
完成EUV光刻胶显影后,需要先通过称为过渡层和硬掩模的一系列中间层对芯片图形进行刻蚀,随后才能将其最终刻蚀到晶圆上。迄今为止,这些中间层都是使用旋涂技术来进行沉积的。今日,应用材料公司推出使用该公司的Precision化学气相沉积系统来进行沉积,适用于EUV的 Stensar™ 先进图形镀膜(Stensar™ Advanced Patterning Film for EUV)。相较于旋涂沉积,应用材料公司的CVD膜可帮助客户对EUV硬掩模层进行微调,使其达到特定厚度和刻蚀弹性,以便在整个晶圆上EUV图形传输时达成接近完美的均匀性。
应用材料公司还详解了其Sym3® Y刻蚀系统的特殊功能,即允许客户在相同反应腔内进行材料刻蚀和沉积,这样可先改善EUV图形,再将其刻蚀到晶圆上。Sym3反应腔会轻轻移除EUV光刻胶材质,然后以特殊方式重新进行材料沉积,使图形变均匀,从而消除因“随机误差”而产生的图形易变性。改善后的EUV图形可提高良率、降低芯片功耗并提升其性能。因此,位居DRAM市场中导体刻蚀系统首要供应商位置的应用材料公司,正在凭借其Sym3技术的飞速发展,将客户群体从存储器领域拓展到晶圆代工厂/逻辑芯片领域。
应用材料公司还展示了如何将其PROVision® eBeam量测技术用于深入观察多层芯片内部,以便精确测量整个晶圆上的EUV图形化特征,帮助客户解决其他量测技巧可能无法诊断的“边缘布局错误”。应用材料公司2021年电子束系统的营收几乎翻倍,使其跃居电子束技术供应商榜首的位置。
三维环绕式栅极晶体管工艺设计
新兴的GAA晶体管为客户示范了如何利用三维设计技巧和DTCO布局创新来对二维微缩加以补充,即使二维微缩速度放缓,仍可快速提升逻辑密度。材料工程领域的创新同时还有助于GAA晶体管降低功耗和提升性能。
在FinFET中,构成晶体管电子路径的垂直沟道是由光刻和刻蚀来形成的,这种工艺会导致沟道宽度不均匀。而这种不均匀性则会对功耗和性能产生不利影响,这也是客户转投GAA的另一个主要原因。
GAA晶体管看上去就像是FinFET晶体管旋转了90度,使沟道从垂直变为水平。GAA沟道是通过使用外延生长和选择性材料刻蚀来形成的,这种技术使客户得以精确设计宽度,实现宽度均匀,从而获得最优功耗和性能。外延生长系统恰恰是应用材料公司的首项产品,自此之后,它便一跃成为市场领头羊。2016年,应用材料公司发布Selectra®系统并在其中率先启用选择性材料刻蚀技术,迄今已提供1000余个反应腔给客户使用,并位居市场领袖地位。
GAA晶体管的主要制造挑战在于沟道间距仅约10纳米,在如此微小的空间内,客户必须在围绕各沟道的全部四周进行多层氧化栅极和金属栅极堆叠的沉积。
应用材料公司专为氧化栅极堆叠开发了IMS™(集成材料解决方案)系统,通过将氧化栅极变薄,增加了驱动电流并提升晶体管性能。但氧化栅极越薄,通常就会导致漏电流越高,造成功耗浪费和发热。应用材料公司全新的IMS™系统将等效氧化层厚度降低1.5埃,使设计师无需增加栅极漏电流即可提升性能,或者在保持性能不变的前提下,使栅极漏电流减小至原先的十分之一以下。它将原子层沉积(ALD)、热处理步骤、等离子处理步骤和量测整合到单一高真空系统内。
应用材料公司还展示了IMS系统,该系统用于GAA金属栅极的工艺,支持客户借由调整栅极厚度来微调晶体管阈值电压,以满足从电池供电式移动设备到高性能服务器在内的各种特定计算应用的每瓦特功耗性能目标。它可在高度真空环境内执行高精度金属原子层沉积步骤以防止空气污染。
应用材料公司已经在4月21日举办的“全新微缩之旅”大师课上,提供了有关其逻辑微缩解决方案的更多详情。
-
二维和三维Gauss随机粗糙面的Monte Carlo仿真2010-05-28 2617
-
三维触控技术突破“二向箔”的束缚2016-12-19 3276
-
三维设计应用案例2019-07-03 2561
-
芯片里面100多亿晶体管是如何实现的2020-07-07 3661
-
什么是GaN透明晶体管?2020-11-27 2914
-
安徽三维动画制作和二维动画有哪些区别呢?(一)2022-01-22 24999
-
安徽三维动画制作和二维动画有哪些区别呢?(三)2022-01-25 22498
-
LED三维显示系统设计方案2016-01-06 13724
-
如何生产3纳米以下全环绕栅极晶体管?2020-09-29 4750
-
剖析二维电子器件的高k介电薄膜——氟化钙2021-04-20 6004
-
准费米能级相空间及其在双极型二维场效应晶体管中的应用2022-05-26 2695
-
应用材料公司推出全新Ioniq™ PVD系统助力解决二维微缩下布线电阻难题2022-05-27 3373
-
二维半导体晶体管实际沟道长度的极限2022-10-17 4296
-
基于高温共烧陶瓷基板的三维互连技术2022-11-16 2874
-
制造二维TMD晶体管面临的挑战2023-11-07 3196
全部0条评论

快来发表一下你的评论吧 !

