

一种在衬底上蚀刻氮化硅的方法
今日头条
描述
引言
本文提供了用于蚀刻膜的方法和设备。一个方面涉及一种在衬底上蚀刻氮化硅的方法,该方法包括:(a)将氟化气体引入等离子体发生器并点燃等离子体以a形成含氟蚀刻溶液;(b)从硅源向等离子体提供硅;以及(c)将氮化硅暴露于蚀刻物质,以相对于衬底上的其他含硅材料选择性地蚀刻氮化硅。硅源可以提供给衬底上游的等离子体。在一些实施例中,硅源被提供给远程等离子体发生器中的等离子体。替代地或附加地,硅源可以被提供给衬底和容纳衬底的腔室的前端之间的等离子体。硅源可以在容纳衬底的室的喷头处或附近提供给等离子体。
硅源可以包括两个或多个硅源。在各种实施例中,硅源是固体。硅源的例子包括含硅化合物,例如石英、硅、硅锗、碳化硅和氧化硅。在一些实施例中,硅源是包括硅的适配器环。在一些实施例中,硅源是包括硅的气体扩散器。衬底可以容纳在包括喷头的腔室中,喷头可以包括硅。在一些实施例中,硅源附着到等离子体发生器的壁上。
在各种实施例中,硅源是硅源,并且可以是含硅化合物。例如,进入容纳衬底的腔室的气体总流量的至少约0.5%(体积)可以是硅源。流体硅源的例子包括硅烷、乙硅烷、四氟化硅、四氯硅烷、正硅酸乙酯和四甲基硅烷。
实验
进行了一项实验,表明硅源的存在提高了氮化硅对氧化硅和多晶硅的蚀刻选择性。测试了三个过程,每个过程在两个不同的室环境中测试。一个腔室环境用于在没有硅源的情况下进行处理。另一个腔室环境用于执行硅源工艺。进行了比较使用和不使用硅源的李思-康氮化物对TEOS和多晶硅的蚀刻选择性的实验。第一组试验的实验在1.5托的压力下进行,电感耦合等离子体(ICP)设置在2000瓦的功率下。流动NGO和O以促进10℃的基座温度下的蚀刻
在第一组试验中,将包括通过等离子体增强化学气相沉积(PECVD)沉积的氮化硅层、正硅酸四乙酯(TEOS)和多晶硅的衬底暴露于四氟化碳(CFR)和氧与一氧化二氮(O/N;o)没有硅源。第二组试验的实验在至少1托的压力下进行,电感耦合等离子体功率约为1000瓦。对于蚀刻工艺,约10,000 sccm的非政府组织和氧一起流入腔室以促进蚀刻。
在第二组试验中,将包括一层PECVD沉积的氮化硅、TEOS和多晶硅的衬底暴露于CFR和O/N;o在一个腔室中,10个固体硅片贴在线圈附近,靠着远程等离子体发生器的壁。
进行了比较使用和不使用硅扩散源的李思-康氮化物对TEOS和多晶硅的蚀刻选择性的实验。进行了第一组试验,确定了没有硅源时氮化硅对TEOS的蚀刻选择性。
图1是描述根据公开实施例的方法的操作的过程流程图
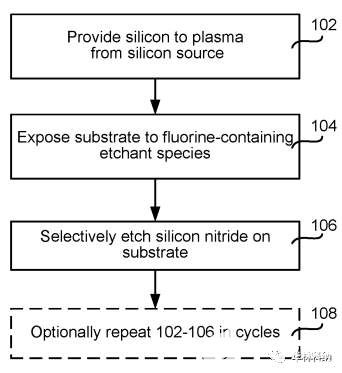
图2A和2B是根据公开实施例的蚀刻方案的示意图
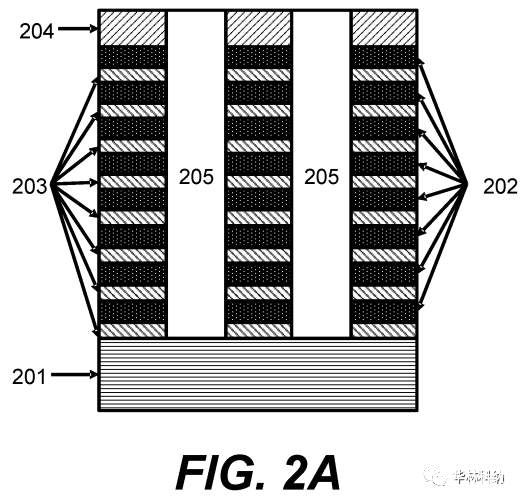
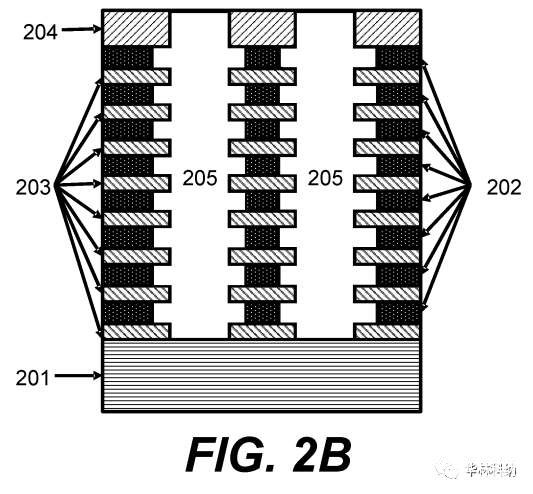
图3、4和5是用于执行根据公开的实施例的方法的处理室的示例的示意图
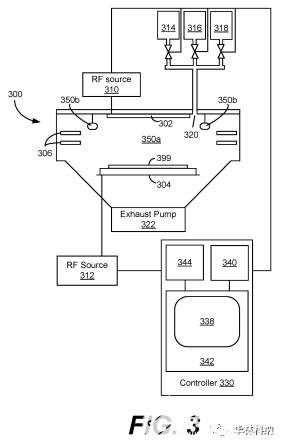
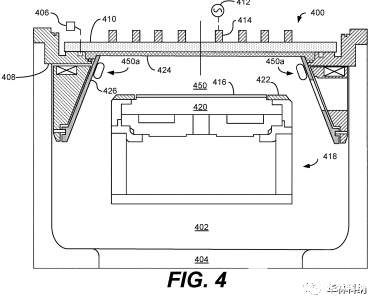

图6A和6B是根据公开的实施例进行的实验结果的条形图
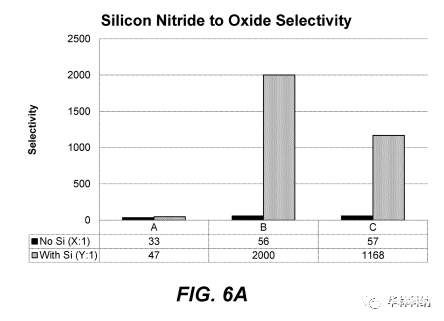

结果和讨论
尽管为了理解清楚的目的已经对前述实施例进行了一些详细的描述,但是显然在所附权利要求的范围内可以进行某些改变和修改。应该注意的是,存在许多实现本实施例的过程、系统和装置的替代方式。因此,本实施例被认为是说明性的而非限制性的,并且实施例不限于这里给出的细节。
审核编辑:汤梓红
-
《氧化铝、碳化硅、氮化硅,谁才是工业陶瓷老大?》2026-04-29 496
-
氧化硅薄膜和氮化硅薄膜工艺详解2025-06-24 2685
-
氮化硅薄膜的特性及制备方法2024-11-29 4380
-
氮化硅薄膜制备方法及用途2024-11-24 3628
-
氮化硅为什么能够在芯片中扮演重要的地位?2023-12-20 5386
-
氮化硅陶瓷基板生产工艺 氮化铝和氮化硅的性能差异2023-07-06 3057
-
氮化硅陶瓷基板的市场优势和未来前景2023-04-11 3229
-
磷酸的腐蚀特性及缓蚀剂 氮化硅湿法蚀刻中热磷酸的蚀刻率2022-08-30 7655
-
用于CVD金刚石沉积的氮化硅表面预处理报告2022-01-21 1460
-
锗对氮化硅中红外集成光子学的波导2021-12-16 2203
-
一种采用氮化硅衬底制造集成光子电路(光子芯片)技术2021-05-24 6754
-
一种采用氮化硅衬底制造光子集成电路的新技术2021-05-06 3655
-
氮化硅基板应用——新能源汽车核心IGBT2021-01-27 1771
-
氮化硅陶瓷基板助力新能源汽车市场2021-01-21 1252
全部0条评论

快来发表一下你的评论吧 !

