

 使用单晶片自旋处理器的背面清洁研究
使用单晶片自旋处理器的背面清洁研究
今日头条
描述
在这项研究中,我们华林科纳使用经济特区单晶片自旋处理器开发了一种单一背面清洁解决方案,能够通过蚀刻晶片背面的几埃来去除任何金属或外来污染物,无论其涂层如何(无涂层、Si3N4或SiO2)。选择H2O:H2O2:H2SO4:HF混合物是因为它允许对3种感兴趣的材料的蚀刻速率进行独立控制,而不会使硅表面变得粗糙,然后,在有意被各种金属污染的晶片上,以及在外来材料沉积或传统铜工艺过程中被污染的“生产晶片”上,检查化学效率。
我们首先通过改变混合物中H2O2和H2SO4的比例来关注硅蚀刻速率,温度设定为60℃以激活Si表面氧化反应,HF浓度为0.5%。随着H2O2含量的增加,硅蚀刻从5.8升至13.5/分钟(图1),但体积比为5:5:1的混合物似乎达到了一个稳定水平,该组合物被选择用于最终的清洁测试;第二步,我们调整HF浓度以达到氮化硅和氧化硅上所需的蚀刻速率,在60°C时,HF浓度为0.1%至0.5%,Si3N4的蚀刻速率为5至25Å/min,SiO2的蚀刻速率为10Å至140Å/min,对于具有最低硅蚀刻速率的混合物(比例为8:2:1,图2),硅蚀刻速率与HF浓度的独立性得到了很好的验证。

我们注意到在过氧化氢含量较高(比例5:5:1)的化学混合物中,0.1% HF的蚀刻速率略有下降,因为预期硅氧化速率随着氧化剂浓度而增加,并且对于非常低的HF浓度,限制步骤可能是氧化硅蚀刻速率,最后,选择0.2%的HF浓度以避免限制硅蚀刻,因为在Si3N4和热SiO 2(60°C)上分别获得10Å/min和35Å/min的合适蚀刻速率,还证实了在5次清洗序列后,AFM在Si晶片上没有记录到显著的粗糙度增加。
我们开发的清洗溶液在处理过渡金属和其他类型的污染物方面表现出了优异的性能,接近at/cm²的初始金属水平是通过硅晶片上的有意污染获得的,然后通过用5∶5∶1/0.2的混合物蚀刻10Ǻ的硅(60秒,在60℃下),甚至在退火的晶片上,获得低于
at/cm²的残留污染水平,在晶片背面发现了随机的金属污染物,清洗后,所有金属的残留污染低于,这使我们能够在“真实”污染情况下验证背面清洗效率。
在沉积和清洗后特定元素(如铟、锡和钇)的污染情况下,我们观察到晶片与晶片之间的初始污染水平差异很大(不是在同一批中沉积的),范围从到at/cm²,清洗后,最终污染水平低于at/cm²。
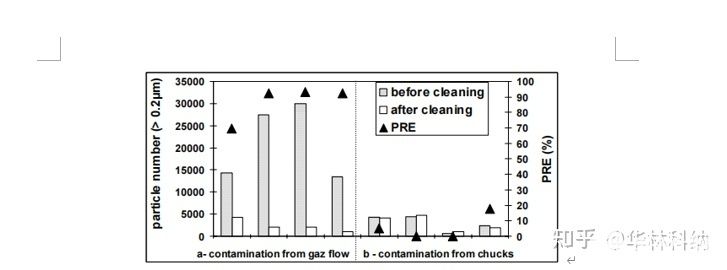
上图中报告的结果说明了降低背面颗粒污染的难度,在封闭室中,来自污染气流的颗粒获得了非常高的初始污染水平(达到饱和水平,在晶片表面上均匀分布),在1分钟内实现了70%至95%的可接受PRE,打扫卫生,然而从工具操作和卡盘接触中去除颗粒要困难得多,在该测试中,初始粒子数要低得多(最多4500个粒子,局限于处理足迹),但PRE几乎可以忽略(0至20%)。
已经证明,焦点更好地与由于处理系统引起的非常大的背面缺陷或粘在光刻工具卡盘上的大颗粒相关,而不是与晶片背面颗粒数相关,背面颗粒污染的规格仍需在工业环境中更完整的研究的基础上确定,以显示背面颗粒污染对产量的影响,如有必要可实施额外的擦洗步骤(刷子或非接触式擦洗器)或使用兆频超声波活化来减少晶片背面的颗粒污染。
由于用于单晶片序列的短处理时间,金属去除仍然存在,在SEZ spin处理器上研究了背面清洁,该处理器具有专门开发的易于使用的化学物质,通过使用相同的配方来去除硅、氧化硅或氮化硅背面涂层上的金属污染物,重点研究了过渡金属和“外来”污染物,并表明无论采用何种基底,都可以获得良好的金属去除效率。
审核编辑:汤梓红
-
单晶片背面和斜面清洁(下篇)2022-06-27 1656
-
GaN单晶晶片的清洗与制造方法2022-04-15 1424
-
关于晶片背面的薄膜蚀刻法说明2022-03-28 2284
-
一种在单个晶片清洁系统中去除后处理残留物的方法2022-03-22 2153
-
高效晶圆背面清洁工艺显得尤为重要2022-03-03 1293
-
单晶片清洗中分散现象对清洗时间的影响2022-03-01 918
-
无化学添加剂的单晶硅晶片的无损抛光2021-12-22 1665
-
Linux内核同步机制的自旋锁原理是什么?2020-03-31 1275
-
晶片边缘蚀刻机及其蚀刻方法2018-03-16 3500
-
TI CC2430单晶片机的范例程式2015-12-29 774
-
娱乐、安全娱乐两不误,车载处理器掀混搭风2014-08-19 951
-
Cypress推出PRoC-UI单晶片解决方案2012-10-26 2107
-
SiC单晶片CMP超精密加工技术现状与趋势2010-10-21 952
-
单晶片PLL电路2008-08-17 2581
全部0条评论

快来发表一下你的评论吧 !

