

 聚乙烯醇刷非接触洗涤对CMP后清洗的影响
聚乙烯醇刷非接触洗涤对CMP后清洗的影响
今日头条
描述
全接触洗涤被认为是去除晶圆表面污染的最佳有效清洁方法之一。为了使刷与晶片之间的小间隙最大限度地增加水动力阻力,在晶片上安装了压电传感器(圆片型)。为了研究磨料颗粒在Cu和PETEOS(等离子体增强四氯硅酸盐)上的附着力,测定了胶体二氧化硅磨料、Cu和PETEOS之间的相对zeta电位。本文研究了聚乙烯醇刷非接触洗涤对cmp后清洗的影响。
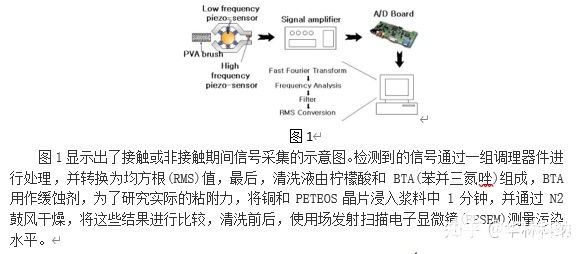
如图2所示,通过刷子旋转使用流体动力阻力,横截面积为的浸没颗粒上的拖曳力表示为等式,牛顿流体中的球形颗粒上的拖曳力可以用等式表示,阻力随着刷子转速的增加而线性增加,如下式所示,在等式2中,是清洗溶液的密度,是颗粒的直径,是流速,其取决于刷子和晶片之间的间隙,是阻力系数,对于暴露在基于颗粒直径的雷诺数为0.04~40的速度下的10nm~10μm磨粒,可由等式(3)表示。
为了研究由Cu和PETEOS组成的互连结构上的胶态二氧化硅磨料粘附,将Cu晶片和PETEOS浸入浆料中,用DIW冲洗并通过N2吹风干燥,不同的zeta电位极性导致不同的粘附力,在第二步抛光和刻划之后的Cu / PETEOS互连结构的FESEM图像中,大量的硅胶磨料仍然选择性地留在铜表面,而不是铜表面,因此应该把重点放在铜互连结构清洗过程中的磨料去除。
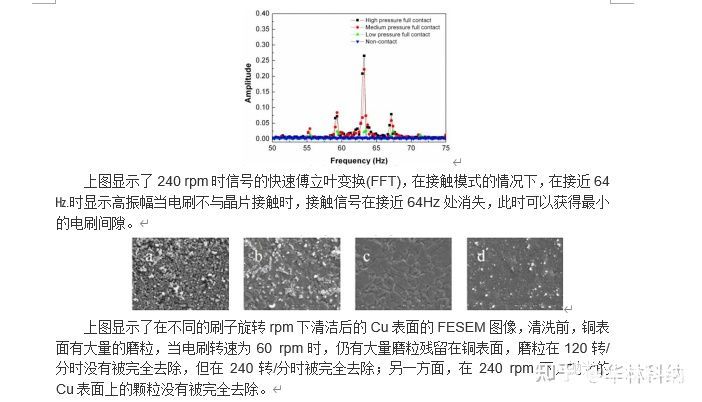
胶体二氧化硅可能通过CMP过程中产生的机械力嵌入铜表面,去除力不超过粘附力,包括变形粘附力,较高的转速和较长的加工时间可以获得完全洁净的表面。
对于由铜和斑点清洗组成的互连结构,铜清洗是关键问题,因为铜和胶体硅之间的相对zeta电位符号不同,当检测到接触信号时,可以制造小的间隙和高的流体阻力,在240 rpm时,流体阻力高于无变形粘附力时的粘附力,但低于有变形粘附力时的粘附力,更高的速度和更长的处理时间(280 rpm,120秒)可以去除磨粒,水力拖曳力可以有效地去除铜表面的磨粒,而不会损伤铜表面。
-
PVA刷擦洗对CMP后清洗过程的影响2022-04-27 2362
-
PVA刷接触式清洗过程中超细颗粒清洗现象2022-04-15 1208
-
利用PVA刷观察表面附近的接触清洗现象2022-04-06 1139
-
PVA刷擦洗对CMP后清洗过程的影响报告2022-01-26 1134
-
详解交联聚乙烯电缆的优缺点2022-01-05 8839
-
热缩套管聚乙烯的发展状况2021-03-11 1023
-
交联聚乙烯电线电缆是什么,关于它的特点和型号2020-07-27 7137
-
温度和湿度控制下聚乙烯醇的研究应用简报2019-10-21 1716
-
氯化聚乙烯合成技术进展2010-06-09 938
-
聚乙烯管道系统的构成与施工2010-01-30 700
-
聚乙烯醇感光胶使用2009-09-15 1884
全部0条评论

快来发表一下你的评论吧 !

