

 EGEE、NMP和THFA的微粒去除和基底损伤性能
EGEE、NMP和THFA的微粒去除和基底损伤性能
今日头条
描述
在本报告中,我们华林科纳探讨了2-乙氧基乙醇(EGEE)、NMP和THFA在常规气溶胶喷雾清洁系统中的微粒去除和基底损伤性能。在300毫米和200毫米的基底上观察到类似的结果;这里只报告了300毫米的结果,显示颗粒去除效率的晶片,清洁性能的顺序是水> NMP > EGEE > THFA,在晶片中心观察到较高的清洗效率,这主要是由于实验部分中描述的工艺配方几何因素,根据这些几何因素,可以计算出局部喷雾暴露时间,作为径向位置的函数,R(方程式1)。
接下来,考虑时间分辨粒子去除效率,图2显示了颗粒去除效率与暴露时间的关系(包括多次测试的数据),同样,清洁效率的顺序是清楚的,为了达到40%的颗粒去除率,可以对水使用2毫秒的局部曝光时间,对NMP使用10毫秒,对EGEE使用400毫秒,对THFA使用1000毫秒,尚不清楚为什么这些溶剂会产生如此不同的结果,一个因素可能是颗粒再沉积,因为二氧化硅颗粒在非水溶剂中的沉积已有描述,在本实验中,可能存在微观粒子扰动,随后是局部粒子沉积。
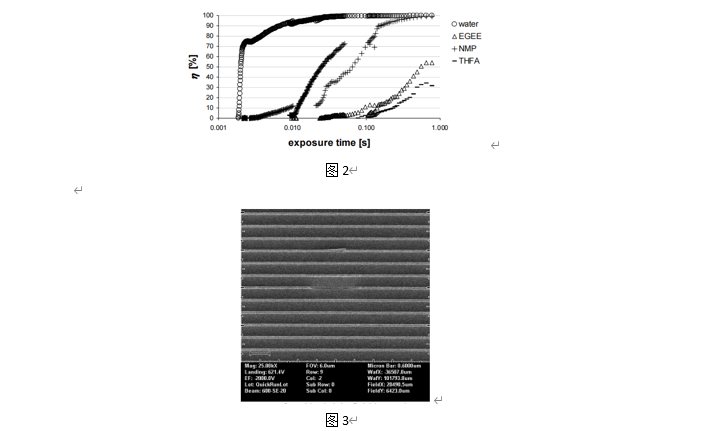
在图3中示出了典型的虚线缺陷,其通过明视场检查发现并通过扫描电子显微镜(SEM)成像,显示增加的线损伤的晶片图如图4所示,中心重缺陷密度也是工艺几何的直接结果,损害发生率显示出与清洁相似的趋势,水和NMP > EGEE > THFA,时间分辨缺陷密度如图5所示,NMP和水喷雾的损伤形成率相似,由于没有修复机制与损伤形成竞争,所有的损伤都是累积的,最后,图6显示了损伤密度与颗粒去除效率的对比,很明显,在相同的损坏率下,水喷雾的颗粒去除率比NMP高,此外,EGEE和THFA喷雾开始造成损害之前,任何净粒子删除观察,虽然图案损坏是不可逆的,但是颗粒的去除可以通过颗粒的再沉积来抵消。
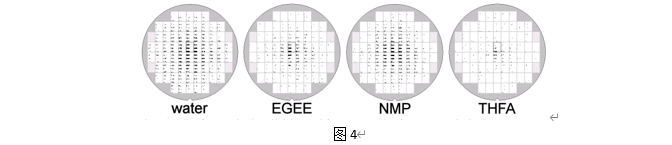
在高速气溶胶喷射清洗方面,水已与EGEE、NMP和THFA进行了比较,对于较小特征(例如< 50纳米线)的一般清洗,这些溶剂都不能提高先进半导体制造中所需的清洗至损坏性能,了解这些溶剂喷射系统的损坏性能有助于开发新的抗蚀剂剥离工艺,使用这些和其他溶剂的其他测试正在进行中,以确定溶剂特性、气溶胶性能和颗粒再沉积之间的任何趋势。
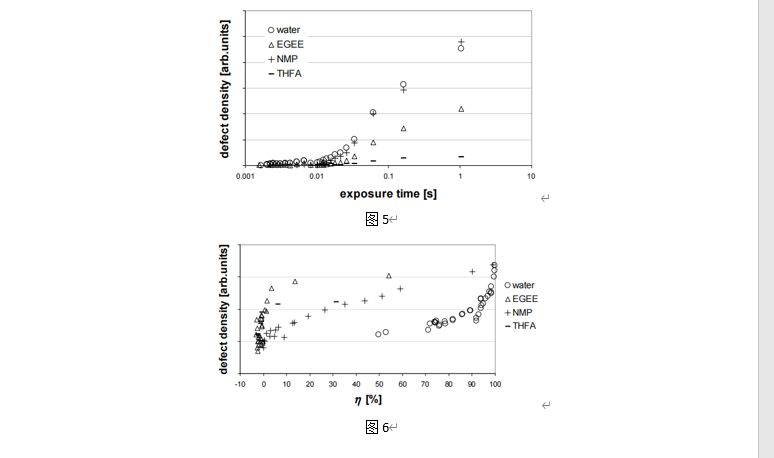
审核编辑:汤梓红
-
光阻去除工艺有哪些2025-07-30 1754
-
MAX13335EGEE/V+T - (Maxim Integrated) - 线性 - 放大器 - 音频2023-07-24 90
-
MAX13336EGEE/V+ - (Maxim Integrated) - 线性 - 放大器 - 音频2023-07-20 73
-
射频功率放大器在声表面驻波技术的悬浮微粒研究中的应用2023-04-03 1052
-
使用高频超声波的半导体单片清洗中的微粒子去除研究2022-04-14 1306
-
明纬模块电源产品线NMP系列2021-02-01 3706
-
ASMT-AB00-NMP00 1W大功率LED2019-07-04 296
-
飞行微粒群算法的液压系统可靠性优化2018-03-14 923
-
Molex推出首次面市的LED阵列塑料基底技术2013-01-29 2609
-
矢量微粒群算法及其应用2009-03-16 509
全部0条评论

快来发表一下你的评论吧 !

