

 精确确定晶片结晶方向的不同技术方法
精确确定晶片结晶方向的不同技术方法
今日头条
描述
摘要
在湿法体微机械加工中,蚀刻特性取决于取向。Si{100}和Si{110}晶片上任何几何形状的掩模开口的延长蚀刻导致由最慢蚀刻平面限定的结构。为了制造高尺寸精度的微结构,对准沿着晶体方向的掩模边缘包括这些最慢的蚀刻平面。因此,掩模边缘的精确对准在微/纳米制造中很重要。因此,确定精确的晶体方向至关重要,事实上,这是确保微结构尺寸精确以提高性能的第一步。在这篇综述文章中,我们对精确确定晶体学方向的不同技术进行了综合分析。我们已经介绍了在二十多年的时间里提出的确定Si{100}和Si{110}晶片上的结晶方向的各种技术。除了详细讨论每种技术及其设计和实现之外,我们还对相关的限制、优点和缺点进行了批判性分析。我们还总结了每种技术的关键方面,并以表格的形式呈现,以方便读者参考。这篇综述文章由详尽的讨论组成,对于在湿法各向异性蚀刻领域中的新手或想了解晶体方向测定技术的研究人员来说是一个方便的参考。
介绍
微机械加工是MEMS/NEMS工业中微/纳米制造的一个组成部分。有两种微加工方法,即表面微加工和体微加工。顾名思义,表面微加工技术利用衬底(例如晶片)的表面,并且使用表面上沉积的薄膜来制造微/纳米结构。沉积的薄膜用作结构层和牺牲层。另一方面,体微加工选择性地蚀刻体以制造三维特征、悬梁、薄膜等。体微加工进一步分为两类:干法和湿法蚀刻。干法蚀刻主要使用气相等离子体进行,但聚焦离子束和激光加工也用于某些特殊情况。如果使用湿化学药品进行蚀刻,则称为湿蚀刻。基于不同方向的蚀刻速率,湿法蚀刻可以进一步细分为各向同性和各向异性蚀刻。在各向同性蚀刻中,蚀刻速率在所有方向上都是相同的,并且不取决于结晶方向,然而在各向异性蚀刻的情况下,蚀刻速率是结晶取向的函数。普通硅湿各向同性蚀刻剂是HF、HNO3和CH3COOH的混合物,而氢氧化钾(KOH)和四甲基氢氧化铵蚀刻剂最广泛地用于湿法各向异性蚀刻。还有一些其它的碱性溶液已经被研究用于硅湿法各向异性蚀刻,例如乙二胺邻苯二酚水(EDP或EPW)氢氧化铵,和氢氧化铯(CsOH)。在湿法各向异性蚀刻中,面是所有类型的各向异性蚀刻剂中蚀刻速率最慢的面。因此,硅晶片中稳定的蚀刻轮廓(或延长的蚀刻轮廓)由{111}面形成,例如,Si{100}晶片上的任意形状的掩模开口导致在四个相互垂直的方向上由面组成的正方形/矩形v形槽,如图2所示。1 而在Si{110}晶片上,它给出六边形沟槽型结构,包括在〈110〉和〈112〉方向上的{111}面。
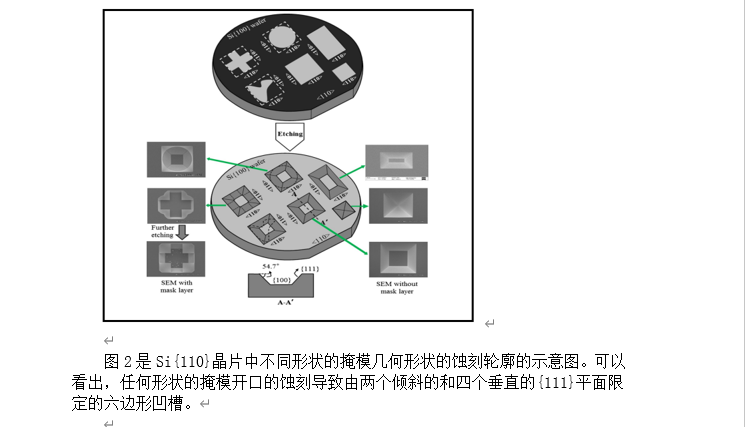

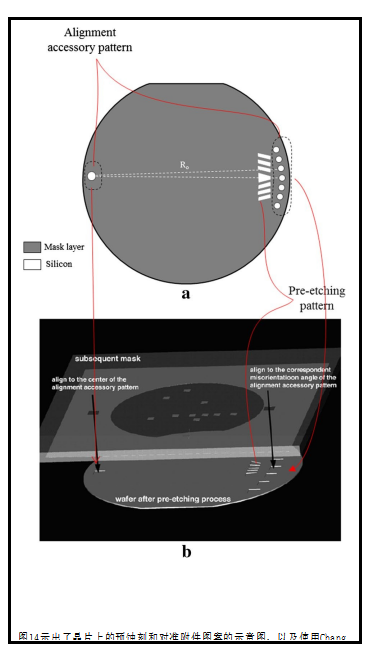
结论
这篇综述文章旨在我们华林科纳将迄今为止提出的精确确定Si{100}和Si{110}晶片结晶方向的不同技术集中在一个地方。讨论了不同的技术,包括解理边缘法和使用预蚀刻图案来确定晶体方向。根据不同几何图形在Si{100}或Si{110}晶片上的适用性,对它们进行了分析。沿着晶体方向对准掩模边缘的基本技术是使用晶片平面作为参考。然而,考虑到确定晶片平面的不确定性,当需要高尺寸精度时,这是不够的。
因此,开发了替代方法。其中之一是通过使用晶片平面作为参考制造结构,然后使用具有最小底切长度的结构边缘作为精确的晶体方向。然而,测量这种在某些情况下非常小的底切长度是一项繁琐的任务,并且需要复杂的设备。为了克服这些缺点,已经提出了不需要任何测量的其他技术。一种是通过选择在蚀刻后拐角合并的结构,另一种是通过选择具有对称底切的结构等。虽然这些技术不需要测量,但是由于晶片上不同位置的底切率不同,难以确定底切对称的目标结构等,仍然会带来相关的误差。最近,已经开发了自对准技术,由于结构的自对准性质,该技术使得晶体方向看起来很明显。这些技术在无需测量、鲁棒性、实现简单以及减少识别方向所需的努力方面克服了所有先前技术的缺点。这些技术可以在不使用任何复杂设备的情况下使用。
-
电缆故障精确定点方法2023-12-26 4241
-
精确测距或者精确定位2017-05-03 5800
-
晶片边缘蚀刻机及其蚀刻方法2018-03-16 3501
-
倒装芯片和晶片级封装技术及其应用2018-08-27 3307
-
UCOSII下的精确定时问题2019-06-04 1852
-
使用步进电机精确定位2010-01-09 518
-
555精确定时电路2008-10-24 1145
-
如何确保单片机精确定时控制有哪些编程方法详细说明2020-01-26 4926
-
清洗半导体晶片的方法说明2022-02-28 1883
-
GaN单晶晶片的清洗与制造方法2022-04-15 1427
-
晶片表面沉积氮化硅颗粒的沉积技术2022-05-25 2145
-
不同的湿法晶片清洗技术方法2022-07-07 2928
-
亥姆霍兹线圈实验如何确定磁场方向2024-03-09 4350
-
服务提供商数据在精确定位中的应用2024-07-18 1144
-
电缆故障预警与精确定位装置所涉及的技术2026-02-27 1274
全部0条评论

快来发表一下你的评论吧 !

