

 晶圆尺寸从300毫米过渡到450毫米的技术挑战
晶圆尺寸从300毫米过渡到450毫米的技术挑战
今日头条
描述
随着技术复杂性在亚20nm节点上的加速,半导体制造成本已经快速增加,晶圆尺寸从300毫米过渡到450毫米将是解决这一问题的方法之一,平均而言,采用300毫米晶圆的成本比之前的200毫米晶圆降低了30%,300毫米设备的开发只是简单地缩放200毫米工具,这不足以实现450毫米的成功,工艺技术、衬底处理/运输和工艺灵活性方面的创新是必要的,主要挑战如下:先进技术节点的清洁度、图案塌陷和损坏、湿法蚀刻均匀性、降低拥有成本、通过单晶片工具回收晶片、Si3N4选择性蚀刻。
对先进技术节点的清洁性:
根据国际半导体技术路线图(ITRS ),可以肯定的是,半导体制造的未来将继续面临表面准备和关键清洗步骤的重大挑战,例如对颗粒和金属污染的严格要求等,从硬件的角度来看,它可以从三个方面来解决,即室气氛、流体的质量控制以及部件清洁和老化,如表1所示,采用新的室气氛控制设计理念,即使不考虑更大的晶片表面面积(x2.25),450毫米alpha工具的颗粒性能也与300毫米生产工具相当或略好。
模式崩溃和损坏:
随着尺寸和间距的缩小,在湿法清洗步骤中图案坍塌和损坏的风险增加,使用20纳米以下的FinFET使其更加脆弱,300毫米工具的可行解决方案,例如IPA干燥、低表面张力流体和先进的分配方法,将全部转移到450毫米工具,450毫米湿法清洗工具需要创新的解决方案,目标应用于14纳米以上的节点。
湿蚀刻均匀性:
对于较大的晶片,均匀性(晶片内)对于许多工艺来说是一个挑战,包括湿法蚀刻、干法蚀刻、薄膜沉积和CMP等,从图1中可以发现,如果使用相同的300毫米化学分配方法,450毫米上的均匀性会降低,然而与300毫米相比,采用新方法可以获得更好的均匀性。
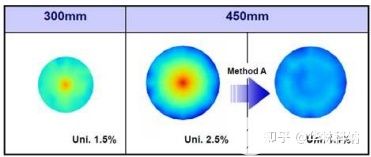
氧化亚钴减少:
450毫米转换的主要原因之一是降低成本,关键领域包括使用新的分配系统和循环减少化学品和DIW的使用,使用新的泵系统降低N2的使用,使用智能闲置和新硬件降低功耗,以及通过紧凑的腔室减少占地面积等。
使用单一晶片工具回收晶片:
主要湿式工具供应商没有预期开发用于450毫米的湿式工作台系统,该系统曾经是回收200毫米和300毫米晶片的标准,对于450毫米,晶圆回收必须通过单晶圆工具完成,成本和产量是主要关注的问题,在短加工时间和低表面粗糙度方面,在SiO2和Si3N4上获得了良好的结果,回收晶圆如表2和图2所示,但是由于薄膜剥离后的表面粗糙度,需要对多晶硅晶片的回收进行进一步的研究,例如研究新的化学品、多步骤配方等。

-
NVIDIA期盼450毫米晶圆 或牵手GlobalFoundries、三星2012-04-26 703
-
450毫米晶圆技术将用于处理器制造2012-09-07 1205
-
英特尔砸20亿美元兴建全球首座450毫米晶圆厂2013-01-22 1417
-
450毫米晶圆2018年量产 极紫外光刻紧随其后2013-04-21 1751
-
格芯宣布推出业内首个基于300毫米晶圆的RF SOI代工解决方案2018-05-03 1928
-
京东方发布全球首款长度1209毫米、宽度63毫米条形屏2019-08-04 4720
-
zpwsmileEntegris的新型300毫米晶圆运输箱体积小40%,可重复使用2020-02-14 4371
-
200毫米晶圆尺寸生产线再次迎来小幅度增长 8英寸是国内厂商发展的重要契机之一2019-09-23 5603
-
ADG721/ADG722/ADG723:CMOS,低伏天,4个双SPSTSTSTSTWSTwith在3毫米2毫米的LFCSP数据Sheet2021-05-09 923
-
英飞凌300毫米薄晶圆功率半导体高科技工厂正式启动运营2021-09-17 1432
-
2025年全球300毫米半导体晶圆厂产能创新高2022-11-09 1498
-
英特尔发布硅自旋量子比特芯片,采用300毫米的硅晶圆2023-06-16 2934
-
LTC7051:5毫米×8毫米口径LQFN数据表的硅MOS智能电源阶段 ADI2023-10-08 114
-
LTC7050:5毫米×8毫米口径LQFN数据表的双硅MOS智能电源阶段 ADI2023-10-09 86
-
300毫米晶圆级平台上的柔性光子芯片:应用与制造技术详解2024-05-27 2101
全部0条评论

快来发表一下你的评论吧 !

