

 化学镀NiP-Pd沉积过程中铜和镍的腐蚀
化学镀NiP-Pd沉积过程中铜和镍的腐蚀
电子说
描述
介绍
对于集成电路(IC)芯片,焊盘金属化是在晶片被切割和芯片被封装之前的制造过程中的最后一步。自集成电路工业开始以来,铝(Al)一直是使用最广泛的互连金属。然而,在过去十年中,它已被新一代IC的铜(Cu)互连所取代。与铝不同,铜易受环境退化的影响,并且由于可靠性问题而不能用于金(Au)引线键合。因此,对于Cu互连技术,IC制造商要么用Al覆盖Cu,要么用Al 成最后的互连层。
本文介绍了我们华林科纳半导体使用化学镀镍-磷/钯(NiP-Pd)来覆盖铜焊盘,而不是用铝来覆盖它。使用无电工艺覆盖铜键合焊盘比其他替代方案便宜得多,因为无电薄膜可以选择性地沉积在键合焊盘上。这消除了许多步骤,包括光图案化、蚀刻和清洗。在铜垫上化学镀镍的工作非常有限。然而,近年来,无电NiP/无电Pd (ENEP)、无电NiP/无电镀金(ENIG)或无电NiP/无电Pd/浸金被广泛研究和使用,用于覆盖引线键合应用的Al焊盘以及倒装芯片应用的凸点下冶金。
铜覆盖的无电镀工艺提出了许多独特的挑战。无电镀工艺中的所有子步骤都必须优化,因为每个步骤都可能导致严重的缺陷问题,如腐蚀、表面污染、桥接、台阶沉积、漏镀、结节和毯式电镀(图1)。腐蚀是焊盘可靠性最关键的问题之一,也是本文的重点。

结果和讨论
镍腐蚀
对被腐蚀的键合焊盘的检查显示,由于焊盘表面上镍腐蚀副产物的积累,焊盘变色(图3)。根据腐蚀的严重程度,垫表面上的腐蚀副产物的量不同,在严重的情况下,副产物膜厚且破裂(见图3c)。与表面污染的严重程度相关的引线键合失败,显示了晶片内的条纹特征(图4)。
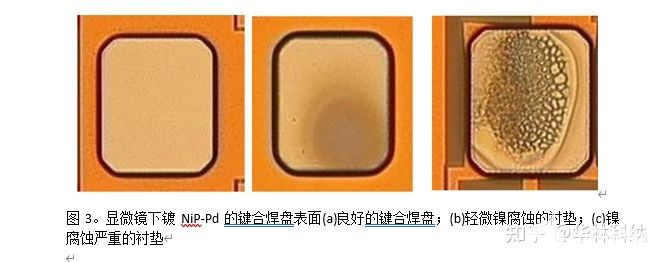
结论
用于接合焊盘金属化的无电镀工艺的实施需要用于无缺陷电镀的子工艺的适当优化。除了更好地研究活化、镍和钯浴的效果之外,理解和优化干燥过程对于实现无缺陷电镀也是至关重要的。已经表明NiP和Cu膜由于干燥不良而被腐蚀。在干燥过程中实施改进,并消除腐蚀剥离化学物质在晶片上的凝结,消除了腐蚀。
审核编辑:符乾江
-
探秘化学镀镍金:提升电子元件可靠性的秘诀2025-03-05 1254
-
pcb表面处理 什么是化学镀镍2024-01-17 3068
-
印制板化学镀镍/浸金(ENIG)镀覆性能规范2023-12-25 1076
-
化学金沉积过程的研究综述2023-04-21 1714
-
《炬丰科技-半导体工艺》用于半导体封装基板的化学镀 Ni-P/Pd/Au2021-07-09 4034
-
化学镀的原理及具有哪些应用特性2019-12-03 10452
-
如何进行化学镀厚铜故障的处理2019-09-02 997
-
不合格的PCB化学镀镍层怎样处置2019-08-22 1211
-
化学镀的特点优势及应用介绍2019-06-25 9039
-
【转】PCB化学镀镍液不稳定性的原因2018-07-20 2959
-
探讨印制电路板用化学镀镍金工艺2016-06-15 1084
-
印制电路板用化学镀镍金工艺探讨-悌末源2015-04-10 3136
-
Pcb化学镀镍/金工艺介绍2009-10-17 1412
-
印制电路板用化学镀镍金工艺探讨(一)2006-04-16 1263
全部0条评论

快来发表一下你的评论吧 !

