

垂直GaN功率器件的最新进展
今日头条
描述
最近在推进宽带隙 (WBG) 电力电子器件方面取得了显着进展,这主要是由于其与 Si 器件相比具有更高的开关频率,以及它们因此能够提高开关模式电源转换器的功率密度和效率。大多数市售的 WBG 功率器件都是基于碳化硅的(SiC) 或氮化镓 (GaN)。尽管迄今为止它在低压应用(大约 650 V 及以下)方面取得了成功,但最成熟的 GaN 基功率器件高电子迁移率晶体管 (HEMT) 并不适用于中压(大致定义为 1.2 至 20 kV) ) 应用,包括电动汽车传动系统和许多电网应用。这是由几个因素造成的,其中包括需要通过横向扩展器件来调整电压,从而增加芯片面积。与 GaN HEMT 相比,在原生 GaN 衬底上生长的垂直 GaN 功率器件不受此类限制,因为电压会在厚的低掺杂漂移层上下降,类似于分立 Si 和 SiC 功率器件的情况。因此,垂直 GaN 器件在中压应用方面具有巨大潜力。然而,n型掺杂 <10 16 cm -3根据击穿电压 >1.2 kV 的要求。还存在处理挑战,例如选择性掺杂 GaN 的能力以及与栅极电介质形成高质量界面的能力。在垂直 GaN 器件实现中压应用潜力之前,必须克服这些挑战。
氮化镓功率
垂直 GaN 功率器件的一个潜在应用领域是电动汽车传动系统。汽车动力传动系统电气化的快速加速已经成为广泛采用 SiC 功率器件的主要驱动力,例如金属氧化物半导体场效应晶体管 (MOSFET) 和结势垒肖特基 (JBS) 二极管。这是因为它们能够提高效率并减少将车辆电池连接到电动机的电力电子逆变器的体积。从传统的基于硅的逆变器过渡到基于碳化硅的逆变器是必要的(并且可能足够)实现美国能源部车辆技术办公室的电力电子密度目标 100 kW/L。然而,基于 GaN 的逆变器可能会在未来提供超出 SiC 所能实现的额外优势,更具侵略性的目标。事实上,利用遗传算法在传动系统逆变器的功率密度和效率之间进行权衡的系统级仿真表明,垂直 GaN 功率器件提供的解决方案优于 SiC 可实现的解决方案。这种模拟与 800 V 或更高的直流母线电压一致,与未来电动汽车的目标一致。因此,市售的 GaN 功率 HEMT 不适用于传统的两电平逆变器,由于其简单性和相关的可靠性,汽车系统设计人员更喜欢传统的两电平逆变器,因为它们如上所述的电压限制。因此,需要额定电压为 1.2 kV 或更高的垂直 GaN 功率器件。我们的团队一直在为逆变器所需的开关整流对开发垂直 GaN MOSFET 和 JBS 二极管。实验工作主要集中在沟槽 MOSFET (T-MOSFET) 上,主要是因为在替代双阱 MOSFET (D-MOSFET) 设计中需要选择性区域掺杂,这在 GaN 中通常具有挑战性,在 D 中尤其如此-由于双阱的MOSFET结构。T-MOSFET 也面临重大挑战,包括需要在沟槽的蚀刻侧壁上使用高质量的栅极电介质,以及缓解沟槽底部的高电场。已经制造了利用通过金属有机化学气相沉积 (MOCVD) 在原生 GaN 衬底上生长的漂移层的垂直 GaN 沟槽 MOSFET。具有原子层沉积 SiO 的单指器件 实验工作主要集中在沟槽 MOSFET (T-MOSFET) 上,主要是因为在替代双阱 MOSFET (D-MOSFET) 设计中需要选择性区域掺杂,这在 GaN 中通常具有挑战性,在 D 中尤其如此-由于双阱的MOSFET结构。T-MOSFET 也面临重大挑战,包括需要在沟槽的蚀刻侧壁上使用高质量的栅极电介质,以及缓解沟槽底部的高电场。已经制造了利用通过金属有机化学气相沉积 (MOCVD) 在原生 GaN 衬底上生长的漂移层的垂直 GaN 沟槽 MOSFET。具有原子层沉积 SiO 的单指器件 实验工作主要集中在沟槽 MOSFET (T-MOSFET) 上,主要是因为在替代双阱 MOSFET (D-MOSFET) 设计中需要选择性区域掺杂,这在 GaN 中通常具有挑战性,在 D 中尤其如此-由于双阱的MOSFET结构。T-MOSFET 也面临重大挑战,包括需要在沟槽的蚀刻侧壁上使用高质量的栅极电介质,以及缓解沟槽底部的高电场。已经制造了利用通过金属有机化学气相沉积 (MOCVD) 在原生 GaN 衬底上生长的漂移层的垂直 GaN 沟槽 MOSFET。具有原子层沉积 SiO 的单指器件 主要是因为在替代双阱 MOSFET (D-MOSFET) 设计中需要选择性区域掺杂,这在 GaN 中通常具有挑战性,尤其是在双阱的 D-MOSFET 结构中。T-MOSFET 也面临重大挑战,包括需要在沟槽的蚀刻侧壁上使用高质量的栅极电介质,以及缓解沟槽底部的高电场。已经制造了利用通过金属有机化学气相沉积 (MOCVD) 在原生 GaN 衬底上生长的漂移层的垂直 GaN 沟槽 MOSFET。具有原子层沉积 SiO 的单指器件 主要是因为在替代双阱 MOSFET (D-MOSFET) 设计中需要选择性区域掺杂,这在 GaN 中通常具有挑战性,尤其是在双阱的 D-MOSFET 结构中。T-MOSFET 也面临重大挑战,包括需要在沟槽的蚀刻侧壁上使用高质量的栅极电介质,以及缓解沟槽底部的高电场。已经制造了利用通过金属有机化学气相沉积 (MOCVD) 在原生 GaN 衬底上生长的漂移层的垂直 GaN 沟槽 MOSFET。具有原子层沉积 SiO 的单指器件 包括在沟槽的蚀刻侧壁上需要高质量的栅极电介质,以及缓解沟槽底部的高电场。已经制造了利用通过金属有机化学气相沉积 (MOCVD) 在原生 GaN 衬底上生长的漂移层的垂直 GaN 沟槽 MOSFET。具有原子层沉积 SiO 的单指器件 包括在沟槽的蚀刻侧壁上需要高质量的栅极电介质,以及缓解沟槽底部的高电场。已经制造了利用通过金属有机化学气相沉积 (MOCVD) 在原生 GaN 衬底上生长的漂移层的垂直 GaN 沟槽 MOSFET。具有原子层沉积 SiO 的单指器件2栅极电介质已展示出约 8 V 的正阈值电压、约 10 8的开/关比和约 400 mA/mm 的电流密度(图 1)。还制造了四指器件,并显示出良好的电流缩放。此外,GaN JBS 二极管已同时开发,在这种情况下,作为p - 和n的交替区域,不能避免选择性区域掺杂掺杂材料是器件运行所固有的。我们的团队利用蚀刻和再生长方法来演示垂直 GaN JBS 二极管,其反向保持电压 >1.5 kV 和正向开启电压 <1 V,与 JBS 操作一致。旨在进一步提高 T-MOSFET 和 JBS 二极管性能的生长和工艺改进目前正在进行中,重点是再生长、栅极电介质和表面钝化。
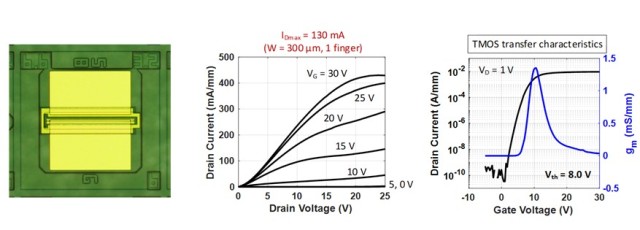
图 1:(左)单指垂直 GaN 沟槽 MOSFET 的显微镜图像。(中)不同栅极电压的漏极电流与漏源电压的关系,电流密度约为 400 mA/mm。(右)固定漏极电压(转移曲线)下的漏极电流与栅极电压的关系,说明~10 8的开关比和~8 V的开启电压;还显示了跨导曲线。
垂直 GaN 器件的另一个潜在应用领域是电网。特别是,由于其快速的雪崩击穿响应,垂直 GaN PN 二极管有望保护电网免受电磁脉冲 (EMP) 引起的快速电压瞬变。我们的团队测量到 GaN PN 二极管的雪崩击穿时间响应小于 1 ns,这对于保护电网免受 EMP 的影响已经足够快了。对于 5 kV 级的垂直 GaN 二极管,我们的团队已经实现了 >50 mm 厚的漂移层,净掺杂在低 10 15 cm -3范围(在某些情况下,这些是在结附近具有最低掺杂的多层设计)。使用这些漂移层,再加上多步蚀刻结终端扩展 (JTE),我们的团队已经展示了 1 mm 2 PN 二极管,其击穿电压 >5 kV,绝对正向电流(脉冲)高达 3.5 A,并且特定于-电阻 <2.5 mW cm 2(图 2)。未来的工作旨在扩展生长和制造,以实现具有 10 kV 和更高击穿电压的器件。此外,一项旨在为电网和其他应用建立中压垂直 GaN 器件的可制造性的平行代工工作正在进行中。迄今为止,这项工作主要集中在 1.2kV 级 PN 二极管上。该团队在制造面积从 ~0.1 到 1 mm 2的 PN 二极管之前对外延 GaN 晶圆进行了广泛的测量并将其与制造设备的产量相关联。使用注入保护环和 JTE 的各种组合,经常实现击穿电压 >1.2 kV 的器件,并根据击穿电压和正向电流的组合评估良率。代工工作目前正在扩展到 3.3 kV 器件,并且正在考虑替代边缘端接方法,例如斜切。此外,已经对垂直 GaN PN 二极管进行了广泛的可靠性测试,以了解它们的基本退化机制并最终缓解它们。该测试包括高温反向偏置和高温工作寿命评估,并揭示了几种不同的退化行为。
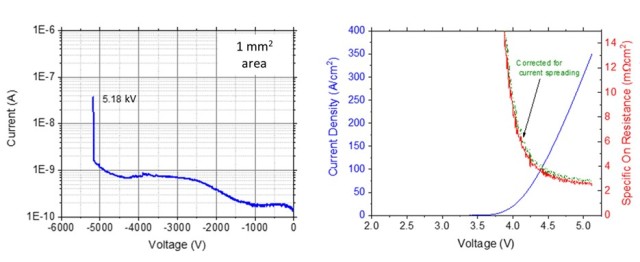
图2.(左)1 mm 2垂直GaN PN二极管的反向偏置电流-电压曲线,具有50 mm厚的三层漂移区,最小掺杂~2×10 15 cm -3,击穿电压>5 kV(右) ) 相同二极管的脉冲正向 IV 曲线(0.1% 占空比),说明最大电流为 3.5 A,最小特定导通电阻 <2.5 mW cm 2。还显示了对电流扩散的校正,这对于这个厚漂移区域来说是最小的。
结论
总之,垂直 GaN 功率器件有望用于电动汽车传动系统、电网等应用。我们的团队设计了各种类型的器件,包括 PN 二极管、JBS 二极管和沟槽 MOSFET,这需要对 GaN 特定的外延生长和器件加工进行研究。这项工作得到了由 DOE 车辆技术办公室的 Susan Rogers 管理的电动传动系统联盟和由 Isik Kizilyalli 指导的 ARPA-E Kilovolt Devices Cohort 的支持。桑迪亚国家实验室是一个多任务实验室,由霍尼韦尔国际公司的全资子公司桑迪亚国家技术与工程解决方案有限责任公司根据合同 DE-NA0003525 为美国能源部国家核安全管理局管理和运营。本文描述了客观的技术结果和分析。本文中可能表达的任何主观观点或意见不一定代表美国能源部或美国政府的观点。
作者:
R.卡普拉1*,A.宾德1,M.克劳福德1,A.阿勒曼1,B.冈宁1,J .弗利克1,L.耶茨1,A.阿姆斯特朗1,J.迪克森1,C.格拉泽1 , J. Steinfeldt 1 , V. Abate 1 , M. Smith 1 , G. Pickrell 1 , P. Sharps 1 , J. Neely 1 , L. Rashkin 1 , L. Gill 1 , K. Goodrick 1 , T. Anderson 2 , J.加拉格尔2 , AG 雅各布斯2, A. Koehler 2 , M. Tadjer 2 , K. Hobart 2 , J. Hite 2 , M. Ebrish 3 , M. Porter 4 , K. Zeng 5 , S. Chowdhury 5 , D. Ji 6 , O. Aktas 7 , 和 J. 库珀8
1桑迪亚国家实验室,阿尔伯克基,新墨西哥州,美国
2美国华盛顿特区海军研究实验室
3 国家研究委员会,华盛顿特区,美国,居住在 NRL
4 海军研究生院,美国加利福尼亚州蒙特雷,居住在 NRL
5 斯坦福大学,美国加利福尼亚州斯坦福
6 斯坦福大学,美国加利福尼亚州斯坦福,现就职于加利福尼亚州圣克拉拉的英特尔公司
7 EDYNX,利弗莫尔,CA,美国
8 Sonrisa Research,圣达菲,新墨西哥州,美国
审核编辑 黄昊宇
-
风光互补技术及应用新进展2009-10-22 3011
-
风光互补技术原理及最新进展2009-10-26 4696
-
DIY怀表设计正式启动,请关注最新进展。2012-01-13 11064
-
车联网技术的最新进展2018-09-21 17548
-
介绍IXIAIP测试平台和所提供测试方案的最新进展2021-05-26 3638
-
ITU-T FG IPTV标准化最新进展如何?2021-05-27 2701
-
CMOS图像传感器最新进展及发展趋势是什么?2021-06-08 4762
-
VisionFive 2 AOSP最新进展即将发布!2023-10-08 1335
-
中国龙芯CPU及产品最新进展2011-12-07 29668
-
UWB通信技术最新进展及发展趋势2017-02-07 1326
-
浅谈垂直纳米环栅器件领域获得的最新进展2021-06-04 4846
-
ASML***的最新进展2023-07-30 3869
-
5G最新进展深度解析.zip2023-01-13 916
-
垂直氮化镓器件的最新进展和可靠性挑战2025-02-17 2430
-
京东方华灿光电氮化镓器件的最新进展2025-03-13 1931
全部0条评论

快来发表一下你的评论吧 !

