

GaN和SiC热管理的进展
电子说
描述
电子元件和电路的适当热管理是确保系统在所有操作条件下正确运行和可靠性的基本要求。当前电子设备逐渐小型化的趋势以及对功率密度的需求不断增加,将热管理问题置于前台,特别是对于最新一代的功率设备,例如由氮化镓 (GaN) 和碳化硅 (SiC)。基于 GaN 和 SiC 的器件可以提供最新一代电源应用所需的高性能。然而,它们极高的功率密度应该得到适当的管理,这使得创新的热管理技术成为一个需要考虑的关键方面。
为了充分发挥宽带隙 (WBG) 半导体的潜力,设计人员必须了解使用这些材料所带来的挑战。在更高的开关频率和更高的功率密度下运行,可以实现无源元件(电感器和电容器)的尺寸减小并制造更轻更小的系统。然而,这些较小的无源元件在较高频率下工作的行为很难预测,并且可能会出现热管理问题。WBG 半导体需要仔细设计,因为与硅基器件支持的温度相比,它们在更高的温度下工作。设计过程考虑了更大的热应力,这会对系统的可靠性产生不利影响。
在“热管理进展 2021 ”这一完全在线举办的活动中,GaN 和 SiC 技术的三位主要专家提供了有关热模型、封装、热分析和热界面材料技术的宝贵信息。该小组由电力电子新闻主编 Maurizio Di Paolo Emilio 主持,并邀请了来自 Efficient Power Conversion (EPC)、UnitedSiC 和 STMicroelectronics 等主要公司的行业名人。
总承包
EPC 的首席执行官兼联合创始人 Alex Lidow 以提到芯片级 GaN 的热管理开始了演讲。据 Lidow 称,EPC 基于 GaN 的功率器件已经生产了大约 11 年。在谈话中,他说由于 GaN 器件比它们所取代的功率 MOSFET 小得多(小 5 到 10 倍),一个常见的误解是它们会引起热管理问题。令人惊讶的是,它们在散热方面的效率提高了 5 到 10 倍。让我们考虑进入 PC 板的设备的热阻。Lidow 表示,这些设备面朝下(倒装芯片)安装,所有有源元件都在设备表面,而且它们真的很靠近 PC 板。从器件结到焊点底部的热阻 (R θJB),具有相同的表面,在硅和 GaN 之间没有太大区别。然而,正如 Lidow 所说,如果我们考虑相反的方向——从结到外壳的热阻(R θJC ),或者通过侧壁或背面离开器件的热阻——它表明 GaN 大约是比具有相同管芯面积的硅器件高 6 倍的热效率。因此,经常看到 PC 板上的器件面朝下放置。这些结果可以通过在基于 GaN 的功率器件和散热器之间放置隔热层来实现,如图 1 所示。
“在隔热材料和凝胶方面有了很大的改进;在短短几年内,我们已经从大约 6 W/mK 一路上升到大约 17 W/mK,”Lidow 说。“我们的解决方案不仅允许从 PC 板到散热器的热传导,而且还允许从设备侧面传导热,这样您就可以通过侧壁冷却获得更大的好处。”
Lidow 评论说,在 4 毫米2代表性设备上执行的模拟显示了 EPC 已经能够通过实验确认和实现的内容。特别是,更好的热管理已经能够在 6W 功耗下将热阻降低到大约 3.9°C/W。
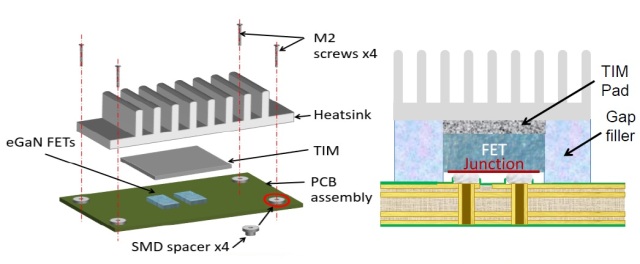
图 1:结壳热阻的减少
“我们为客户提供了一种工具,可以让设计师对整个系统进行热建模,”Lidow 说。“可以配置各种元件,例如间隙填充物、隔热垫、散热器、散热器和散热孔。”
联合碳化硅
UnitedSiC 的首席应用工程师 Jonathan Dodge 就热管理的趋势以及对 SiC 的考虑发表了演讲。正如道奇所说,导通电阻的降低绝对是未来几年将持续的趋势,这将开辟一些有趣的应用,否则功率半导体将无法真正处理这些应用。“因此,我们还提高了每个分立器件的功率处理能力,”道奇说。
“碳化硅可以减小芯片尺寸,但芯片单位面积的功率仍然相关,这意味着我们更多地依赖于封装和散热器来提供热质量,”他补充道。
在他的演讲中,道奇强调了两个应用分支,它们对热管理提出了严峻的设计挑战。第一个包括具有被动冷却的固态断路器和继电器,而另一个包括需要更积极冷却的大功率转换器和电机驱动器。这两种应用都需要一个能够处理所需功率水平的封装。广泛使用的封装(例如 TO-247)具有严重的局限性。它们的引脚很小,考虑到在电机驱动应用中,我们可能会运行超过 100 A RMS通过他们。然后,如图 2 所示,有一个浪费的区域,因为与封装相比,SiC 芯片的面积相对较小,但体积很大。道奇评论说,爬电距离和电气间隙也是另一个问题,因为该封装不是为我们现在使用的高电压而设计的。这就是为什么许多设计师更喜欢带有陶瓷隔离器的夹子安装座,因为陶瓷不会磨损。
“我认为未来的趋势实际上将是表面贴装:它成本低、非常可靠,并且无论是顶部冷却还是底部冷却,”道奇说。“我们需要能够处理多个表面贴装设备、800 V 甚至更高电压的隔离热界面材料,并符合小型 SMT 组装变化。”

图 2:TO-247 封装对最大电流有严格的限制。
意法半导体
STMicroelectronics 集团副总裁兼总经理 Salvatore Coffa 结束了本次会议,并讨论了功率器件中的热管理技术,并考虑了牵引逆变器应用的热管理设计。
Coffa 指出,每当我们谈论功率器件性能的创新时,我们都会看到向更高功率密度以及更低功率和传导损耗的演变。这对于硅来说是正确的,对于像 SiC 和 GaN 这样的 WBG 半导体来说更是如此。
“创新之路不仅是前端、材料、结构或设备的创新,而且封装所扮演的角色越来越重要,”Coffa 说。
为了在 EV 动力总成的功率模块中实现这一点,Coffa 表示,我们需要实现低静态和动态损耗,提高热阻 R th(流体结点),并在最终实现成本、性能和可靠性之间的优化权衡。应用。
Coffa 认为,电源模块封装设计的方法是基于仿真,使用诸如 CAD/CAE 建模之类的工具。这非常有帮助,因为它考虑了设备的属性、损耗和热机械约束。如图 3 所示,Coffa 分析的这种方法允许从具有相关操作条件的初始包装设计开始,通过功率损耗、热机械问题和其他损坏的理论模型来估算产品寿命。Coffa 补充说,最终的包装设计是根据拓扑或形态优化方法迭代流程的结果。并且所有模型都必须事先通过实验进行校准和验证,即使在不同的设计中也是如此。

图 3:建模方法
“我们进行了大量 CAD/CAE 建模,将器件的电气特性与热材料的特性结合起来,我们还进行了大量实验工作,以便从我们使用的材料中选择合适的参数,”科法说。
用于电动汽车牵引逆变器的 SiC MOSFET 需要对芯片和封装进行适当的协同设计,同时考虑到最终应用中的所有相关热机械方面。专门为汽车领域设计的 SiC 功率器件被认为通常通过非常规的芯片连接技术进行安装。新的 SiC 芯片专门设计为通过烧结组装,底部和顶部都用于夹子烧结。在活性金属钎焊上或直接在散热器上烧结芯片,利用这种 WBG 材料的卓越电气和热性能,并在温度波动下提供卓越的可靠性。
审核编辑:郭婷
-
SiC/GaN正在重塑新能源汽车性能,工程师如何应对新挑战?2026-04-17 651
-
报名 | 宽禁带半导体(SiC、GaN)电力电子技术应用交流会2017-07-11 5034
-
SiC/GaN功率开关有什么优势2018-10-30 3602
-
氮化镓GaN技术助力电源管理革新2018-11-20 2102
-
SiC GaN有什么功能?2019-07-31 3757
-
微波射频设计的热管理有什么影响?2019-08-28 2816
-
微型热管理和电源管理怎么解决散热设计的难题?2020-03-10 3126
-
SiC/GaN具有什么优势?2021-03-10 3080
-
请问一下SiC和GaN具有的优势主要有哪些2021-08-03 3098
-
GaN和SiC区别2022-08-12 10135
-
GaN功率集成电路的进展分析2023-06-19 1448
-
电动汽车热管理技术研究进展2023-03-30 5180
-
GaN与SiC功率器件的特点 GaN和SiC的技术挑战2023-08-09 2260
-
SiC 与 GaN 的兴起与未来 .zip2023-01-13 679
-
电力电子的热管理未来趋势与挑战!2024-11-28 1487
全部0条评论

快来发表一下你的评论吧 !

