

硅晶体管的创新还有可能吗?
今日头条
描述
自从固态晶体管取代真空管以来,半导体行业取得了惊人的突破性进展,改变了我们的世界。如果没有这些改进中的许多,即使在被迫隔离期间,我们也无法远程工作和保持联系,也无法享受技术提供的所有其他奇迹。
一个例子:由于工程师不断努力将每单位面积越来越多的晶体管挤到硅芯片上,处理能力的非凡提升成为可能。被确定为摩尔定律,它是晶体管密度每 18 个月左右可以翻一番的观察,它指导了半导体行业中微处理器世代的发展 50 多年。现在,我们正在达到需要新技术的原子和物理极限,例如层的垂直堆叠。
与此同时,随着碳化硅(SiC)和氮化镓(GaN)等宽带隙半导体的发展,我们也正处于另一场革命之中。新材料具有独特的物理特性,可在更严酷的热条件下提高效率、提高功率密度和更安全的性能。
STMicroelectronics 已经开始大批量生产 STPOWER SiC MOSFET,有助于推动电动汽车 (EV) 的普及,并开启大规模电气化时代。也可以想象,这最终会导致实现可持续移动的自动驾驶。
另一项涉及高压(即 200 V 以上)硅功率晶体管的革命发生在世纪之交,当时出现了超级结 MOSFET。直到 1990 年代末,设计人员不得不接受这样一个“公理”,即对于平面晶体管,品质因数(定义为导通电阻乘以芯片面积)与击穿电压 (BV) 成正比,提高到 2.5 . 该公理暗示通过给定电压达到较低导通电阻值的唯一解决方案是增加芯片面积。这使得使用具有小外形封装的设备变得越来越困难。超级结技术通过使上述关系接近线性来拯救高压 MOSFET。ST 将这项技术命名为 MDmesh,并使其成为 STPOWER 子品牌的一部分。
超结晶体管的原理
超级结晶体管的工作机制利用麦克斯韦方程之一,简化为一维情况 - 例如,垂直轴,y。它指出电场沿该轴的斜率等于电荷密度 r 除以介电常数 e。在符号中,dE/dy = r/e。另一个方程将电压 V 与电场 E 沿 y 的分量联系起来;即,E = –dV/dy。换句话说,电压 V 是 E 的积分,或者用几何术语来说,是作为 y 函数的 E 曲线下的面积。我们可以通过比较标准平面 MOSFET 的垂直结构与其类似尺寸的超级结对应物来了解它是如何工作的。超级结本质上是通过实现 p 型柱,在垂直漏极内部扩展基本晶体管的 p 体。
在沿 y 轴从表面开始的平面结构(见图 1,左)中,我们遇到 p 体,因此,在到达 A 点之前,斜率为正。从 A 到 B,我们有排水管极性相反,因此,斜率反转为负。从 B 到基板,极性变得更加负 (n–),因此,斜率增加。图中的绿色区域代表在关断状态下可以维持的电压。在右侧所示的超结图中,添加 p 型区柱改变了电场分布。事实上,从 C 到 A,电场分布保持不变(体和柱具有相同的极性),然后由于漏极和衬底的原因,斜率与平面结构中的相反。结果,电场下方的面积更大,所以电压 V2 是持续的。在这里,柱子发挥了它的魔力。现在,在给定电压下,我们可以降低漏极电阻并降低导通电阻。
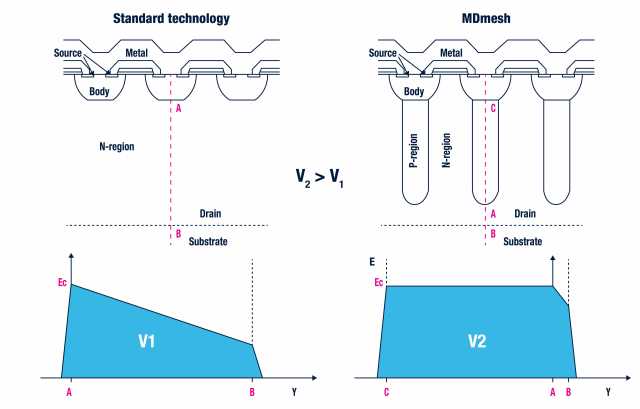
图 1:平面(左)和超结 MDmesh(右)MOSFET
技术演进
自从首次亮相以来,MDmesh 晶体管一直在不断改进和完善,并且大量的功率转换应用仍然受益于它们的使用。用于创建垂直支柱的工艺技术已得到极大优化,以提高制造产量和设备坚固性。根据目标电路拓扑和应用,现在提供不同的专用产品系列。这种技术多功能性和灵活性使系统设计人员可以从多种选项中进行选择。通用 M2 系列在 400 至 650 V 范围内具有最佳成本/性能,并且有针对 PFC、软开关 LLC 和桥拓扑的特定应用变体,电压能力扩展至 1,700 V .
最重要的是,诸如铂离子注入之类的寿命终止技术正被用于提高集成体二极管的性能,以减少反向恢复时间 t rr,以及反向恢复电荷 Q rr加上改进的 dV/dt( DM 系列)。这些特性是桥式和高功率移相电路的理想选择。快速二极管版本甚至可以在低功率电机驱动器中与 IGBT 竞争,从而无需使用共同封装的二极管。在效率方面,典型的例子是一台150W的冰箱压缩机逆变器,如图2所示。

图 2:DPAK 封装中快速二极管 MDmesh MOSFET 与 IGBT 的压缩机逆变器效率曲线。测试条件:0.23 Nm(负载),220V / 50Hz(输入电压)
毫不奇怪,无处不在的 MDmesh 晶体管已经生产了数十亿!
在图 3 中,通过比较针对谐振转换器优化的最新 M6 系列实现的功能,我们可以看到 ST 设计人员在改进早期 M2 版本方面是多么勤奋。
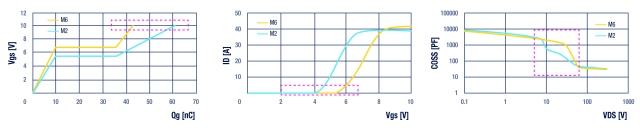
图 3:从 M2 到 M6 — 改善栅极电荷、阈值电压和输出电容
在图 3 的图表中,从左到右,我们看到更低的栅极电荷、更高的阈值电压和线性电压输出电容转化为更高的开关频率、更低的换向损耗和更轻负载下的更高效率。
底层超结技术与最先进的工艺步骤相结合,产生了高性能高压 MOSFET,特别关注关键开关参数,如 dI/dt 和 dV/dt,如图 4 中的安全操作图所示。由于这些改进,DM6 MDmesh 系列非常适合太阳能逆变器、充电站和电动汽车车载充电器 (OBC),仅举几例。
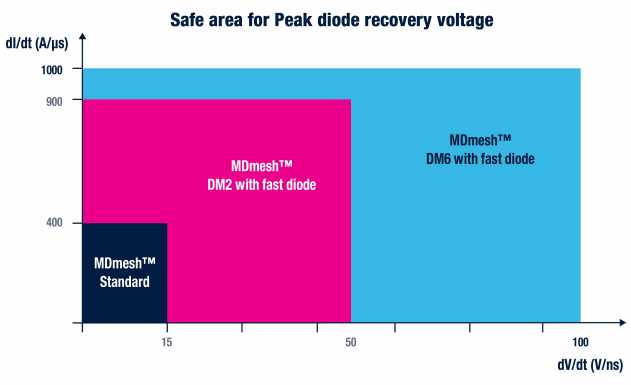
图 4:dI/dt 与 dV/dt 安全工作区
应用领域
ST 的 MDmesh 晶体管用于多种应用,这使我们能够在一个小而具有代表性的选择中展示它们的优点。
最大容量的应用之一是智能手机适配器。图 5 显示了 120-W 版本。

图 5:智能手机适配器中的 MDmesh
图 6 显示了“量身定制的”M5 系列如何相对于“基本”M2 系列以更高的功率提高 1.5 kW PFC 的效率。所使用的两个 MOSFET 具有相似的导通电阻(M5 和 M2 的导通电阻分别为 37mΩ 和 39mΩ)和电压阻断能力(650V)。
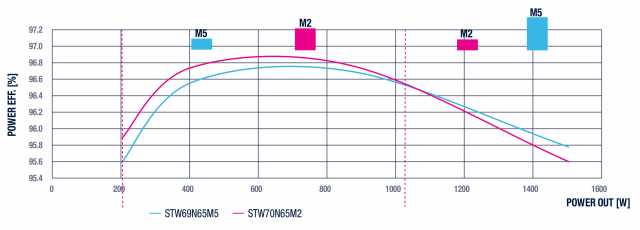
图 6:M5 系列(蓝色)如何在更高功率下提高 PFC 效率
图 7 显示了另一个有趣的例子:用于汽车 OBC 的 3 kW 半桥 LLC 电路比较了最新的 DM6 (STWA75N65DM6) 与 Vin = 380–420 V、Vout = 48 V、开关频率 f = 的最佳竞争产品250 Hz 至 140 kHz。

图 7:3 kW 全桥 LLC — 关闭能量和增量效率与 Pout
图 8 说明了损耗的分配,表明达到最低损耗和最高效率的关键是通过传导和开关损耗的最佳组合。

图 8:分析 3 kW 全桥 LLC 转换器中的各种损耗源
快速增长的 5G 技术也受益于 MDmesh 创新。随着 5G 系统的高度小区密集化和不断减小的基站尺寸(从微小区到微微小区),MDmesh 凭借其效率、非常大的批量生产能力、竞争力、和性能。
为了让 5G 系统以高于 98% 的效率运行,PFC 和 DC/DC 转换器级需要分别达到 99% 的效率。PFC 的一种解决方案可以是在三角电流模式 (TCM) 操作中使用 MCU 数字控制的 3 通道交错式无桥图腾柱。TCM 系统使转换器能够在零电压开关下运行,从而显着降低开关损耗。总体而言,除了电感器、EMI 滤波器和输出电容器的尺寸减小之外,结果是平坦的效率曲线和低负载下的良好效率值。
MDmesh 晶体管为 5G 无线系统的推出铺平了道路。
扩散焊和封装
另一个被纳入 MDmesh 下一次迭代的有趣创新是扩散焊接工艺。
在标准焊接工艺(软焊接)中,金属间相 (IMP) 的形成是键合形成的基础。它由界面处的薄金属间层和中间未反应的焊料组成。热循环后标准软焊点的失效机理分析揭示了未反应焊料体积内的疲劳裂纹扩展。
所有金属间化合物的两个重要特性是硬度和脆化,这是延展性的降低。众所周知,后者会在热机械应力期间导致设备故障,从而降低电子设备的可靠性。
此外,焊锡层含有大小不一的空隙,不仅会破坏芯片与引线框架之间的热连接,还会产生“热点”;也就是说,微观体积达到非常高的局部温度。另一个需要考虑的影响是 MOSFET 参数的温度依赖性,例如导通电阻会增加,而阈值电压会随着温度升高而降低。虽然前一种趋势具有稳定作用,但后一种趋势可能有害,尤其是在开/关转换期间。
为了克服这些问题,正在开发一种称为等温扩散焊接的新工艺,它将标准焊接的特征与扩散焊接相关联。
这主要是通过具有低熔点的材料(例如,Sn-Cu 焊膏)和具有高熔点的材料(例如,来自基板的 Cu)之间通过界面处的 IMP 生长而获得的。
与传统焊接相比,接头是在焊接过程中通过等温固化形成的,而不仅仅是在冷却之后。
形成具有非常高熔点的相的这一优势还与优异的机械强度有关。随着功率封装的结温达到 200°C,扩散焊接技术改进了芯片到基板的互连,确保工作温度不超过会导致过早失效的连接工艺温度。
焊接工艺改进的热性能消除了软焊料的一些负面影响,这也转化为更好的电气性能。因此,它与新的封装概念完美结合,例如 TO-LL(TO 无铅)封装,在 SMD(表面安装器件)封装中具有最佳的电路板空间面积与热阻比。它还配备了开尔文引脚,使关断效率更高,因此可以使用 M6 或桥接电路解决硬开关拓扑问题,MD6 系列提供更低的导通电阻。

图 9:TO-LL 与更多 SMD 封装
为了完成这个封装概述,创新的 ACEPACK SMIT(表面安装隔离顶部冷却)“分立”电源模块如图 9 所示。这种模制的引线框架封装包含一个直接键合铜 (DBC) 基板,可以容纳单独的用于实现各种拓扑的芯片。ACEPACK SMIT 具有令人印象深刻的低热阻,0.2°C/W,背面陶瓷确保绝缘电压最低为 3,400 VRMS(UL 认可)。

图 10:ACEPACK SMIT 包

图 11:ACEPACK SMIT 内部配置灵活性
接下来是什么
20 多年后,STPOWER MDmesh 技术不断发展,与意法半导体最具创新性的 WBG 半导体一起,继续提供市场上最广泛的功率晶体管。图 12 描绘了以标准技术和理论物理极限为基准的连续 MDmesh 版本的特定导通电阻与击穿电压的关系:M9 和 K6 现在已全面投产。为清楚起见,K5 和 K6 代表极高电压(从 800 V 到 1,700 V)技术子集。
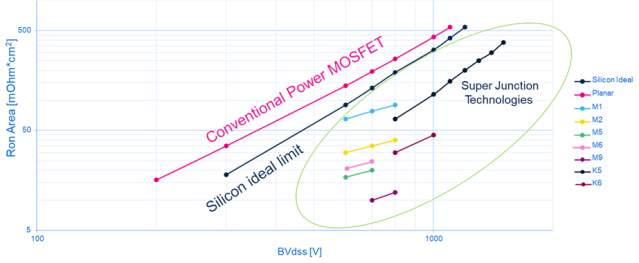
图 12:MDmesh 特定导通电阻的演变
为了了解为满足不同应用的要求而开发的 MDmesh 多次迭代所做的努力,请查看图 13 中的一系列图像,从第一代 MOSFET 到最新的 TrenchFET。
下一步是什么?引入MD6后,目的是将沟槽结构的好处应用到超结上。这一壮举将使 MDmesh 又向前迈进了一步,并将其扩展到未来的突破性技术,如 SiC。通过适当的调整和优化,这种 WBG 技术有望享受在现有硅技术上广泛实施和调试的性能改进。旅程永远不会停止惊喜!

图 13:MDmesh 里程碑:走向 Trench
审核编辑 黄昊宇
-
什么是达林顿晶体管?2023-02-16 1923
-
什么是晶体管 晶体管的分类及主要参数2023-02-03 2337
-
基于硅晶体管模糊电路2022-08-10 1455
-
晶体管晶圆芯片2020-02-17 1322
-
晶体管简介2019-05-09 2163
-
晶体管的由来2019-05-05 2523
-
晶体管的代表形状2019-04-10 2165
-
晶体管ON时的逆向电流2019-04-09 2038
-
MAPRST0912-50硅双极晶体管2018-08-09 2069
-
晶体管分类及参数2010-08-12 3258
-
多晶硅发射极晶体管,多晶硅发射极晶体管是什么意思2010-03-05 1958
-
晶体管分类2009-11-05 4967
-
硅晶体管与锗晶体管的识别及区分方法2008-10-19 9566
全部0条评论

快来发表一下你的评论吧 !

