

用于新型电力电子设备的垂直GaN器件
电子说
描述
GaN 是一种高带隙材料,与硅相比,它允许器件在更高的温度下运行并承受更高的电压。此外,GaN 更高的介电击穿允许构建更薄且因此电阻更低的器件。较低的特性 R DS(on)导致具有较低电容的较小器件。垂直 GaN 器件能够以更高的频率进行开关并在更高的电压下运行。
“垂直 GaN ™器件比硅小 90%。电容与器件的面积直接相关。器件越小,电容越低。电容越低,开关频率越高。NexGen Power Systems Inc. 首席执行官兼联合创始人 Dinesh Ramanathan 表示,在大多数典型应用中,垂直 GaN ™ 的开关损耗比 Si MOSFET 低 67%,尤其是电源。
与在非 GaN 衬底上制造的横向 GaN 器件相比,在低缺陷密度体 GaN 衬底上生长的低缺陷密度外延层允许实现在电压和热应力下具有更高可靠性的垂直功率器件。
Vertical GaN ™能够在高击穿电压下运行(图 1),这使 Vertical GaN™ 能够为最苛刻的应用供电,如数据中心服务器电源、电动汽车、太阳能逆变器、电机和高速列车。

图 1:GaN 材料特性与 Si 和 SiC 的比较 [图片:NextGen Power Systems]
传统功率器件和横向 GaN-on-Si
电力电子设备使用固态设备来处理或转换电力。电源转换器或适配器无处不在,并且有各种形状和尺寸。
大多数称为开关电源 (SMPS) 的转换器使用电容器、电感器、变压器和半导体开关将功率从具有给定电压和电流的输入传输到具有不同电压/电流配置的输出(图 2)。

图 2:开关模式电源框图 [图片:NextGen Power Systems]
电容器、电感器和变压器是无源且体积较大的组件。为了减小 SMPS 的尺寸,它们必须在高频下运行。为了在高频下工作,他们需要更好的半导体开关,以克服现有硅基开关的局限性,这些开关只能在高达几百 kHz 的频率下工作。
在过去的三年中,MOSFET 和 IGBT 等硅器件主导了功率器件市场。具体来说,硅基功率 MOSFET 已经达到了它们的技术极限,只是增加了额外的性能提升。“硅已经达到极限。根据其材料特性,目前您无法从硅功率器件中获得任何根本收益,”Dinesh Ramanathan 说。
碳化硅 (SiC) 和氮化镓 (GaN) 等替代材料为实现新一代功率器件以克服硅的局限性提供了可能性。其中,对基于 GaN 的功率器件开发的兴趣特别强烈,因为与 Si 和 SiC 相比,GaN 的材料特性更好。
当前的 GaN 器件是在混合衬底上制造的:硅或碳化硅上的 GaN 薄层创建 GaN-on-Si 或 GaN-on-SiC HEMT(高电子迁移率晶体管)结构(图 3)。
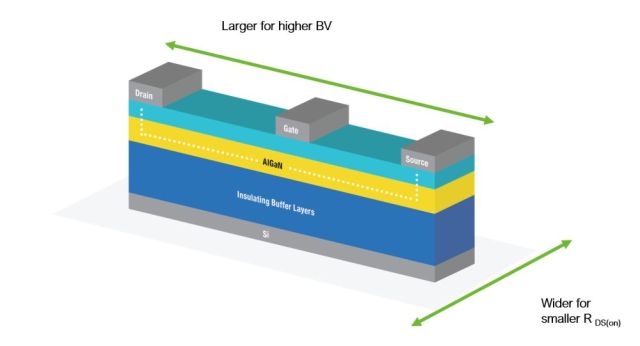
图 3:GaN-on-Si HEMT 结构的代表性示意图 [图片:NexGen Power Systems]
横向 GaN-on-Si(或 GaN-on-SiC)器件结合了热膨胀系数 (CTE) 不匹配的材料,导致可靠性和性能缺乏。此外,在典型的 GaN HEMT 器件中,通道非常靠近表面(大约几百纳米),这会产生钝化和冷却问题。在横向 GaN-on-Si 器件中,漏源分离决定了器件的击穿电压。较大的漏源分离会增加沟道电阻并限制电流能力。为了弥补这一点并增加载流能力,必须将器件做得更宽。更高电压和更高电流要求的组合导致器件具有大面积并因此具有更高的电容。因此,横向器件仅限于大约 650 V 的击穿电压。
雪崩击穿是 Si 和 SiC 器件在短期过压条件下保护自身的关键特性。横向 GaN-on-Si HEMT 中没有 pn 结可防止这些器件发生雪崩击穿。此外,由于靠近器件表面的电流传导敏感性,GaN-on-Si HEMT 难以从顶部冷却。将 Si 衬底与 GaN 层分开的缓冲层限制了底部冷却的效率。这意味着通常必须创建定制封装来冷却 GaN-on-Si HEMT,从而进一步增加其成本。
垂直 GaN 功率器件
GaN 和 Si 或 SiC 之间的晶格失配会降低 GaN 的电气特性并影响可靠性。对于在 GaN 衬底上生长的 GaN 器件,晶格和 CTE 都完美匹配——它是相同的材料。因此,可以在块状 GaN 衬底上外延生长非常厚的 GaN 层,从而可以创建非常高压的器件。
垂直 GaN ™技术释放了 GaN 卓越材料特性的全部潜力,因为它基于在 GaN 衬底上同质外延生长的 GaN(图 4)。此外,垂直 GaN 器件使用所有三个空间维度:通过增加漂移层的厚度来获得更高的击穿电压,通过增加器件面积来降低 R DS(on) / 电流能力,从而有效地创建了一个将击穿电压和电流解耦的 3-D 器件能力(R DS(on))。
“交流系统需要能够显着降低谐波失真的高性能功率因数校正电路。垂直 GaN 的高开关频率支持新的控制算法,并以更小的实施和更高的效率提供所有这些”,Dinesh Ramanathan 说。
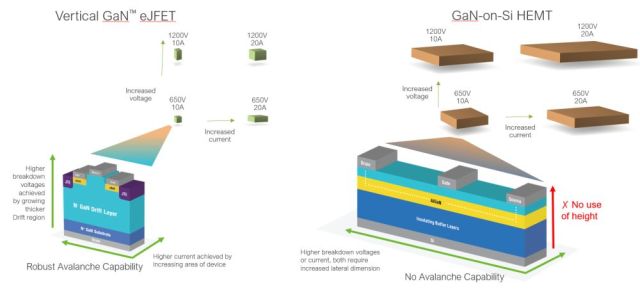
图 4:垂直 GaN 与 GaN-on-Si 器件结构 [图片:下一代电源系统]
图 5 显示了增强型垂直 GaN 结场效应晶体管 (eJFET) 和 GaN-on-Si 高电子迁移率晶体管 (HEMT) 的示意图。在垂直 GaN 的情况下,衬底和外延层都是具有极低缺陷密度的 GaN。NexGen Power Systems 表示,它能够展示 >40µm 的漂移厚度,产生击穿电压 >4000V 的二极管和电阻率为 2.8mΩ.cm 2 的晶体管。对于相同的电流容量,Vertical GaN ™器件尺寸大约比 650V GaN-on-Si HEMT 小六倍,但提供更高的 1200V 击穿电压。垂直 GaN ™ eJFET 具有雪崩能力,可在超过指定击穿电压时保护器件。
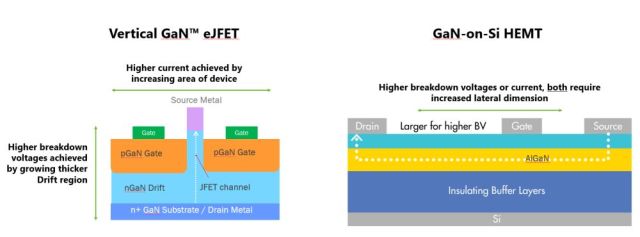
图 5:垂直 GaN eJFET 和 GaN-on-Si HEMT 示意图。白色虚线表示电子传导路径 [图片:下一代电力系统]
垂直 GaN ™器件旨在通过漂移层传导电流,漂移层位于晶体管的主体内部。因此,不存在由表面界面杂质捕获的电荷产生的动态 R DS (on) 变化的机制。栅极-源极二极管的耗尽区延伸到沟道中控制着漏极和源极之间的电流。在超过击穿电压的情况下,雪崩最初通过反向极化的栅源二极管发生,随后导致雪崩电流增加栅源电压,并使沟道打开并导通。
由于输出电容小,应用中的开关损耗非常小。与横向 GaN 器件相比,热量最佳地通过同质材料从器件的顶部和底部直接传递到封装引线框架(图 6),无需附加层。
“该器件的优势在于它只是由 GaN 制成的 pn 结。我们没有二维电子气和复杂的材料层。我们有一个增强型 JFET,它是一种广为人知的器件,并且因为它具有 pn 结,所以它会雪崩,因此您没有破坏性击穿。因为这一切都发生在设备的主体中,所以它可以在雪崩期间吸收相当多的能量,并且在雪崩之后设备恢复并正常运行。因此,它具有内置的安全机制。因此,它是一种更可靠、更坚固的设备”,Dinesh Ramanathan 说。

图 5:垂直 GaN eJFET 和 GaN-on-Si HEMT 示意图。白色虚线表示电子传导路径 [图片:下一代电力系统]
在电源电路中使用垂直 GaN
NexGen Vertical GaN™ FET 是一种结型场效应晶体管 (JFET),与硅逻辑器件中使用的 FinFET 相似。
栅极和源极之间的电压差 (V GS ) 控制着漏极和源极之间的电流。当 V GS低于阈值电压 (V t ) 时,JFET 通道关闭。当V GS大于V t 时,沟道打开,电流可以在源极和漏极之间流动。该电流在设备的主体内流动。电子迁移率很高,并且与 pn 结的较小电容一起,产生具有非常小的输出 (C oss ) 电容的器件。这使得器件能够在高频下高效运行,并支持开关频率高于 1MHz 的应用。
JFET 的对称结构允许源极和漏极交换功能,如果漏极端电压低于源极端电压,则沟道电流可以反向流动。这类似于 Si MOSFET 中体二极管的功能,但没有少数载流子/反向恢复电荷去除引起的损耗和潜在的可靠性问题。
“NexGen 的垂直 GaN eJFET 可以由成熟且具有成本效益的标准低成本 Si MOSFET 驱动器(图 7)驱动,只需对现有设计进行少量修改。这有助于快速采用具有卓越性能的设备”,Dinesh Ramanathan 说。
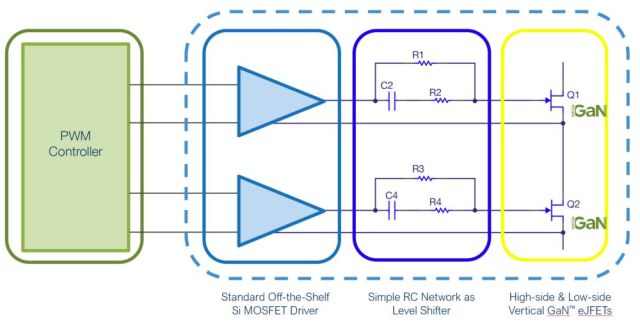
图 7:驱动 NexGen 的垂直 GaN eJFET [图片:下一代电源系统]
审核编辑:刘清
-
电力电子器件课件2009-09-16 13745
-
做好医疗电子设备的电子元器件的维修2009-11-28 80769
-
报名 | 宽禁带半导体(SiC、GaN)电力电子技术应用交流会2017-07-11 5056
-
电力电子设备的现状与展望2018-08-05 9212
-
基于GaN的开关器件2019-06-21 3612
-
电力电子设备与电能质量2010-05-13 760
-
电力电子设备介绍2010-08-08 1655
-
电力电子设备设计手册免费下载2011-06-02 3066
-
垂直GaN 器件:电力电子的下一个层次2022-07-27 5535
-
应用于新一代电力电子的GaN相比于传统的Silicon有何优势?2023-11-07 1229
-
低成本垂直GaN功率器件研究2023-12-27 2169
-
垂直与横向GaN功率器件单片集成的高效隔离技术2025-01-16 1598
-
垂直GaN迎来新突破!2025-07-22 5168
-
倾佳电力电子设备高压辅助电源拓扑、器件选型与1700V SiC MOSFET技术分析报告2025-10-14 797
-
安森美垂直GaN技术赋能功率器件应用未来2025-12-04 2098
全部0条评论

快来发表一下你的评论吧 !

