

 使用稀释的HCN水溶液的碳化硅清洗方法
使用稀释的HCN水溶液的碳化硅清洗方法
电子说
描述
摘要
金属污染物,如碳化硅表面的铜,不能通过使用传统的RCA清洗方法完全去除。RCA清洗后,在碳化硅表面没有形成化学氧化物,这种化学稳定性归因于RCA方法对金属污染物的不完全去除,因为它通过氧化和随后的蚀刻去除了金属污染物。用氰化氢HCN水溶液清洗被金属污染的碳化硅,然后进行RCA清洗,反之亦然,可以完全去除它们。结果表明,强吸附金属和粗糙碳化硅表面底部区域的金属不能分别用RCA法和HCN法去除。由于氰化物离子的高反应性,HCN方法可以去除强吸附的金属,而底部区域的金属不能被去除,因为去除过程需要形成大体积的金属-氰化物络合离子。
介绍
碳化硅具有优异的物理性能,如高击穿电场、高电子漂移速度和高热导率。半导体清洗是器件制造最重要的工艺之一,。在制造硅大规模集成大规模集成电路的情况下,总工艺的25%以上用于清洗。碳化硅的化学稳定性比硅高得多。RCA方法通常被认为是碳化硅清洗的唯一合适的技术。在本文中,研究了RCA方法的机理,特别是HPM技术,并且已经表明只有在两种清洗溶液,即先后使用了HPM和氰化氢HCN溶液。
实验
首先,使用RCA方法清洗4H–sic 0001晶圆。然后,将晶片浸入0.08米氯化铜加0.08米氯化镍溶液中,室温下的酸碱度为9,持续10分钟,进行深度污染,然后用超纯水冲洗10分钟。然后,使用APM29wt%氢氧化铵:30wt%过氧化氢:水=1:1:5,HPM36wt%盐酸:30wt%过氧化氢:水=1:1:5,或0.05M,即0.14wt%氢氰酸水溶液清洗碳化硅晶圆。需要注意的是,氢氰酸的浓度远低于APM和HPM溶液。APM和HPM清洗分别在50°C和80°C下进行,而氢氰酸清洗则在室温下进行。通过加入氨水溶液,将氢氰酸水溶液的pH值调整为10。在清洗过程中,没有进行密集的搅拌。
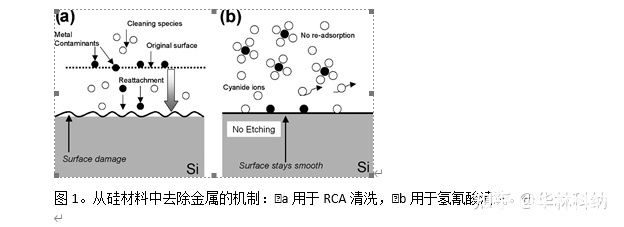
结果和讨论
图2显示了光谱a之前和光谱b–d清洁之后有意污染的碳化硅表面的TXRF光谱。
图3a显示了铜2p区的XPS光谱。
图5a和5b分别显示了碳化硅和硅表面的原子力显微镜图像。4H-碳化硅表面相对粗糙,均方根粗糙度值为1.0纳米,硅表面均方根粗糙度值为0.2纳米,此外,在碳化硅表面观察到化学机械抛光处理产生的可见划痕。碳化硅表面粗糙和划痕是由于化学稳定性高,湿法刻蚀困难造成的。未完全去除可能是由于底部区域存在铜物质,第一氯化萘离子可以接近,但第二氯化萘离子由于空间有限而无法接近,特别是当污染物被捕获在划痕中时。使用HPM溶液的不完全去除可能是由于化学因素,即。由于HPM反应性相对较弱,强吸附的铜物种不能被去除。此外,最终的氟化氢处理实际上是没有意义的,因为在HPM清洗过程中没有形成氧化层。
尽管HCN是一种有毒化合物,但HCN溶液在用于清洁后,很容易通过臭氧27或紫外线照射加上氢气分解成二氧化碳和N2过氧化物28处理。HCN也可以通过使用催化剂由非氰化物化合物合成,如CH4加NH3.29因此,HCN清洁法可以被认为对环境温和。
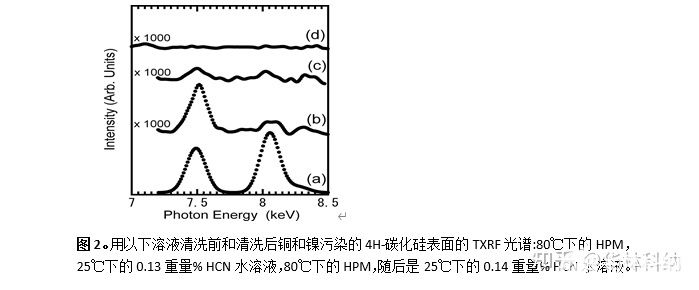
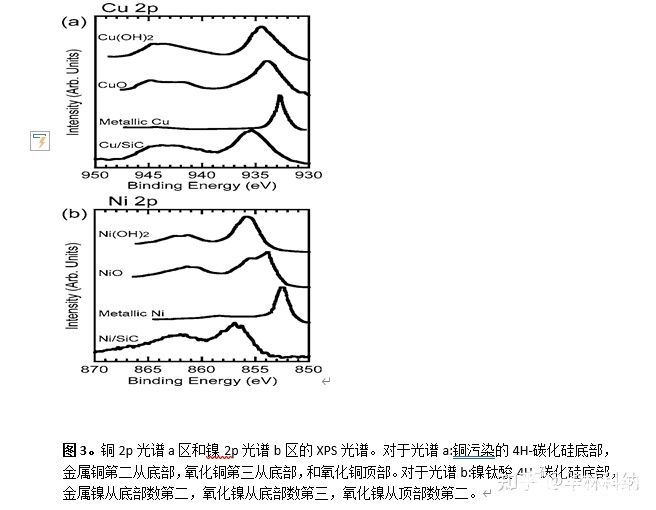
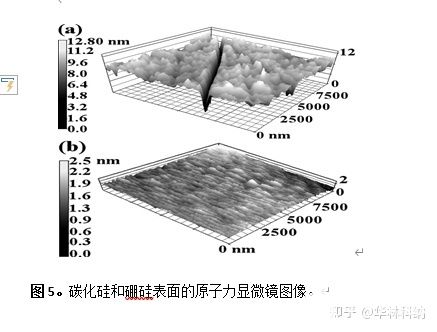
结论
RCA方法不会形成可通过HF蚀刻的天然氧化物层,因此,难以完全去除不需要的表面金属污染物。在本研究中,开发了一种完全去除碳化硅上金属污染物的替代方法。这种方法由传统的HPM法和HCN清洗法组成,反之亦然。HCN和HPM的解决方案可以分别去除由于化学和结构原因难以去除的金属污染物。
审核编辑:汤梓红
-
碳化硅外延晶片硅面贴膜后的清洗方法2025-02-07 317
-
碳化硅压敏电阻 - 氧化锌 MOV2024-03-08 8426
-
浅谈硅IGBT与碳化硅MOSFET驱动的区别2023-02-27 3050
-
请教碳化硅刻蚀工艺2022-08-31 42027
-
传统的硅组件、碳化硅(Sic)和氮化镓(GaN)2021-09-23 6186
-
碳化硅的应用2021-08-19 4001
-
什么是碳化硅(SiC)?它有哪些用途?2021-06-18 9428
-
碳化硅器件是如何组成逆变器的?2021-03-16 2845
-
碳化硅基板——三代半导体的领军者2021-01-12 4461
-
碳化硅半导体器件有哪些?2020-06-28 4465
-
CISSOID碳化硅驱动芯片2020-03-05 4303
-
碳化硅深层的特性2019-07-04 6123
-
碳化硅的历史与应用介绍2019-07-02 5072
-
新型电子封装热管理材料铝碳化硅2016-10-19 8783
全部0条评论

快来发表一下你的评论吧 !

