

图形尺寸不同的元器件在不同温度下的热积存
电子说
描述
热积存取决于栅极的尺寸,也就是IC芯片的最小图形尺寸。栅极长度较小的元器件能使源极/漏极扩散的空间小,因此也只有较小的热积存。由于最小图形尺寸的缩小,晶圆只能在高温(超过1000摄氏度)过程中停留很短的时间,所以需要紧凑的热积存控制。下图显示了图形尺寸不同的元器件在不同温度下的热积存(某温度下所能停留的时间)。
下图假设掺杂物的表面浓度为10的20次方原子/平方厘米。图形尺寸越小的元器件,热积存也越小。 如0.25 um的元器件经过源极/漏极注入之后只能在1000摄氏度)过程中停留很短的时间,所以需要紧凑的热积存控制。
下的温度下停留24s,而2 um的元器件能停留1000s。降低温度能使热积存明显增加,比如经过源极/ 漏极注入后的0. 25 um的元器件能够在900摄氏度的温度下停留200s,而当温度为800摄氏度时,可以停留3000s。
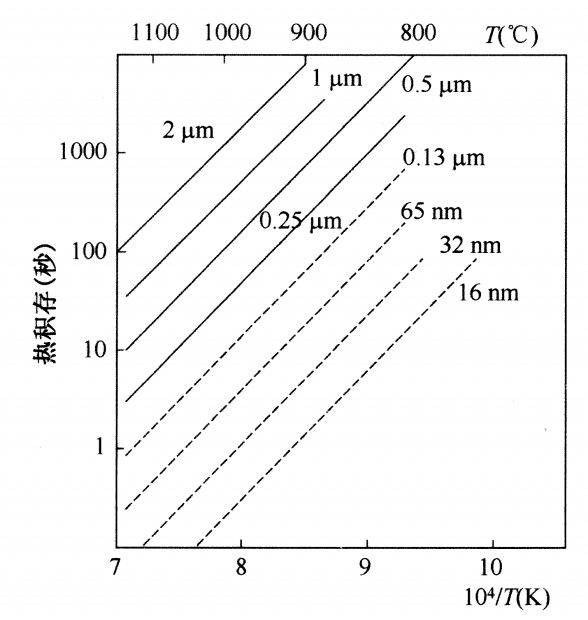
沉积和驱入过程
一般扩散掺杂工艺的顺序为先进行预沉积,然后为驱入过程。1050摄氏度时首先在晶圆表面沉积一层掺杂氧化层,如B2O3或P205。接着再用热氧化工艺消耗掉残余的掺杂物气体,并且在硅晶圆上生长一层二氧化硅层覆盖掺杂物,避免掺杂物的向外扩散。预沉积及覆盖层氧化反应中最常用的硼和磷原材料为二硼烷(B2 H6 )和三氯氧化磷(Phosphorus Oxychloride,即 POC13, 一般称为POCL),它们的化学反应式可表示如下:
硼: 预沉积:B2H6+2O2->B2O3+3H2O
覆盖层氧化反应:2B2O3 +3Si — 3SiO2 +4B 2H2O + Si t SiO2 +2H2
磷: 预沉积:4POC13 +3O2-> 2P2O5 +6C12
覆盖层氧化反应:2P2O5 +5Si — 5SiO2 +4P
二硼烷(B2H6)是一种有毒气体,闻起来带有烧焦的巧克力甜味。如果吸入或被皮肤吸收会有致命危险。二硼烷可燃,自燃温度为56Y;当空气中的二硼烷浓度高于0.8%时会产生爆炸。POCL3的蒸气除了引起皮肤、眼睛及肺部不适外,甚至会造成头晕、头痛、失去胃口、恶心及损害肺部。其他常用的N型掺杂化学物为三氢化碑(Ash’)和三氢化磷(PH3),这两者都有毒、易燃且易爆。它们在预沉积和氧化过程中的反应都和二硼烷(B2H6)类似。
下图所示为硼的预沉积和覆盖氧化过程使用的高温炉扩散系统。为了避免交叉污染,每个炉管仅适用一种掺杂物。
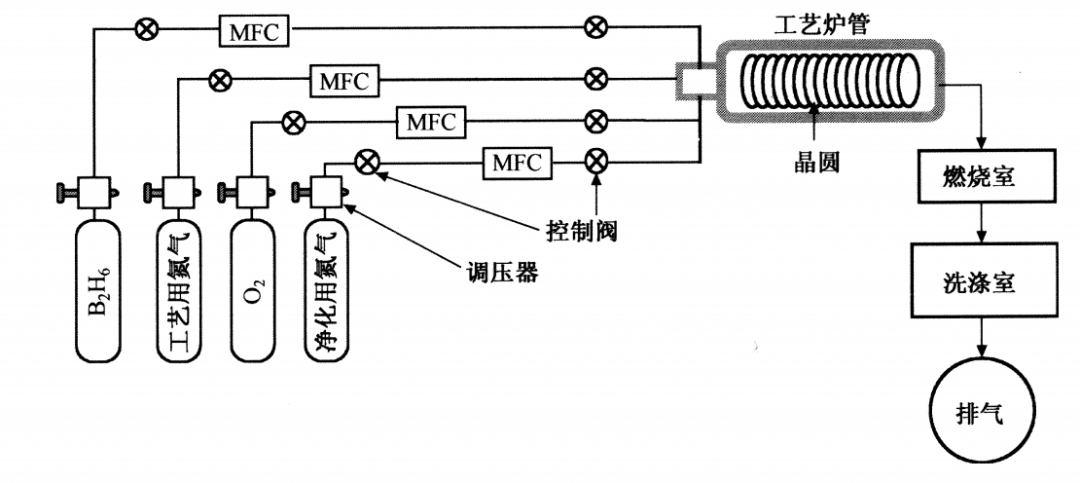
接着在氧气环境下将高温扩散炉的温度升高到1200摄氏度提供足够的热能使掺杂物快速扩散到硅衬底。驱入时间由所需的结深决定,可以通过已有的理论推算出每种掺杂物所需的驱入时间。下图显示了扩散掺杂工艺中的预沉积、覆盖氧化过程和驱入过程。
扩散工艺无法单独控制掺杂物的浓度和结深,这是因为两者都与温度密切相关。扩散是一种等向性过程,所以掺杂物原子都将扩散到遮蔽氧化层的边缘下方。但由于离子注入对掺杂物的浓度和分布能很好控制,所以先进IC生产中几乎所有的半导体掺杂过程都使用离子注入技术完成。扩散技术在先进IC制造中的主要应用是在阱区注入退火过程中将掺杂物驱入。
20世纪90年代晚期,研发部门为了形成超浅结深(Ultra-Shallow Junction, USJ)使扩散技术再次流行,首先利用CVD技术将含有高浓度硼的硼硅玻璃(BSG)沉积在晶圆表面,接着利用快速加热工艺(RTP)再将硼从BSG中驱出并扩散到硅中形成浅结。下图显示了超浅结形成时的预沉积、扩散和剥除过程。
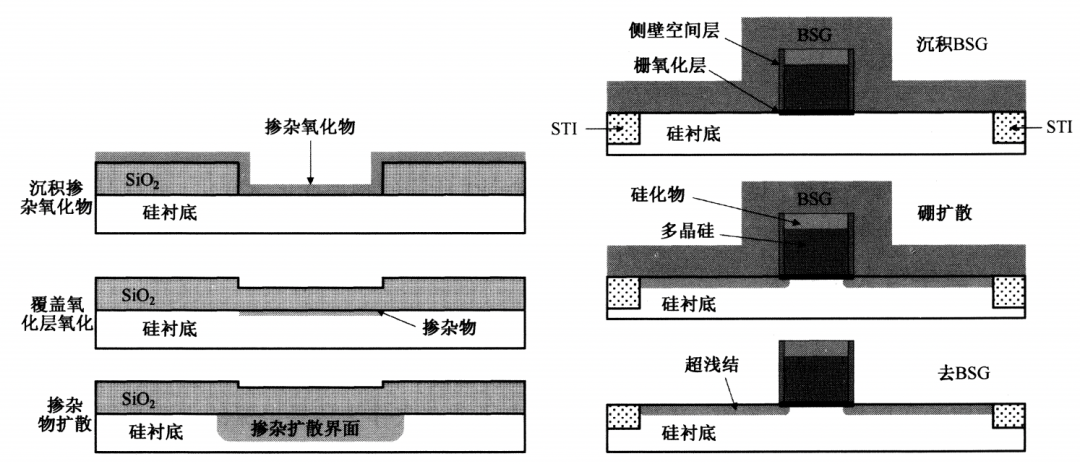
审核编辑:刘清
-
PCB元器件布局通则和尺寸考虑2018-08-30 2094
-
元器件布局对PCB热设计的重要性2019-08-07 3876
-
PCB热设计技巧:元器件的合理摆放2019-09-26 4416
-
铜线在不同温度下的线径和所能承受的最大电流表2021-09-28 5995
-
元器件封装尺寸2009-09-11 1370
-
基于热分析的电子元器件可靠性探讨2009-09-18 622
-
protel设计之元器件的间距与安装尺寸2011-04-15 4083
-
常用元器件封装标准尺寸(精华)2011-07-22 7485
-
常用贴片芯片及元器件封装尺寸2017-04-21 2962
-
元器件的封装尺寸资料概述2018-12-25 1350
-
AlGaN和GaN HEMT在不同温度下的退化规律及退化机理详细说明2020-06-23 1503
-
预测元器件温度的10项提示—高级操作指南2023-02-28 1844
-
热控仪表元器件符号总结表2023-12-11 6060
-
HX1117稳压芯片在不同温度下的性能表现2025-03-06 1476
-
DSC中不同温升速度对玻璃化转变温度测试结果的影响2025-08-28 1678
全部0条评论

快来发表一下你的评论吧 !

