

SiC功率器件的主要特点
描述
碳化硅(SiC)功率器件在高击穿电压、低功耗和快速开关方面明显优于成熟的硅(Si)器件。本文简要介绍了SiC功率器件的主要特点,然后介绍了SiC pn结击穿现象的研究工作以及考虑能带结构的相关讨论。接下来,介绍了SiC金属氧化物半导体场效应晶体管(最重要的单极器件)的最新进展,重点是SiO上通道迁移率的改善2/碳化硅接口。介绍了用于超高压(>10 kV)应用的SiC双极器件的开发,例如引脚二极管和绝缘栅双极晶体管,并展示了提高载流子寿命的效果。还描述了大规模生产的现状以及SiC功率器件如何为节能做出贡献。
关于晶体结构,SiC可以以许多(超过100种)不同的形式结晶,称为“多型”,其中Si-C对沿一个方向的堆叠序列因不同的多型而异。21)对于电子应用,我们必须确定最合适的SiC多型,并且必须生长出高质量和大的单晶,不含外来多型的夹杂物。SiC的早期发展致力于SiC体积和外延生长中的多型控制。22)在1990年代初期,专门研究了3C-SiC(立方相)和6H-SiC(六方相),第一个1 kV SiC肖特基势垒二极管(SBD)是用6H-SiC制造的。23)1994年,人们发现4H-SiC多型(另一个六方相)远优于3C-SiC和6H-SiC,具有更高的电子迁移率和更宽的带隙。24–26)在这一发现之后,4H-SiC已被专门研究和生产用于功率器件应用。8)在本文中,为简单起见,4H-SiC表示为SiC。
基于以日本、美国和欧洲为中心对生长、材料特性和器件加工技术的广泛研究,SiC SBD和金属氧化物半导体场效应晶体管(MOSFET)的生产已经开始。然而,SiC功率MOSFET的性能仍远未达到材料的全部潜力。此外,许多重要的内在特性和缺陷的性质是未知的。对SiC中载流子传输、载流子复合和击穿现象的物理理解也很差。这种材料独特的六方晶体结构、宽带隙和复杂的能带结构使得表征物理性质和适当解释采集的数据变得非常困难。由于材料的高机械硬度和化学惰性,制备适当的样品结构或器件结构进行表征也很困难。
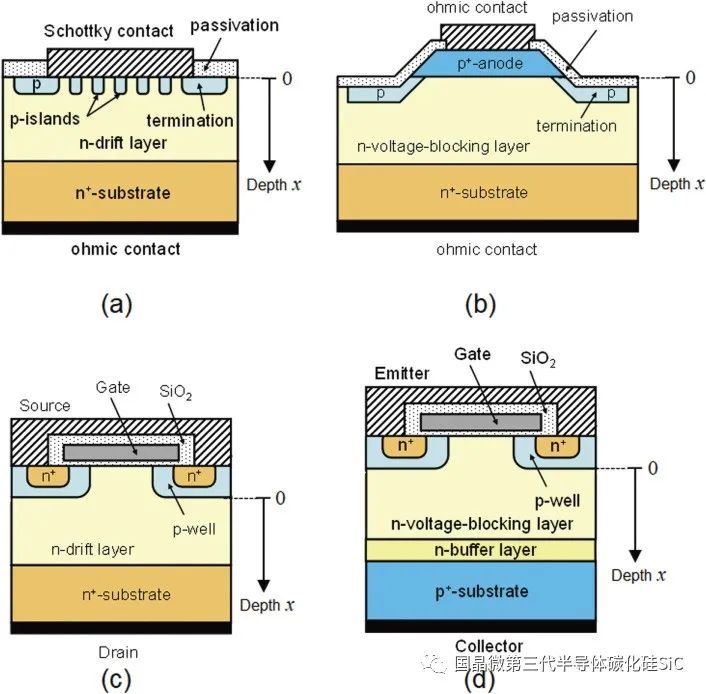
SiC功率器件的典型结构示意图如图所示。图例.1.1.数字图1(a)1(a)和(b)分别显示了肖特基二极管和PN二极管(通常称为“PN二极管”),其中金属阳极或p阳极形成在相对较厚的n层(电压阻断区)上,该n层通过其欧姆接触连接到底部低电阻率n基板。当正电压施加到阳极时,这些二极管必须允许电流以低导通电阻平稳流动(正向偏置条件),而当负电压施加到阳极时,它们必须完全阻断电流(反向偏置条件)。当施加高负电压时,为了完全阻断硅基二极管中的电流,需要相对较厚的n层将二极管内的电场降低到其临界值以下,以防止击穿现象(或电流的发生)。在反向偏置下击穿时,Si二极管内的电场如图中的蓝色三角形所示。+++图22作为与结点距离的函数,即阳极和n层之间的界面。对于SiC二极管来说,情况则完全不同,因为SiC维持的电场(击穿场或临界电场)要高得多,大约是Si的十倍。因此,SiC二极管中的n层可以是Si二极管的十倍左右,以实现相同的击穿电压,如图中的红色三角形所示。图例.2.2.这里是图中直角三角形的面积。图22对应于击穿电压。此外,n层的掺杂密度与图中图的斜率成正比。图2,2,使用SiC可以增加100倍。由于n层更薄且掺杂量更大,在给定击穿电压下,SiC器件的n层电阻比Si器件低约400-800倍。这就是为什么SiC器件表现出低得多的导通电阻(导通电阻)的主要原因,从而在器件运行期间显著降低焦耳热。
通常,功率器件必须在关断状态下维持相当高的电压。在反向偏置二极管和关断晶体管中,电流通常保持得可以忽略不计,但如果施加的电压超过所谓的击穿电压,电流就会增加到相当大的水平。对于轻掺杂半导体,这种击穿过程是由载流子的雪崩现象引起的,而在重掺杂材料中,它是由齐纳隧穿过程引起的。为了阐明SiC中的这些击穿过程,对各种pn二极管进行了系统研究,如下所述。请注意,SiC能带结构的复杂和各向异性方面以及位错可能会影响击穿过程。
在功率器件中,MOSFET和SBD等单极器件是理想的,因为单极器件具有快速和低损耗的开关特性,并且更容易制造。在单极器件中,n层(漂移层或阻断层)的电阻由厚度和供体密度决定,因为只有有意掺杂的供体提供的电子才会产生电流。然而,当击穿电压设计为超过一定值时,n层电阻(漂移电阻)变得高得令人无法接受,这在图中显示为材料极限。图例.3.3.在硅功率器件中,n层电阻变得非常高(>50 mΩcm2)当击穿电压高于600–800 V时。对于高压器件,利用从p区到厚n层的少数载流子注入(双极性操作),这导致n层电阻的显着降低,因为电子和空穴的密度都高于供体密度,都会对电流产生影响。因此,IGBT等双极器件用于高压应用。
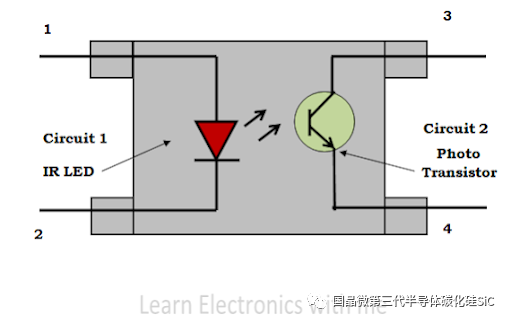
硅功率器件的一个固有限制是超高压阻断能力。当击穿电压超过10 kV时,n层所需的厚度和供体密度变为约1.2 mm和1×1013厘米−3分别。这种晶片难以生产,所需的供体密度接近120°C时Si的固有载流子密度。与硅相比,超高压SiC器件的制造要容易得多,因为临界电场高出约十倍。例如,10 kV SiC器件所需的n层的厚度和供体密度约为80μm和8×1014厘米−3分别。然而,即使使用SiC,这种厚且轻掺杂的n层的电阻对于这种超高压单极器件也会变得很高。因此,SiC双极器件对10 kV(或更高)应用具有吸引力。
碳化硅功率器件的应用!
通过SiC材料和器件技术的快速进步,SiC器件因其高性能和可靠性而成为宽带隙半导体功率器件中最成熟的。数字图2424原理图显示了Si、SiC、GaN和Ga器件阻断电压方面的主要应用范围2O3功率开关器件(未显示二极管)。关于硅功率器件,功率MOSFET主要采用在800 V以下的阻断电压范围内,而IGBT则在高于600 V的电压范围内使用。28)硅晶闸管主要在非常高的电压范围内使用。预计SiC功率MOSFET将取代阻断电压范围为600至6500 V的Si器件,因为它们具有低导通电阻和快速开关。然而,低于500 V,SiC器件将很难与Si竞争,因为这种低电压范围内的Si功率MOSFET表现出高性能,并且通常与栅极驱动电路和传感器集成在一起。SiC IGBT在5-8 kV以上的极高阻断电压范围内很有前景。
无锡国晶微半导体技术有限公司是宽禁带第三代半导体碳化硅SiC功率器件、氮化镓GaN光电器件以及常规集成电路研发及产业化的高科技创新型企业,从事碳化硅场效应管,碳化硅肖特基二极管、GaN光电光耦继电器、单片机集成电路等产品芯片设计、生产与销售并提供相关产品整体方案设计配套服务,总部位于江苏省无锡市高新技术开发区内,并在杭州、深圳和香港设有研发中心和销售服务支持中心及办事处。
公司具有国内领先的研发实力,专注于为客户提供高效能、低功耗、低阻值、品质稳定的碳化硅高低功率器件及光电集成电路产品,同时提供一站式的应用解决方案和现场技术支持服务,使客户的系统性能优异、灵活可靠,并具有成本竞争力。
公司的碳化硅功率器件涵盖650V/2A-100A,1200V/2A-90A,1700V/5A-80A等系列,产品已经投入批量生产,产品完全可以对标国际品牌同行的先进品质及水平。先后推出全电流电压等级碳化硅肖特基二极管、通过工业级、车规级可靠性测试的碳化硅MOSFET系列产品,性能达到国际先进水平,应用于太阳能逆变电源、新能源电动汽车及充电桩、智能电网、高频电焊、轨道交通、工业控制特种电源、国防军工等领域。由于其具有高速开关和低导通电阻的特性,即使在高温条件下也能体现优异的电气特性,大幅降低开关损耗,使元器件更小型化及轻量化,效能更高效,提高系统整体可靠性,可使电动汽车在续航里程提升10%,整车重量降低5%左右,并实现设计用充电桩的高温环境下安全、稳定运行。
特别在高低压光耦半导体技术方面更是拥有业内领先的研发团队。在国内创先设计开发了28nm光敏光栅开关PVG芯片技术,并成功量产应用于60V、400V、600V高低压、低内阻、低电容的光电耦合继电器芯片、涵盖1500kVrms SOP超小封装及3750kVrms隔离增强型常规SMD、DIP等不同封装,单路、双路、混合双路、常开常闭等电路产品,另包括200V SOI MOS/LIGBT集成芯片、100V CMOS/LDMOS集成芯片、8bit及32bit单片机等集成电路产品,均获得市场及各重点科研单位、检测机构的新产品认定。
公司核心研发团队中大部分工程师拥有硕士及以上学位,并有多名博士主持项目的开发。公司建立了科技创新和知识产权管理的规范体系,在电路设计、半导体器件及工艺设计、可靠性设计、器件模型提取等方面积累了众多核心技术,拥有多项国际、国内自主发明专利。
“国之重器,从晶出发,自强自主,成就百年”是国晶微半导体的企业目标,我们为员工提供精彩的发展空间,为客户提供精良的产品服务,我们真诚期待与您携手共赢未来。
审核编辑 :李倩
-
SiC功率器件的特点和优势2024-12-05 2543
-
RISC的主要特点和优点讲解2023-02-27 1249
-
SPI总线的主要特点2022-02-09 915
-
什么是Lora?LoRa的主要特点?2021-07-26 1649
-
高频功率放大器主要特点和应用2021-05-27 1605
-
浅析SiC功率器件SiC SBD2019-05-07 3733
-
SiC功率器件概述2019-05-06 3461
-
SiC功率元器件的开发背景和优点2018-11-29 3939
-
全SiC功率模块介绍2018-11-27 6043
-
贴片头的分类和主要特点2018-09-03 3413
-
功率放大器的主要特点介绍2017-08-10 3903
-
Linux的主要特点 发展 安装2012-08-13 3427
-
变频空调的控制原理及主要特点2009-08-21 2953
全部0条评论

快来发表一下你的评论吧 !

