

物理气相沉积及溅射工艺(PVD and Sputtering)
描述

物理气相沉积(Physical Vapor Deposition, PVD)工艺是指采用物理方法,如真空蒸发、溅射 (Sputtering)镀膜、离子体镀膜和分子束外延等,在圆片表面形成薄膜。在超大规模集成电路产业中,使用最广泛的 PVD 技术是溅射镀膜,主要应用于集成电路的电极和金属互连。溅射镀膜是在高度真空条件下,稀有气体(如氩气 Ar)在外加电场作用下电离成离子(如 Ar),并在高电压环境下轰击材料靶源,撞击出靶材的原子或分子,经过无碰撞飞行过程抵达圆片表面形成薄膜。氩气(Ar)的化学性质稳定,其离子不会与靶材和薄膜产生化学反应。随着集成电路芯片进入0. 13um 铜互连时代,铜的阻挡材料层采用了氮化钛(TiN)或氮化钽(TaN)薄膜,产业技术的需求推动了对化学反应溅射技术的研发,即在溅射腔里,除了氩气,还有反应气体N2,这样从靶材Ti 或 Ta 轰击出来的Ti 或Ta 与氮气反应,生成所需的 TiN 或TaN 薄。
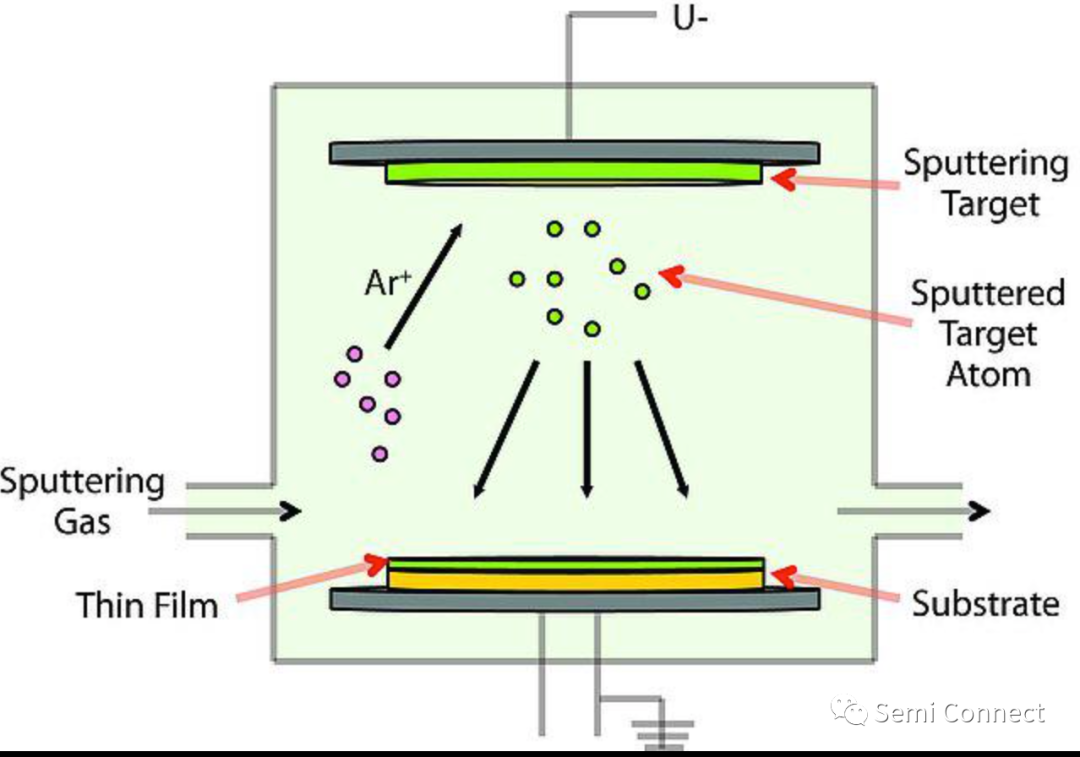
常用的溅射方式有 3 种,即直流溅射、射频溅射和磁控溅射。由于集成电路的集成度不断提高,多层金属布线的层数越来越多,PVD工艺的应用也更为广泛。PVD 材料包括 AI-Si、AI-Cu、 Al-Si-Cu、Ti、 Ta、 Co、 TiN、TaN、Ni、WSi2等。 PVD和溅射工艺通常是在一个高度密闭的反应腔室里完成的,其真空度达到 1X10(-7)~9×10(-9)Torr ,可保证反应过程中气体的纯度;同时,还需要外接一个高电压,使稀有气体离子化以产生足够高的电压表击靼材。评价物理气相沉积和溅射工艺的主要参数有尘埃数量,以及形成薄膜的电阻值、均匀性、反射率、厚度和应力等。
审核编辑 :李倩
-
019. PVD溅射工艺充八万 2023-07-06
-
《炬丰科技-半导体工艺》IC制造工艺2021-07-08 4777
-
PVD技术在CCL中的应用研究2010-08-27 912
-
芯片薄膜工艺是什么2021-12-22 9743
-
PVD和CVD无机薄膜沉积方式大全2023-02-24 7789
-
基于PVD 薄膜沉积工艺2023-05-26 6811
-
半导体工艺装备现状及发展趋势2023-05-30 3791
-
光纤传感器在磁控溅射镀膜温度的监测2023-12-04 1562
-
化学气相沉积与物理气相沉积的差异2023-12-26 2997
-
流量控制器在半导体加工工艺化学气相沉积(CVD)的应用2024-03-28 2492
-
Bumping工艺升级,PVD溅射技术成关键推手2024-11-14 3678
-
IBC技术新突破:基于物理气相沉积(PVD)的自对准背接触SABC太阳能电池开发2025-04-14 1857
-
质量流量控制器在薄膜沉积工艺中的应用2025-04-16 1235
-
一文详解磁控溅射技术2026-02-03 1608
-
磁控溅射工艺时间对金属及氧化物靶材溅射速率的影响:基于台阶仪的薄膜厚度表征2026-04-15 217
全部0条评论

快来发表一下你的评论吧 !

