

化学气相沉积工艺(Chemical Vapor Deposition,CVD)
描述
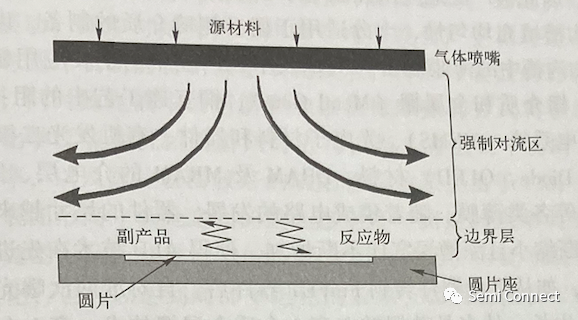
化学气相沉积 (Chemical Vapor Deposition, CVD)是指不同分压的多种气相状态反应物在一定温度和气压下发生化学反应,生成的固态物质沉积在衬底材料表面,从而获得所需薄膜的工艺技术。在传统集成电路制造工艺中,所获得的薄膜材料一般为氧化物、氮化物、碳化物等化合物或多晶硅、非晶硅等材料。45nm 节点后比较常用的选择性外延 (Selective Epitaxy)技术,如源漏 SiGe 或 Si 选择性外延生长,也是一种CVD 技术,这种技术可在硅或其他材料单晶衬底上顺着原有晶格继续形成同种类或晶格相近的单晶材料。CVD广泛用于绝缘介质薄膜(如 SiO2、Si3N4和 SiON等)及金属薄膜(如 W 等)的生长。在一定的温度下,基本的化学反应为
SiH4 + O2 ———> SiO2 + 2H2
SiH4 + 2PH3 + O2 ———> SiO2 + 2P + 5H2
SiH4 + B2H6 + O2 ———> SiO2 + 2B + 5H2
3SiH4 + 4NH3 ———> Si3N4 + 12H2
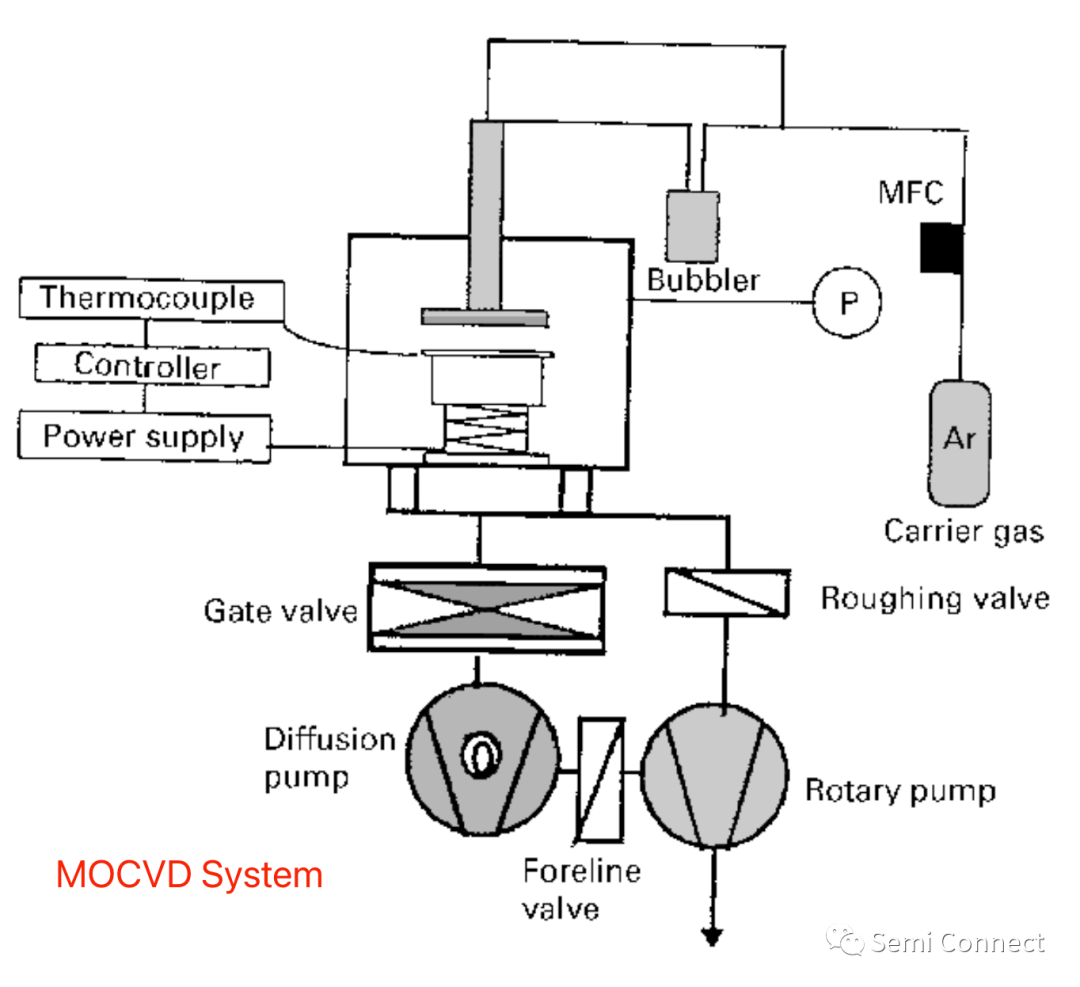
用来作为反应的气体还有 N2O、Si (C2H5O)4、SiCl2H2、WF6等。通常,按照压力分类,CVD 可分为常压化学气相沉积 ( Atmospherie Pressure CVD,APCVD)、亚常压化学气相沉积 (Sub Atmospheric Pressure CVD)和低压化学气相沉积 (Low Pressure CVD, LPCVD):按照温度分类,CVD 可分为高温/低温氧化膜化学气相沉积(HTO/LTO CVD) 和快速热化学气相沉积 (Rapid Thermal CVD,RTCVD);按照反应源分类,CVD 可分为硅烷基化学气相沉积 (Silane-Based CVD)、聚酯基化学气相沉积 (TEOS-Based CVD)和金属有机气相沉积(MOCVD);按照能量分类,CVD 可分为热能化学气相沉积 (Thermal CVD)、等离子体增强化学气相沉积 (Plasma Enhanced CVD, PECVD)和高密度等离子体化学气相沉积 (High Density Plasma CVD, HDPCVD);近期还发展出缝隙填充能力极好的流动性化学气相沉积(Flowable CVD,FCVD)。不同的CVD 生长的膜的特性(如化学成分、介电常数、张力、应力和击穿电压)都有差别,可根据不同的工艺要求(如温度、台阶覆盖率、填充要求等)而分别使用。
审核编辑 :李倩
-
晶圆制造工艺流程完整版2011-12-01 35870
-
高密度等离子体化学气相淀积(HDP CVD)工艺2009-12-17 2131
-
低热量化学气相工艺制备氮化硅2009-06-12 1297
-
物理气相沉积及溅射工艺(PVD and Sputtering)2022-11-03 12638
-
原子层ALD沉积介绍2023-06-15 6963
-
国产CVD设备在4H-SiC衬底上的同质外延实验2023-06-19 2782
-
化学气相沉积与物理气相沉积的差异2023-12-26 2998
-
流量控制器在半导体加工工艺化学气相沉积(CVD)的应用2024-03-28 2494
-
半导体FAB中常见的五种CVD工艺2025-01-03 13772
-
质量流量控制器在薄膜沉积工艺中的应用2025-04-16 1236
-
半导体“化学气相沉积(CVD)碳化硅(Sic)”工艺技术详解;2025-11-09 4180
-
化学气相淀积工艺的核心特性和系统分类2025-11-11 2355
全部0条评论

快来发表一下你的评论吧 !

