

湿法刻蚀和清洗(Wet Etch and Cleaning)
描述
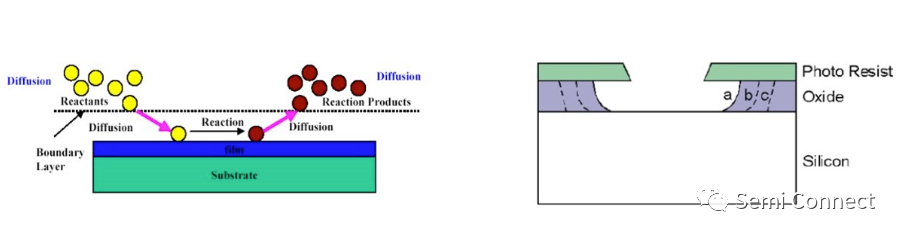
湿法刻蚀是集成电路制造工艺最早采用的技术之一。虽然由于受其刻蚀的各向同性的限制,使得大部分的湿法刻蚀工艺被具有各向异性的干法刻蚀替代,但是它在尺寸较大的非关键层清洗中依然发挥着重要的作用。尤其是在对氧化物去除残留与表皮剥离的刻蚀中,比干法刻蚀更为有效和经济。湿法刻蚀的对象主要有氧化硅、氮化硅、单晶硅或多晶硅等。湿法刻蚀氧化硅通常采用氢氟酸(HF)为主要化学载体。为了提高选择性,工艺中采用氟化铵缓冲的稀氢氟酸。为了保持 pH 值稳定,可以加入少量的强酸或其他元素。掺杂的氧化硅比纯氧化硅更容易腐蚀。湿法化学剥离( Wet Removal)主要是为了去除光刻胶和硬掩模(氮化硅)。热磷酸 (H3PO4)是湿法化学剥离去除氮化硅的主要化学液,对于氧化硅有较好的选择比。在进行这类化学剥离工艺前,需要将附在表面的氧化硅用 HF 酸进行预处理,以便将氮化硅均匀地清除掉。
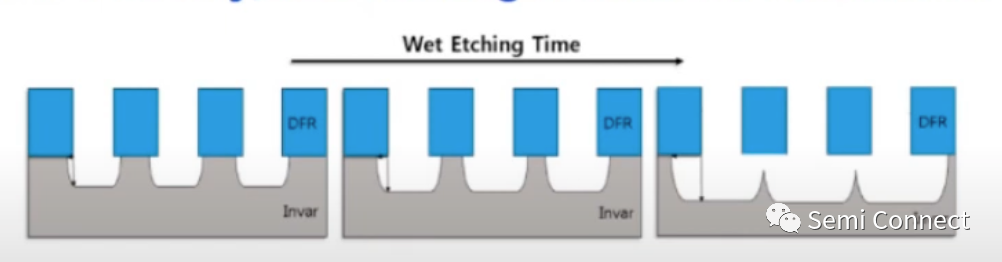
湿法清洗与湿法刻蚀类似,主要是通过化学反应去除硅片表面的污染物,包括颗粒、有机物、金属和氧化物。主流的湿法清洗就是湿化学法。虽然干法清洗可以替代很多湿法清洗,但是目前尚未找到可以完全取代湿法清洗的方法。湿法清洗常用的化学品有硫酸、盐酸、氢氟酸、磷酸、过氧化氢、氢氧化铵、氟化铵等,在实际应用中视需要以一种或多种化学品按照一定比例与去离子水调配组成清洗液,如 SC1、SC2、DHF、BHF 等。
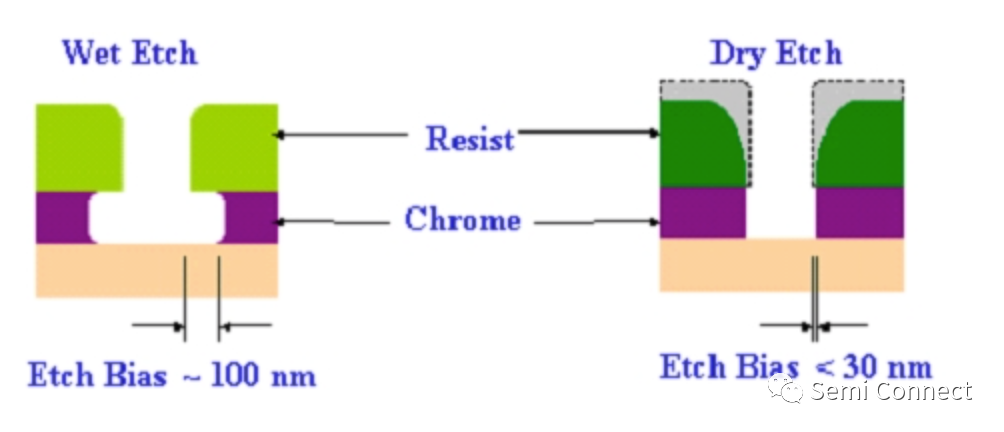
清洗常用于氧化膜沉积前工艺,因为氧化膜的制备必领在绝对清洁的硅片表面上进行。常见的硅片清洗流程见下表 。
| 序号 | 清洗工艺步骤 | 工艺目的 |
| 1 | 热的H2SO4/H2O2 | 去除有机物和金属 |
| 2 | 超纯水 | 清洗 |
| 3 | 稀释的HF(DHF) | 去除自然氧化层 |
| 4 | 超纯水 | 清洗 |
| 5 | NH4OH/H2O2/H2O | 去除颗粒 |
| 6 | 超纯水清洗(室温、80~90℃、室温) | 清洗 |
| 7 | HCL/H2O2/H2O | 去除金属 |
| 8 | 超纯水 | 清洗 |
| 9 | 稀释的HF(DHF) | 去除自然氧化层 |
| 10 | 超纯水 | 清洗 |
|
11 |
干燥 | 干燥 |
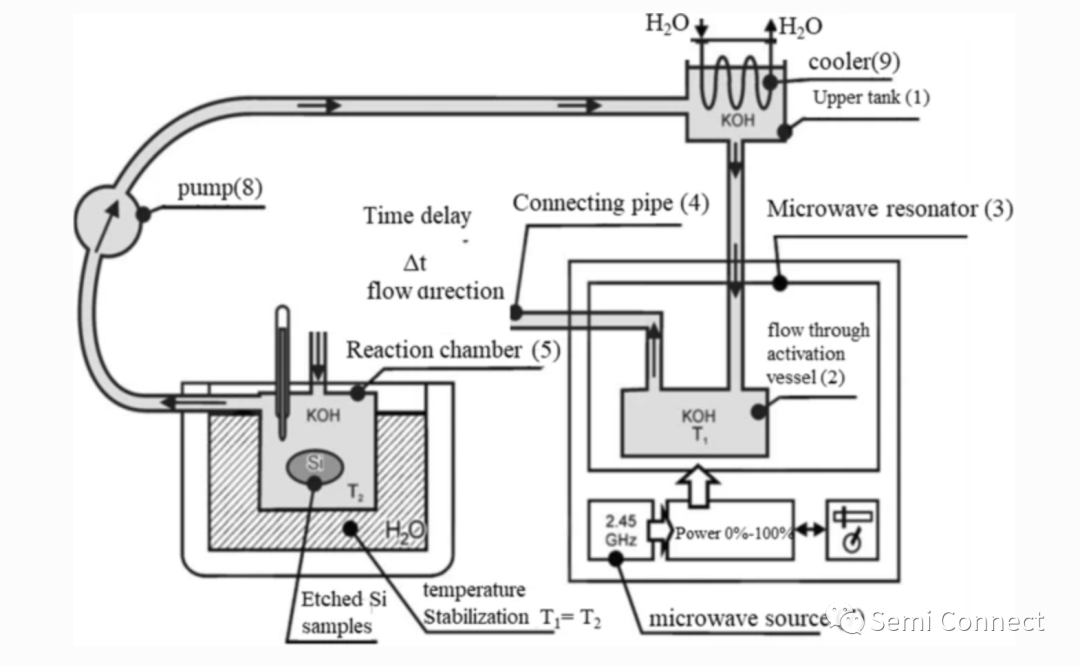
1970 年,由美国无线电公司的 W. Kern 和D.Puotinen 提出了 RCA 湿法清洗方法。在这种方法中,1号清洗液(RCA1 或 SC1)是碱性溶液,能去除表面颗粒物和有机物质;2号清洗液(RCA2 或 SC2)是酸性溶液,能去除表面金属污染物和颗粒。近年来,清洗技术在雾化蒸汽清洗( Vapor Clean)、超声波辅助清洗等新技术支撑下,在高端芯片制造工艺中获得了更广泛的应用。
审核编辑 :李倩
-
半导体及光伏太阳能领域湿法清洗2011-04-13 13030
-
清洗 腐蚀设备2017-12-15 4212
-
湿法设备分类及槽体材质2021-02-07 3560
-
关于氮(氧)化硅湿法刻蚀后清洗方式的改进2020-12-29 3731
-
工业泵在半导体湿法腐蚀清洗设备中的应用2023-04-20 2768
-
常见的各向同性湿法刻蚀的实际应用2022-10-08 7843
-
干法刻蚀和清洗(Dry Etch and Cleaning)2022-11-10 10529
-
湿法刻蚀工艺的流程包括哪些?2023-02-10 7865
-
PDMS湿法刻蚀与软刻蚀的区别2024-09-27 1372
-
湿法刻蚀步骤有哪些2024-12-13 1818
-
芯片湿法刻蚀残留物去除方法2024-12-26 2557
-
后段刻蚀工艺(BEOL ETCH)详解2024-12-31 3907
-
半导体湿法刻蚀残留物的原理2025-01-02 1537
-
湿法刻蚀:晶圆上的微观雕刻2025-03-12 1405
-
湿法刻蚀工作槽全解析:各槽分工协同,揭秘高效精准刻蚀的运作逻辑2026-05-06 138
全部0条评论

快来发表一下你的评论吧 !

