

最新的系统级封装SiP发展趋势
描述
日月光工程中心资深处长王盟仁近日分享最新的系统级封装SiP发展趋势。王处长表示, SoC犹如一个“固定套餐“,而SiP就是”自助餐“,可根据功能和需求自由组合,提供弹性化设计。以手机为例,可进行系统级封装SiP的功能模块包括传感器(Sensors)、互联(Connectivity)、射频前端模组(RF FEM)以及基带(Baseband)。SiP根据不同的功能整合成模块后,从一个功能到次系统,再整合到PCB,将手机整体尺寸缩小 57%,预留更大的空间放置电池,提供更大的电力储存,延长产品的使用时间,使手机的厚度变薄,但功能更多、速度更快。
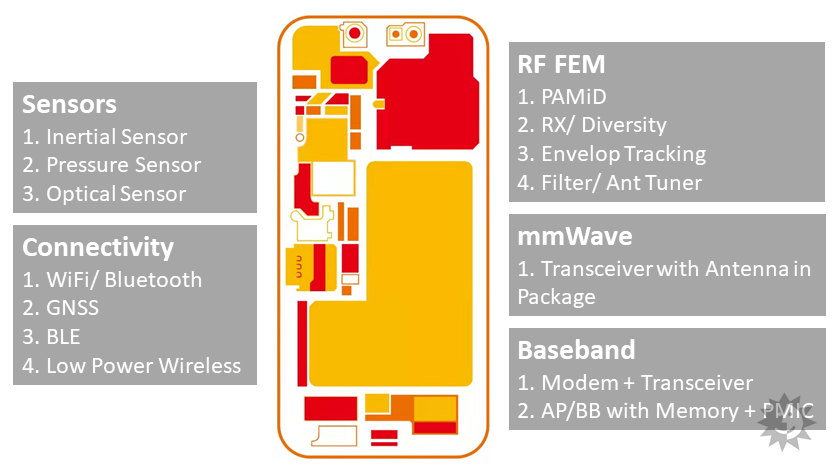
系统级封装SiP技术趋势
高性能、高集成及微型化需求推动系统级封装SiP不断发展。从最初最简单的SiP,经过不断研发,整合天线,并逐步与扇出型封装Fan Out及系统级封装SiP整合,提供更高的集成能力与更强的性能。未来将朝着3D系统级封装SiP及3D模块方向发展,可实现线路层用晶圆级(wafer level)制程的系统级封装SiP及更高级别集成的替代解决方案,提供最轻薄短小的封装形式。
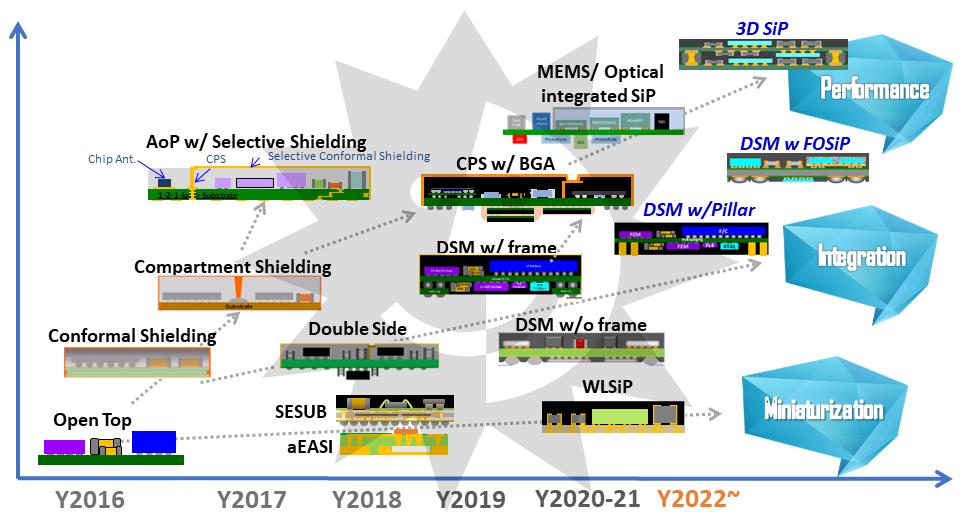
MEMS与传感器封装应用
MEMS与传感器主要有Open Top和Seal这两种封装方式。Open Top所用传感器功能需要与外界有所沟通,通常包含微光学(Optical MEMS),环境传感器(Environmental Sensor)以及麦克风所用到的声学传感器(Acoustic Sensors)。另一种封装方式是Seal,以molding的方式保护线路和互联模块,主要运用在惯性传感器(Inertial Sensor),包含加速度计、陀螺仪、磁力计、IMU、罗盘、智能传感集线器(MCU)等,以及射频组件中的天线调谐器、射频滤波器及振荡器等。

系统级封装SiP关键技术
系统级封装SiP的关键技术涵盖从Die Interconnection的粘晶(Die Bond)、打线(Wire Bond)及倒装芯片封装(Flip Chip),也包括高密度SMT贴片,利用008004被动元件,缩小零件间距至40μm。此外系统级封装SiP实现更好的电磁屏蔽功能,运用划区屏蔽(Compartment Shielding)及可选择性塑封(Selective Molding),成型上可依据客户的设计做不同形状的模块,可以是任意形状,甚至3D立体结构,适用于5G mmWave模块与TWS真无线蓝牙耳机等领域。
产品可追溯性
日月光有一套完整的产品可追溯系统,可追溯芯片及模块在整个生产过程中的产品履历,比如可以轻松查晶圆的出处,基板的ID,甚至基板的位置,以及所有材料ID、机台形式、机台号码以及相关的作业人员,只要扫Unit ID即可提供客户完整的产品资料。
日月光提供全面且多元的先进封装及系统级封装SiP制程与服务,从更优化的芯片设计到电性、热与机械性质的模拟、失败分析,以及制造的整合与弹性化的营运,是产品开发与量产的最佳合作伙伴。
审核编辑 :李倩
-
一文读懂系统级封装(SiP)技术:定义、应用与前景2024-12-31 8471
-
系统级封装(SiP)技术介绍2024-11-26 3522
-
LGA‐SiP封装技术解析2023-05-19 3738
-
系统级封装(SIP)有什么用?2023-03-16 4583
-
系统级封装SiP多样化应用以及先进封装发展趋势2022-03-23 7574
-
嵌入式芯片封装的发展趋势是什么2021-10-28 1249
-
伺服系统的发展趋势是怎样的?2021-09-30 3441
-
CMOS射频电路的发展趋势如何?2021-05-31 2215
-
SIP系统封装技术浅析2020-05-28 3757
-
先进封装技术的发展趋势2018-11-23 3805
-
系统级封装(SiP)的发展前景(上)2018-08-23 4416
-
stm8的发展趋势2013-11-04 4074
-
PCB发展趋势,六大趋势2012-11-24 6662
-
系统级封装(SiP)集成技术的发展与挑战2009-12-21 835
全部0条评论

快来发表一下你的评论吧 !

