

жІүйҮ‘PCBз„ҠзӣҳдёҚж¶Ұж№ҝй—®йўҳзҡ„еҲҶжһҗж–№жі•
жҸҸиҝ°
з®Җд»Ӣ
йҡҸзқҖж— й“…еҢ–дә§дёҡзҡ„жҺЁиҝӣпјҢжІүйҮ‘е·ҘиүәдҪңдёәж— й“…йҖӮеә”жҖ§зҡ„дёҖз§ҚиЎЁйқўеӨ„зҗҶе·Із»ҸжҲҗдёәж— й“…иЎЁйқўеӨ„зҗҶзҡ„дё»жөҒе·ҘиүәгҖӮж— й“…з„ҠжҺҘеі°еҖјжё©еәҰзҡ„жҸҗй«ҳпјҢеёҰжқҘдәҶжӣҙеӨҚжқӮзҡ„з„ҠзӣҳдёҚж¶Ұж№ҝй—®йўҳпјҢз»ҷдјҒдёҡжӯЈеёёз”ҹдә§йҖ жҲҗеҫҲеӨ§еӣ°жү°гҖӮйҮҚзӮ№й’ҲеҜ№жІүйҮ‘PCBж— й“…з„ҠжҺҘз„ҠзӣҳдёҚж¶Ұж№ҝзҡ„й—®йўҳиҝӣиЎҢдәҶж·ұе…Ҙз ”з©¶пјҢж•ҙзҗҶдәҶдёҖеҘ—е®Ңж•ҙзҡ„з„ҠзӣҳдёҚж¶Ұж№ҝй—®йўҳзҡ„еҲҶжһҗж–№жі•гҖӮдёәдјҒдёҡи§ЈеҶіжІүйҮ‘PCBз„ҠзӣҳдёҚж¶Ұж№ҝй—®йўҳжҸҗдҫӣдәҶжңүеҠӣзҡ„еҲҶжһҗж–№жі•е’ҢжүӢж®өгҖӮ
йҡҸзқҖж— й“…еҢ–дә§дёҡзҡ„жҺЁиҝӣпјҢжІүйҮ‘е·ҘиүәдҪңдёәж— й“…йҖӮеә”жҖ§зҡ„дёҖз§ҚиЎЁйқўеӨ„зҗҶе·Із»ҸжҲҗдёәж— й“…иЎЁйқўеӨ„зҗҶзҡ„дё»жөҒе·ҘиүәгҖӮ
жІүйҮ‘д№ҹеҸ«ж— з”өй•ҚйҮ‘гҖҒжІүй•ҚжөёйҮ‘жҲ–еҢ–йҮ‘пјҢжҳҜдёҖз§ҚеңЁеҚ°еҲ¶зәҝи·Ҝжқҝ(PCB)иЈёй“ңиЎЁйқўж¶ӮиҰҶеҸҜз„ҠжҖ§ж¶ӮеұӮзҡ„е·ҘиүәпјҢе…¶йӣҶз„ҠжҺҘгҖҒжҺҘи§ҰеҜјйҖҡгҖҒжү“зәҝе’Ңж•ЈзғӯзӯүеҠҹиғҪдәҺдёҖиә«пјҢж»Ўи¶ідәҶж—ҘзӣҠеӨҚжқӮзҡ„PCBз»„иЈ…з„ҠжҺҘиҰҒжұӮпјҢеҸ—еҲ°PCBA(printedcircuitboardassemblyпјҢеҚіPCBз»„иЈ…)е®ўжҲ·зҡ„е№ҝжіӣдәІзқҗгҖӮдҪҶйҡҸзқҖж— й“…з„ҠжҺҘеі°еҖјжё©еәҰзҡ„жҸҗй«ҳпјҢдҪҝз„ҠжҺҘе·ҘиүәзӘ—еҸЈз”ұ50в„ғеҮҸе°ҸеҲ°15в„ғгҖӮз„Ҡж–ҷгҖҒPCBиЎЁйқўеӨ„зҗҶе’Ңе…ғеҷЁд»¶иЎЁйқўеӨ„зҗҶзҡ„еӨҡе…ғеҢ–пјҢеҮәзҺ°дәҶеҫҲеӨҡе…је®№жҖ§й—®йўҳпјҢе°Өе…¶жҳҜеёҰжқҘдәҶжӣҙеӨҚжқӮзҡ„жІүйҮ‘PCBз„ҠзӣҳдёҚж¶Ұж№ҝй—®йўҳгҖӮ
еҰӮеӣҫ1жүҖзӨәпјҢеӨұж•Ҳж ·е“ҒдёҠзҡ„з„Ҡзӣҳжҷ®йҒҚдёҠй”ЎдёҚиүҜпјҢдё»иҰҒиЎЁзҺ°дёәз„ҠзӣҳйғЁеҲҶеҢәеҹҹжңӘдёҠй”ЎпјҢиЎЁйқўйҮ‘еұӮжңӘе®Ңе…Ёжә¶иҝӣз„Ҡж–ҷдёӯгҖӮиҖҢеңЁжӯЈеёёзҡ„з„ҠжҺҘиҝҮзЁӢдёӯпјҢй•ҚйҮ‘з„ҠзӣҳеңЁй«ҳжё©з„ҠжҺҘзҡ„зһ¬й—ҙпјҢиЎЁйқўйҮ‘еұӮе°ҶжҖҘйҖҹжә¶дәҺз„Ҡж–ҷдёӯпјҢеҪўжҲҗAuSnXзі»еҲ—еҗҲйҮ‘иҖҢеҝ«йҖҹи„ұзҰ»з„ҠзӣҳпјҢиҝ…йҖҹжү©ж•ЈеҲ°з„Ҡж–ҷд№ӢдёӯгҖӮ
жң¬ж–Үе°ҶйҮҚзӮ№жҺўи®ЁдёҖеҘ—е®Ңж•ҙзҡ„з„ҠзӣҳдёҚж¶Ұж№ҝзҡ„еҲҶжһҗж–№жі•пјҢдёәеҲҶжһҗи§ЈеҶіжІүйҮ‘PCBз„ҠзӣҳдёҚж¶Ұж№ҝй—®йўҳжҸҗдҫӣжңүеҠӣзҡ„еҲҶжһҗж–№жі•е’ҢжүӢж®өгҖӮ
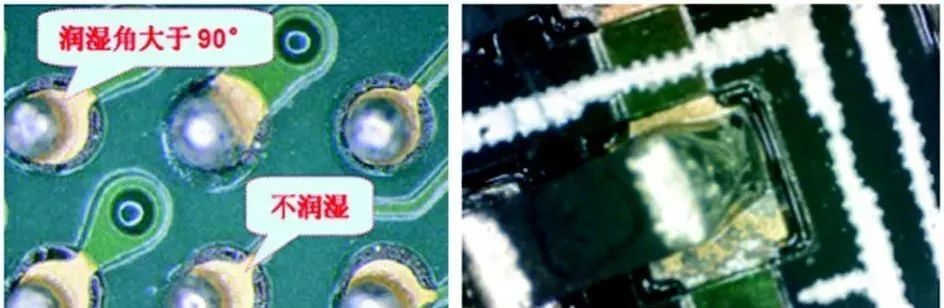
еӣҫ1ж¶Ұж№ҝдёҚиүҜз„Ҡзӣҳ
з„ҠжҺҘзғӯйҮҸ
еҪ“еҮәзҺ°з„ҠзӣҳдёҚж¶Ұж№ҝзҡ„жғ…еҶөпјҢйҰ–е…Ҳеә”иҜҘиҝӣиЎҢз„ҠжҺҘе·ҘиүәиҝҮзЁӢзҡ„еӣ зҙ жҺ’жҹҘгҖӮеҪ“з„ҠжҺҘзғӯйҮҸдёҚи¶іжҲ–й”ЎиҶҸж¶Ұж№ҝжҖ§е·®ж—¶пјҢд№ҹдјҡеҜјиҮҙз„ҠзӣҳдёҚж¶Ұж№ҝгҖӮжүҖд»ҘйҰ–е…ҲйңҖиҰҒеҜ№NGпјҲNoGoodпјүе“ҒдёҠзҡ„дёҠй”ЎдёҚиүҜз„ҠзӮ№д»ҘеҸҠдёҠй”ЎиүҜеҘҪз„ҠзӮ№иҝӣиЎҢз”өеӯҗжү«жҸҸжҳҫеҫ®й•ңпјҲSEMпјүеҲҮзүҮеҲҶжһҗпјҢеҲҶжһҗе…¶й”ЎиҶҸеҜ№е…ғеҷЁд»¶зҡ„еҸҜз„Ҡз«Ҝ/еј•и„ҡж¶Ұж№ҝжғ…еҶөд»ҘеҸҠе…¶з•Ңйқўзҡ„IMCпјҲйҮ‘еұһй—ҙеҢ–еҗҲзү©пјҢIntermetallicCompoundпјүеұӮеҺҡеәҰпјҢд»ҘзЎ®е®ҡз„ҠжҺҘе·ҘиүәжҳҜеҗҰжӯЈеёёгҖӮ
NGе“ҒдёҠзҡ„дёҚиүҜз„ҠзӮ№еҲҶжһҗВ В В
е°ҶNGе“ҒдёҠзҡ„дёҚиүҜз„ҠзӮ№еҲ¶жҲҗеҲҮзүҮпјҢ并еҜ№е…¶жҲӘйқўиҝӣиЎҢSEMи§ӮеҜҹпјҢеҰӮеҸ‘зҺ°еӣҫ2жүҖзӨәзҠ¶еҶөпјҢеҚіеҸ‘зҺ°з„Ҡж–ҷзј©иҒҡеңЁз”өйҳ»еҸҜз„Ҡз«ҜпјҢиҜҘз•Ңйқўж¶Ұж№ҝиүҜеҘҪпјҢз•ҢйқўйҮ‘еұһй—ҙеҢ–еҗҲзү©еҺҡеәҰзәҰдёә1.3ОјmгҖӮиҖҢз„Ҡж–ҷеҜ№з„ҠзӣҳеҲҷдёҚж¶Ұж№ҝпјҢдёҚж¶Ұж№ҝеҢәеҹҹеҸҜи§ҒжҳҺжҳҫйҮ‘еұӮиҰҶзӣ–PCBз„Ҡзӣҳе·ІдёҠй”ЎеҢәеҹҹпјҢз„Ҡж–ҷеҜ№PCBз„ҠзӣҳеқҮе·Іж¶Ұж№ҝгҖӮиҜҙжҳҺз„ҠжҺҘзғӯйҮҸе’Ңй”ЎиҶҸж¶Ұж№ҝжҖ§жІЎжңүй—®йўҳгҖӮ
еҸҚд№ӢпјҢеҰӮжһңеҸ‘зҺ°еҷЁд»¶дҫ§еҗҢж ·жІЎжңүеҪўжҲҗиүҜеҘҪзҡ„IMCеұӮпјҢеҲҷиҜҙжҳҺз„ҠжҺҘзғӯйҮҸдёҚи¶іжҲ–й”ЎиҶҸж¶Ұж№ҝжҖ§е·®гҖӮ

еӣҫ2дёҚиүҜз„ҠзӮ№жҲӘйқўд»ЈиЎЁжҖ§SEM&EDSз»“жһң
NGе“ҒдёҠзҡ„дёҠй”ЎиүҜеҘҪз„ҠзӮ№еҲҶжһҗВ
е°ҶеҗҢдёҖдёӘNGе“ҒдёҠзҡ„дёҠй”ЎиүҜеҘҪз„ҠзӮ№еҲ¶жҲҗеҲҮзүҮпјҢ并еҜ№е…¶жҲӘйқўиҝӣиЎҢSEMи§ӮеҜҹпјҢеҰӮеҸ‘зҺ°еӣҫ3жүҖзӨәжғ…еҶөпјҡз„Ҡж–ҷеҜ№е…ғеҷЁд»¶ж¶Ұж№ҝиүҜеҘҪпјҢе…¶з•ҢйқўеӨ„зҡ„IMCеұӮеҺҡеәҰзәҰдёә1.2ОјmпјҢPCBз„Ҡзӣҳдҫ§д№ҹиў«ж¶Ұж№ҝгҖӮиҜҙжҳҺз„ҠжҺҘзғӯйҮҸе’Ңй”ЎиҶҸж¶Ұж№ҝжҖ§жІЎжңүй—®йўҳгҖӮ
йҮ‘й•Қй•ҖеұӮеҺҡеәҰ
дёҖиҲ¬йҮ‘й•Қй•ҖеұӮз„ҠзӣҳиЎЁйқўиҰҒжұӮйҮ‘еҺҡ0.050пҪһ0.152ОјmпјҢй•ҚеҺҡ3пҪһ8ОјmгҖӮеҰӮиЎЁ1жүҖзӨәпјҢжңүз ”з©¶з»“жһңиЎЁжҳҺйҮ‘еҺҡеҜ№з„Ҡ锡延еұ•жҖ§жңүжҳҫи‘—еҪұе“ҚпјҢеҚійҮ‘еұӮи¶Ҡи–„пјҢз„Ҡ锡延еұ•жҖ§и¶Ҡе·®пјҢйҮ‘еұӮи¶ҠеҺҡпјҢз„Ҡ锡延еұ•жҖ§и¶ҠеҘҪгҖӮ
йҮ‘й•ҚеҺҡеҪұе“Қз„ҠжҺҘж•Ҳжһңзҡ„жңәзҗҶжҳҜпјҡйҮ‘дёҺ银з„Ҡй”ЎжҖ§йғҪеҫҲеҘҪжҳҜеӣ дёәе®ғ们еңЁејәзғӯдёӯиғҪеҝ«йҖҹеҪўжҲҗIMC(AuSn4дёҺAg3Sn)пјҢдё”IMCиҝҳиғҪиҝ…йҖҹеҲҶж•Јжә¶е…Ҙж¶ІжҖҒзҡ„з„Ҡж–ҷдёӯгҖӮйҮ‘жә¶иҝӣй«ҳй”ЎйҮҸSAC305з„Ҡж–ҷзҡ„йҖҹзҺҮеҸҜиҫҫ2.995Ојm/sпјҢ银д№ҹиғҪеҝ«еҲ°1.107Ојm/sпјҢиҝңи¶…иҝҮй“ң(0.104Ојm/s)е’Ңй•ҚпјҲ0.001Ојm/sпјүиҝҷ2з§Қеҹәеә•йҮ‘еұһеҪўжҲҗIMCзҡ„йҖҹзҺҮгҖӮж•…жІүйҮ‘жқҝдёҚдёҠй”Ўж—¶пјҢжҺ’йҷӨжҺүз„ҠжҺҘе·Ҙиүәеӣ зҙ еҗҺ第дёҖж—¶й—ҙеә”иҜҘз”ЁйҮ‘еҺҡжөӢиҜ•д»ӘиҝӣиЎҢйҮ‘й•ҚеҺҡзҡ„жөӢиҜ•гҖӮ
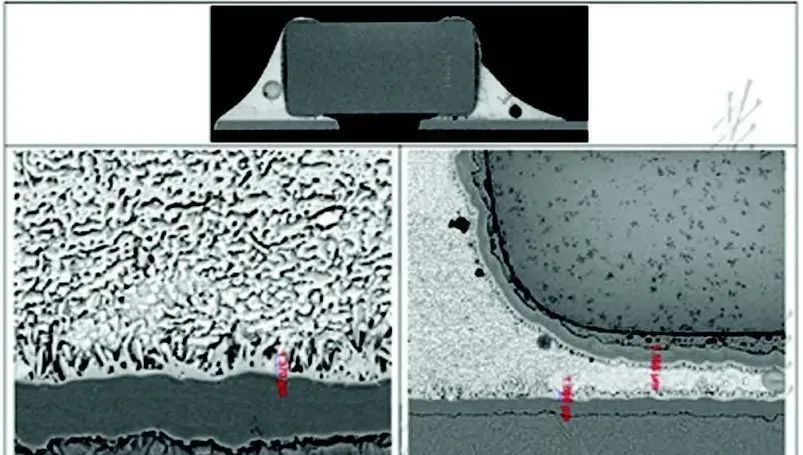
еӣҫ3иүҜеҘҪз„ҠзӮ№жҲӘйқўд»ЈиЎЁжҖ§SEMеӣҫзүҮ

иЎЁ1еҜ№жҜ”иҜ•йӘҢз»“жһң
й•ҚеұӮзЈ·еҗ«йҮҸ
ж №жҚ®SEMжү«жҸҸеҫ®и§ӮеӣҫпјҢдҪҺPеҗ«йҮҸзҡ„й•ҚеұӮжҷ¶ж јз•ҢйҷҗжҳҺжҳҫпјҢиҖҢй«ҳPеұӮзҡ„й•ҚеұӮиЎЁйқўжҷ¶ж јжЁЎзіҠпјҢе‘ҲзҺ°йқһжҷ¶дҪ“з»“жһ„гҖӮй«ҳPеҗ«йҮҸзҡ„Ni-Pй•ҖеұӮпјҢе…¶дјҳиүҜиҖҗиҡҖжҖ§иғҪиө·еӣ дәҺе®ғзҡ„йқһжҷ¶жҖҒз»“жһ„пјҢиҝҷз§ҚеңЁйқһжҷ¶жҖҒз»“жһ„дёӯдёҚеӯҳеңЁжҷ¶з•ҢгҖҒдҪҚй”ҷгҖҒеӯӘжҷ¶жҲ–е…¶д»–зјәйҷ·пјҢиҖҗиҡҖжҖ§иғҪзӣёеҜ№иҫғеҘҪгҖӮВ В В
дҪҶжҳҜй«ҳPеҗ«йҮҸзҡ„й•ҚеұӮпјҢеӣ дёәжңүж•Ҳз„ҠжҺҘйҮ‘еұһзҡ„еҮҸе°‘пјҢиҖҢз„ҠжҺҘиҝҮзЁӢдёӯпјҢPжҳҜдёҚеҸӮдёҺеҲ°з„ҠжҺҘеҗҲйҮ‘еұӮз»“жһ„дёӯзҡ„пјҢжүҖд»ҘеҪ“Pеҗ«йҮҸи¶…и¶ҠдёҖе®ҡзЁӢеәҰж—¶еҖҷпјҢй•ҚеұӮиЎЁйқўе°Ҷе‘ҲзҺ°йқһжҷ¶дҪ“з»“жһ„пјҢжһҒеӨ§еўһеҠ дәҶй•ҚеұӮзҡ„иҖҗи…җиҡҖжҖ§пјҢдҪҶеҗҢж—¶е…¶ж¶Ұж№ҝжҖ§иғҪгҖҒеҸҜйқ жҖ§иғҪе°ҶдёӢйҷҚгҖӮеңЁзЎ®е®ҡйҮ‘й•ҚеҺҡеәҰж— ејӮеёёж—¶пјҢе°ұиҰҒиҝӣдёҖжӯҘз”ЁEDXеҲҶжһҗй•ҚеұӮзЈ·еҗ«йҮҸпјҢй•ҚеұӮзЈ·еҗ«йҮҸиҙЁйҮҸеҲҶж•°дёҖиҲ¬еңЁ7%пҪһ11%гҖӮ
й•Қи…җиҡҖ
еңЁй•Қи…җиҡҖдёҘйҮҚж—¶пјҢеҫҖеҫҖдјҡйҖ жҲҗз„ҠзӣҳдёҚж¶Ұж№ҝпјҢеҚіNiеұӮеҸ—еҲ°ж·ұеәҰи…җиҡҖиҖҢеј•иө·ENIGеӨ„зҗҶз„ҠзӮ№ж–ӯиЈӮзҡ„еӨұж•ҲжЁЎејҸгҖӮдёҖиҲ¬дёҡз•ҢжҜ”иҫғи®ӨеҸҜзҡ„й•Қи…җиҡҖеҲӨе®ҡж ҮеҮҶдёәпјҡ
1пјүеңЁж”ҫеӨ§3000еҖҚзҡ„жқЎд»¶дёӢйҮҮз”ЁSEMи§ӮеҜҹпјҢз„ҠзӣҳиЎЁйқў50ОјmиҢғеӣҙеҶ…Niи…җиҡҖж·ұеәҰи¶…иҝҮNiеұӮеҺҡеәҰ40%зҡ„жқЎж•°дёҚи¶…иҝҮ4жқЎпјӣ
2пјүIMCй•ҖеұӮдёҚе…Ғи®ёеҮәзҺ°иҝһз»ӯзҡ„Niи…җиҡҖпјҢеҰӮеӣҫ4жүҖзӨәгҖӮеңЁеҮәзҺ°жІүйҮ‘з„ҠзӣҳдёҚж¶Ұж№ҝзҡ„жғ…еҶөдёӢпјҢиҰҒз”ЁSEMи§ӮеҜҹй•ҚеұӮзәөеҲҮзүҮпјҢзЎ®и®Өй•Қи…җиҡҖжғ…еҶөгҖӮ
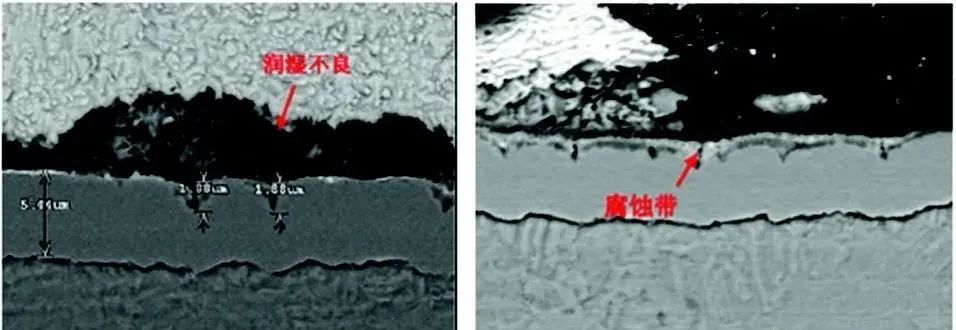
еӣҫ4й•Қи…җиҡҖеҲҮзүҮ
з„ҠзӣҳиЎЁйқўжұЎжҹ“
ејӮеёёе…ғзҙ еҲҶжһҗВ
еҜ№дёҠй”ЎдёҚиүҜзҡ„з„ҠзӮ№иҝӣиЎҢEDXпјҲEnergy Dispersive X-Ray SpectroscopyпјүжҲҗеҲҶеҲҶжһҗпјҢзЎ®и®ӨжҳҜеҗҰжңүејӮеёёе…ғзҙ еӯҳеңЁгҖӮеңЁPCBз”ҹдә§иҝҮзЁӢдёӯпјҢж–Үеӯ—д»ҘеҸҠйҳ»з„ҠеЎһеӯ”зӯүе·ҘеәҸеҸҜиғҪдјҡеҮәзҺ°ж–Үеӯ—жҲ–иҖ…йҳ»з„ҠеүӮдёҠз„ҠзӣҳеҜјиҮҙз„ҠзӣҳдёҚж¶Ұж№ҝзҡ„жғ…еҶөгҖӮ
еҰӮеӣҫ5жүҖзӨәпјҢеҸ‘зҺ°з„ҠзӣҳиЎЁйқўжңүејӮеёёе…ғзҙ TiпјҢTiжҳҜеӯ—з¬ҰжІ№еўЁзҡ„зү№еҫҒе…ғзҙ пјҢеҸҜд»ҘеҲӨе®ҡжңүеӯ—з¬ҰжұЎжҹ“зү©еӯҳеңЁгҖӮй’ҲеҜ№еӯ—з¬ҰжұЎжҹ“з„Ҡзӣҳзҡ„дёҚиүҜпјҢеҸҜйҮҮз”ЁжІүйҮ‘еүҚеҚ°еӯ—з¬Ұе·ҘиүәпјҢиҝҷж ·еҸҜд»Ҙжңүж•ҲйҒҝе…Қеӯ—з¬ҰжұЎжҹ“з„ҠзӣҳеҜјиҮҙзҡ„з„ҠжҺҘдёҚиүҜпјҢзӣ®еүҚдёҡз•ҢжңүеӨҡдёӘPCBеҺӮ家йҮҮз”ЁжІүйҮ‘еүҚеҚ°еӯ—з¬Ұе·ҘиүәгҖӮ
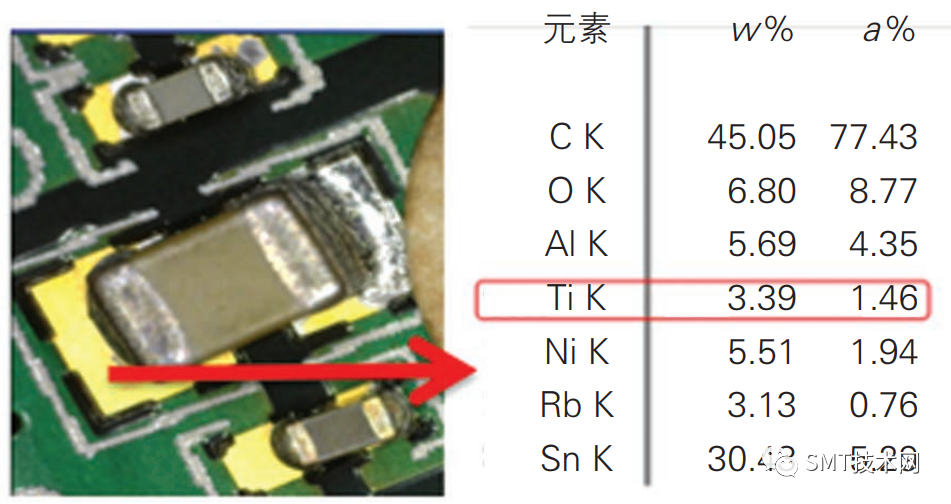
еӣҫ5дёҚдёҠй”Ўз„ҠзӣҳEDXжҲҗеҲҶ
жңүжңәзү©жұЎжҹ“еҲҶжһҗВ В В
еҪ“иҝӣиЎҢEDXе…ғзҙ еҲҶжһҗж—¶пјҢжңӘеҸ‘зҺ°жҳҺжҳҫејӮеёёе…ғзҙ еӯҳеңЁж—¶пјҢе°ұиҰҒи§ӮеҜҹж°§еҗ«йҮҸжҳҜеҗҰжӯЈеёёгҖӮеҰӮеӣҫ6жүҖзӨәпјҢиҝҷдёӘдёҚдёҠй”Ўз„ҠзӣҳиЎЁйқўAuеұӮж°§е…ғзҙ еҗ«йҮҸиҫғй«ҳпјҢиҜҙжҳҺз„ҠзӣҳеӯҳеңЁдёҖе®ҡзЁӢеәҰзҡ„ж°§еҢ–жҲ–иҖ…еӯҳеңЁжңүжңәзү©жұЎжҹ“зҡ„жғ…еҶөгҖӮВ В В
иҝӣиҖҢдҫқжҚ®IPC-J-STD-003Bж–№жі•пјҢз”ЁдҪ“з§ҜеҲҶж•°20%зҡ„HClжё…жҙ—дёҚж¶Ұж№ҝзҡ„з„ҠзӣҳпјҢжё…жҙ—еҗҺеҰӮжһңеҸҜз„ҠжҖ§жҳҺжҳҫж”№е–„пјҢе°ұеҸҜд»ҘиҝӣдёҖжӯҘзЎ®и®Өз„ҠзӣҳеӯҳеңЁдёҖе®ҡзЁӢеәҰзҡ„ж°§еҢ–жҲ–иҖ…еӯҳеңЁжңүжңәзү©жұЎжҹ“зҡ„жғ…еҶөгҖӮВ В В
ж— и®әжҳҜз„ҠзӣҳиЎЁйқўжңүејӮеёёе…ғзҙ еӯҳеңЁпјҢиҝҳжҳҜз„ҠзӣҳиЎЁйқўжңүж°§еҢ–жҲ–иҖ…жңүжңәзү©жұЎжҹ“зү©еӯҳеңЁгҖӮз»ҸиҝҮ笔иҖ…еӨ§йҮҸе®һи·өпјҢеңЁPCBеҢ…иЈ…еүҚз”ЁдҪ“з§ҜеҲҶж•°1%пҪһ3%зҡ„зЁҖзЎ«й…ё+и¶…еЈ°жіўж°ҙжҙ—зҡ„ж–№ејҸиҝӣиЎҢPCBжё…жҙ—пјҢеҸҜд»ҘеҫҲеҘҪең°и§„йҒҝз„ҠжҺҘдёҚиүҜй—®йўҳгҖӮејӮдёҷйҶҮгҖҒжҹ жӘ¬й…ёд»ҘеҸҠзӣҗй…ёзҡ„жё…жҙ—ж–№ејҸдҪңз”ЁжңүйҷҗпјҢдёҚжҺЁиҚҗдҪҝз”ЁгҖӮе°Өе…¶жҳҜзӣҗй…ёиҰҒзҰҒжӯўеҜ№йҮ‘йқўиҝӣиЎҢжё…жҙ—пјҢеӣ дёәзӣҗй…ёдјҡеёҰжқҘдёҘйҮҚзҡ„й•Қи…җиҡҖй—®йўҳгҖӮ

еӣҫ6дёҚдёҠй”Ўз„ҠзӣҳEDXжҲҗеҲҶ
йҮ‘еұӮж°§еҢ–
еҪ“д»ҘдёҠжүҖжңүзҡ„еҲҶжһҗз»“жһңйғҪжІЎжңүејӮеёёж—¶пјҢиҝҷдёӘж—¶еҖҷе°ұиҰҒз”ЁSEMйҮҚзӮ№и§ӮеҜҹзЎ®и®ӨжІүйҮ‘иЎЁйқўеҗҺжҳҜеҗҰеҜ№йҮ‘йқўиҝӣиЎҢдәҶзү©зҗҶеӨ„зҗҶпјҢжҜ”еҰӮе–·з ӮгҖӮдёҖиҲ¬еңЁйҮ‘йқўжңүејӮеёёпјҢдҫӢеҰӮйҮ‘йқўжұЎжҹ“гҖҒйҮ‘йқўеҸ‘зәўе’ҢйҮ‘йқўж°§еҢ–зӯүжӯЈеёёй…ёжҙ—жөҒзЁӢж— жі•еӨ„зҗҶж—¶пјҢжңүдәӣPCBеҺӮ家дјҡйҮҮз”Ёе–·з Ӯзӯүзү©зҗҶж–№ејҸеҜ№йҮ‘йқўиҝӣиЎҢеӨ„зҗҶгҖӮ
еҰӮ7жүҖзӨәпјҢеңЁжІүйҮ‘еҗҺеҒҡиҝҮе–·з ӮеӨ„зҗҶпјҢж•ҙдёӘйҮ‘йқўзҡ„жҷ¶дҪ“з»“жһ„е·Із»Ҹе®Ңе…Ёз ҙеқҸпјҢжңүжјҸй•ҚзҺ°иұЎпјҢиҝҷдәӣдҪҚзҪ®дјҡйҖ жҲҗйҮ‘еҺҹеӯҗд№Ӣй—ҙзҡ„й•ҚеҺҹеӯҗеӨ§йҮҸж°§еҢ–пјҢжңҖз»ҲйҖ жҲҗз„ҠзӣҳдёҚж¶Ұж№ҝгҖӮ

еӣҫ7дёҚдёҠй”Ўз„ҠзӣҳSEMеҲҶжһҗ
з»“жқҹиҜӯ
1пјүжІүйҮ‘PCBз„ҠзӣҳдёҚж¶Ұж№ҝеә”д»Һд»ҘдёӢе…ӯдёӘж–№йқўиҝӣиЎҢйҮҚзӮ№еӨұж•ҲеҲҶжһҗпјҡ
пјҲ1пјүз„ҠжҺҘзғӯйҮҸдёҚи¶іпјӣ
пјҲ2пјүй•ҚеұӮзЈ·еҗ«йҮҸејӮеёёпјӣ
пјҲ3пјүй•Қи…җиҡҖпјӣ
пјҲ4пјүйҮ‘й•ҚеҺҡеәҰејӮеёёпјӣ
пјҲ5пјүз„ҠзӣҳиЎЁйқўжұЎжҹ“пјӣ
пјҲ6пјүйҮ‘еұӮж°§еҢ–гҖӮ
2пјүжІүйҮ‘еҗҺдҪҝз”Ёзү©зҗҶж–№ејҸеҜ№йҮ‘йқўиҝӣиЎҢиҝ”е·ҘпјҢдјҡйҖ жҲҗйҮ‘жҷ¶ж јеҸҳеҪўпјҢйңІй•ҚдҪҚзҪ®й•Қж°§еҢ–пјҢиҝӣиҖҢйҖ жҲҗз„ҠзӣҳдёҚж¶Ұж№ҝгҖӮ
3пјүеңЁPCBеҢ…иЈ…еүҚз”ЁдҪ“з§ҜеҲҶж•°1%пҪһ3%зҡ„зЁҖзЎ«й…ё+и¶…еЈ°жіўж°ҙжҙ—зҡ„ж–№ејҸиҝӣиЎҢPCBжё…жҙ—пјҢеҸҜд»ҘеҫҲеҘҪең°и§„йҒҝз„ҠжҺҘдёҚиүҜй—®йўҳгҖӮ
4пјүйҮҮз”ЁжІүйҮ‘еүҚеҚ°еӯ—з¬ҰеҸҜд»Ҙжңүж•ҲйҒҝе…Қеӯ—з¬ҰжұЎжҹ“з„ҠзӣҳеҜјиҮҙзҡ„з„ҠжҺҘдёҚиүҜпјҢзӣ®еүҚдёҡз•ҢжңүеӨҡдёӘPCBеҺӮ家еңЁйҮҮз”ЁгҖӮ
В
В
-
PCBз„Ҡзӣҳи„ұиҗҪзҡ„еҺҹеӣ еҸҠи§ЈеҶіж–№жі•пјҹ2024-01-18 11281
-
pcbжІүйҮ‘е’Ңе–·й”ЎеҢәеҲ«2023-11-22 8140
-
жІүй•ҚйҮ‘еҸҜз„ҠжҖ§дёҚиүҜеҲҶжһҗеҸҠж”№е–„жҠҘе‘Ҡ2021-10-20 2504
-
PCBжқҝи®ҫи®Ўе…ідәҺжІүйҮ‘дёҺй•ҖйҮ‘зҡ„еҢәеҲ«2018-09-06 5025
-
PCBжқҝжІүйҮ‘дёҺй•ҖйҮ‘зҡ„еҢәеҲ«2018-08-23 4372
-
PCBеӯ”зӣҳдёҺйҳ»з„Ҡи®ҫи®Ў2018-06-05 5393
-
PCBеёғзәҝгҖҒз„ҠзӣҳеҸҠж•·й“ңзҡ„и®ҫи®Ўж–№жі•иҜҰи§Ј2018-05-23 30717
-
PCBжқҝжІүйҮ‘жқҝе’Ңй•ҖйҮ‘жқҝжңүд»Җд№ҲеҢәеҲ«пјҹ2017-08-28 4407
-
иҪ¬пјҡpcbе·Ҙиүәй•ҖйҮ‘е’ҢжІүйҮ‘зҡ„еҢәеҲ«2016-08-03 6653
-
гҖҗPCBе°ҸзҹҘиҜҶ 1 гҖ‘е–·й”ЎVSй•ҖйҮ‘VSжІүйҮ‘2015-11-22 44139
-
pcbжқҝжІүйҮ‘жқҝдёҺй•ҖйҮ‘жқҝзҡ„еҢәеҲ«2012-12-17 4153
-
PCBжІүйҮ‘жқҝдёҺй•ҖйҮ‘жқҝзҡ„еҢәеҲ«еҲҶжһҗ2012-10-07 7823
-
PCBжқҝжІүйҮ‘дёҺй•ҖйҮ‘жқҝзҡ„еҢәеҲ«2011-10-11 4401
е…ЁйғЁ0жқЎиҜ„и®ә

еҝ«жқҘеҸ‘иЎЁдёҖдёӢдҪ зҡ„иҜ„и®әеҗ§ !

