

碳化硅器件制造那些事儿
制造/封装
描述
离子注入是一种向半导体材料内加入一定数量和种类的杂质,以改变其电学性能的方法,可以精确控制掺入的杂质数量和分布情况。
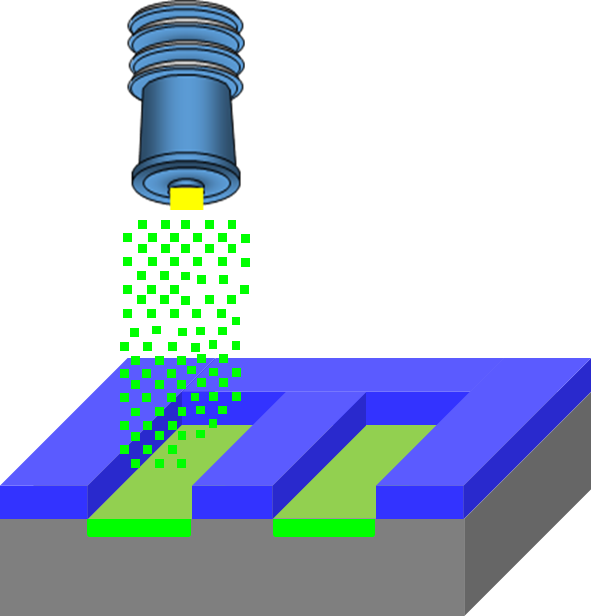
一为什么采用离子注入工艺
在功率半导体器件制造中,传统硅晶圆的P/N区掺杂可以采用扩散方式实现。但碳化硅中杂质原子的扩散常数极低,因此用扩散工艺实现选择性掺杂是不现实的,如图1所示。另一方面,离子注入的温度条件相对扩散工艺较低,同时可形成更加灵活和准确的掺杂分布。
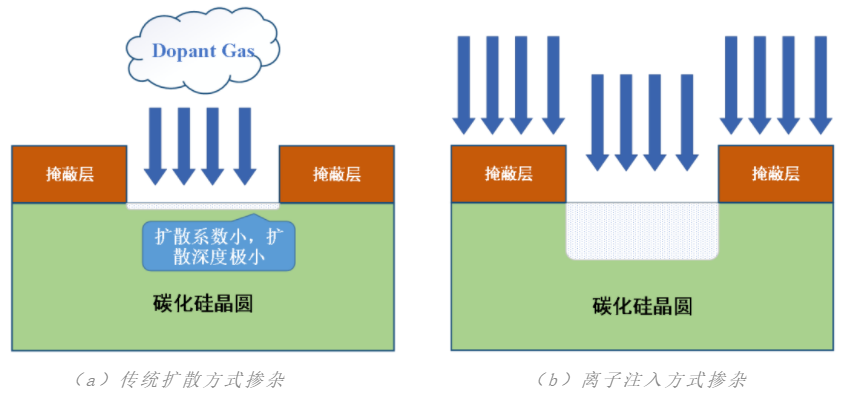
图1 碳化硅材料中,扩散和离子注入掺杂技术对比
二如何实现碳化硅离子注入
碳化硅工艺制造过程中使用的典型高能离子注入设备主要由离子源、等离子体、吸出组件、分析磁体、离子束、加速管、工艺腔和扫描盘组成,如图2所示。

图2 碳化硅高能离子注入设备示意图
(来源:《半导体制造技术》)
SiC离子注入通常在高温下进行,可以最大限度地减少离子轰击对晶格的破坏。对于4H-SiC晶圆,制作N型区域通常选用注入氮和磷离子实现,制作P型区域通常选用注入铝离子和硼离子实现。
表1. SiC器件制作选择性掺杂示例
(来源:Kimoto, Cooper, Fundamentals of Silicon Carbide Technology: Growth, Characterization, Devices, and Applications)

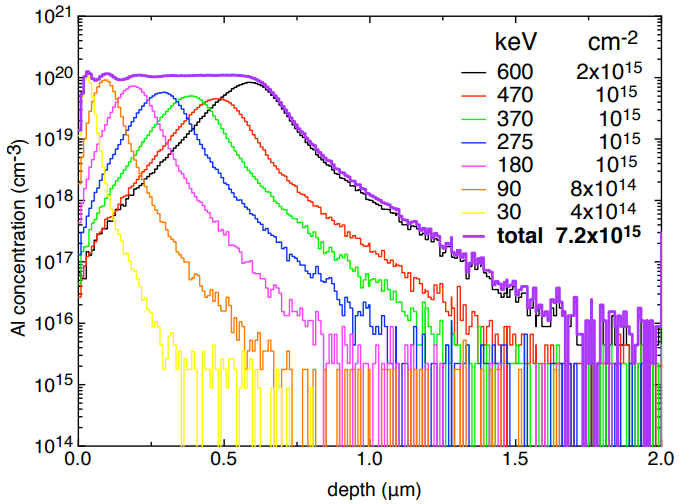
图3 多步能量离子注入与晶圆表面掺杂浓度分布对比
(来源:G.Lulli, Introduction To Ion Implantation)
为达到离子注入区域掺杂浓度均匀的目的,工程师们通常采用多步离子注入的方式调整注入区域的整体浓度分布(如图3所示);在实际工艺制造过程中,通过调节离子注入机的注入能量和注入剂量,可以控制离子注入区域的掺杂浓度和掺杂深度,如图4.(a)和(b)所示;离子注入机在工作中通过在晶圆表面多次扫描方式对晶圆表面进行均匀离子注入,如图4.(c)所示。
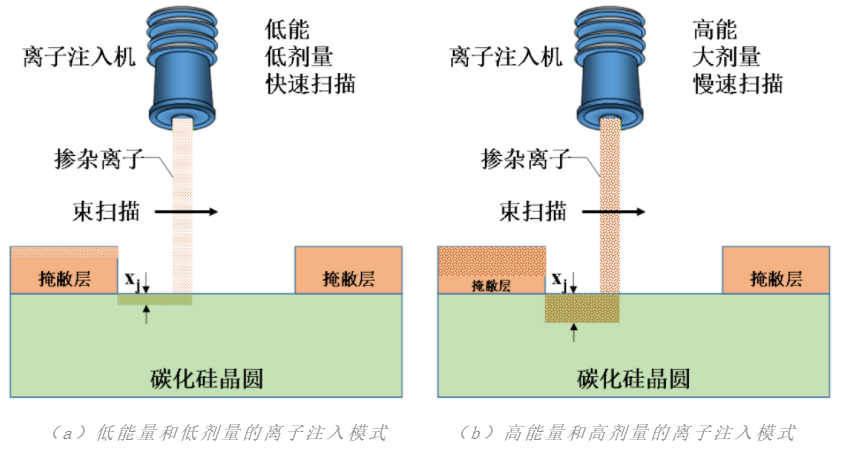
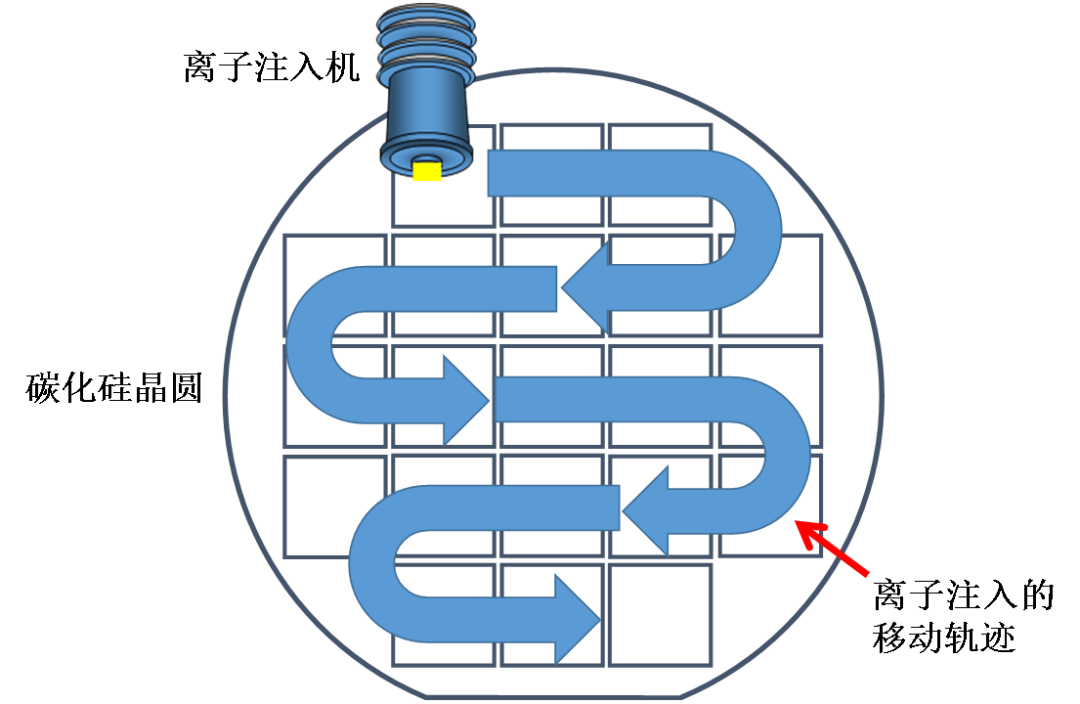
(c)离子注入过程中离子注入机的移动轨迹
图4 在离子注入过程中,通过调节离子注入能量和剂量来控制杂质浓度和深度
三碳化硅离子注入激活退火工艺
离子注入的浓度、分布区域、激活率、体内和表面的缺陷等是离子注入工艺的主要参数,影响这些参数结果的因素很多,有注入剂量、能量、材料的晶向、注入温度、退火温度、退火时间、环境等。与硅离子注入掺杂不同,碳化硅离子注入掺杂后,其杂质依旧很难完全电离,以4H-SiC中性区域内铝受主电离率为例,在1×1017cm-3掺杂浓度下,室温下只有约15%的受主电离率(通常硅的电离率近似为100%)。为达到高激活率和较少缺陷的目标,离子注入后会采用高温退火工序使注入时产生的无定形缺陷再结晶,使注入原子进入替代位并激活,如图5所示。目前,人们对退火过程机理的认识还有限,对退火过程的控制和深入了解是未来离子注入的研究重点之一。
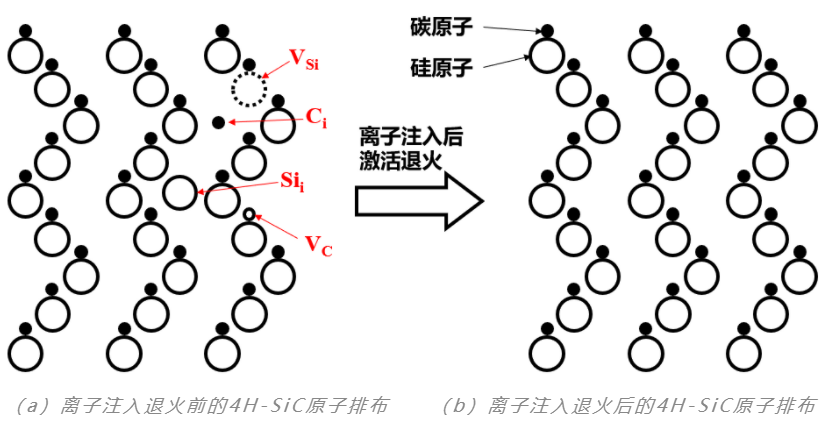
图5 离子注入退火前后,碳化硅离子注入区域表面的原子排布变化示意图,其中Vsi代表硅空位,VC代表碳空位,Ci代表碳填充原子,Sii代表硅填充原子
离子激活退火一般有炉管退火、快速退火和激光退火等。由于SiC材料中Si原子的升华,一般退火温度不超过1800℃;退火氛围一般在惰性气体或真空中进行。不同的离子在SiC中造成不同的缺陷中心,需要不同的退火温度。从大多数的实验结果上看,可以得出退火温度越高、激活率越高的结论(如图6所示)。

图6 退火温度对SiC中氮或磷注入(室温条件下)的电激活率的影响
(总注入剂量1×1014cm-2)
(来源:Kimoto, Cooper, Fundamentals of Silicon Carbide Technology: Growth, Characterization, Devices, and Applications)
目前常用碳化硅离子注入后激活退火工艺在1600℃~1700℃温度下的Ar氛围中进行,使SiC表面再结晶并激活掺杂剂,提高掺杂区域的导电特性;退火前可在晶圆表面涂敷一层碳膜进行表面保护,减小Si脱附和表面原子迁移导致的表面退化,如图7所示;退火完成后,碳膜可以通过氧化或腐蚀方式去除。
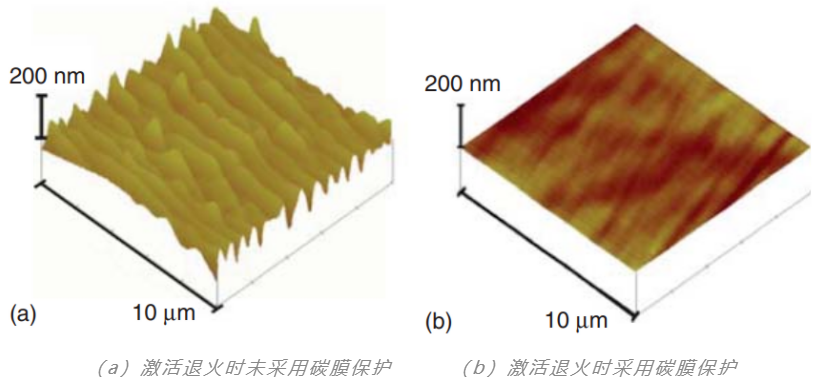
图7 1800℃退火温度条件下,4H-SiC晶圆是否采用碳膜保护的表面粗糙度对比
(来源:Kimoto, Cooper, Fundamentals of Silicon Carbide Technology: Growth, Characterization, Devices, and Applications)
四碳化硅离子注入和激活退火工艺带来的影响
离子注入和随后的激活退火依旧不可避免地会产生降低器件性能的缺陷:复杂的点状缺陷、堆垛层错(如图8所示)、新的位错、浅或深能级缺陷、基面位错环和现有位错的移动。由于高能离子轰击过程会对碳化硅晶圆产生应力作用,高温高能离子注入工艺会增大晶圆翘曲度。这些问题也成为碳化硅离子注入和退火工艺制造环节中亟需优化和研究的方向。
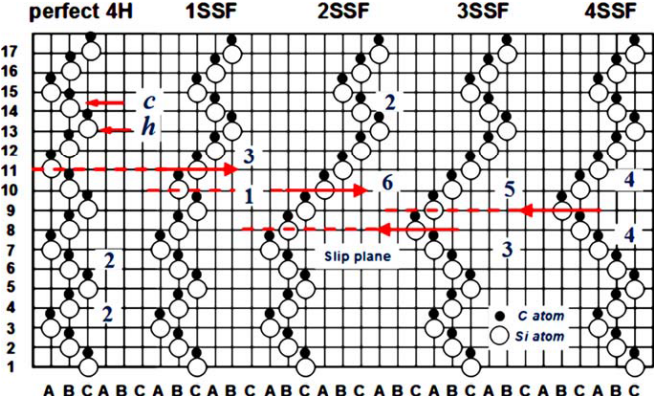
图8 正常4H-SiC晶格排列和不同堆垛层错的对比示意图
(来源:Nicolὸ Piluso 4H-SiC Defects)
五碳化硅离子注入工艺改进
(1)在离子注入区域表层保留一层薄氧化膜,减小高能离子注入对碳化硅外延表层造成注入损伤的程度,如图9.(a)所示。
(2)提高离子注入设备内靶盘质量,使晶圆与靶盘的贴合度更紧密,靶盘向晶圆的热传导性能更好,使设备对晶圆背面的加热效果更均匀,提高在碳化硅晶圆上进行高温高能离子注入的质量,如图9.(b)所示。
(3)优化高温退火设备工作过程中温度上升的速率和温度均匀性。
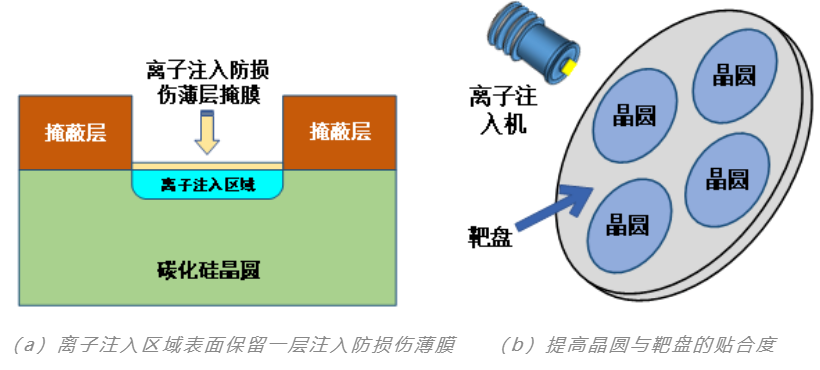
图9 改进离子注入工艺的方法
审核编辑:汤梓红
-
碳化硅压敏电阻 - 氧化锌 MOV2024-03-08 8405
-
碳化硅器件的生产流程,碳化硅有哪些优劣势?2023-10-27 7188
-
图腾柱无桥PFC中混合碳化硅分立器件的应用2023-02-28 2344
-
浅谈硅IGBT与碳化硅MOSFET驱动的区别2023-02-27 3021
-
归纳碳化硅功率器件封装的关键技术2023-02-22 2953
-
传统的硅组件、碳化硅(Sic)和氮化镓(GaN)2021-09-23 6170
-
碳化硅的应用2021-08-19 3982
-
什么是碳化硅(SiC)?它有哪些用途?2021-06-18 9406
-
碳化硅器件是如何组成逆变器的?2021-03-16 2830
-
碳化硅基板——三代半导体的领军者2021-01-12 4439
-
碳化硅半导体器件有哪些?2020-06-28 4435
-
碳化硅深层的特性2019-07-04 6097
-
碳化硅的历史与应用介绍2019-07-02 5055
-
碳化硅(SiC)肖特基二极管的特点2019-01-11 8326
全部0条评论

快来发表一下你的评论吧 !

