

国际首支1200V的硅衬底GaN基纵向功率器件
电子说
描述
氮化镓(GaN)电子器件具有更高耐压,更快的开关频率,更小导通电阻等诸多优异的特性,在功率电子器件领域有着广泛的应用前景:从低功率段的消费电子领域,到中功率段的汽车电子领域,以及高功率段的工业电子领域,目前650V级的GaN基横向功率器件(如HEMT)已经广泛应用于消费类电子产品的快充设备、大数据中心的电源管理系统,而有望应用到电动汽车上的1200 V级器件是GaN功率电子器件领域的研究热点和难点。
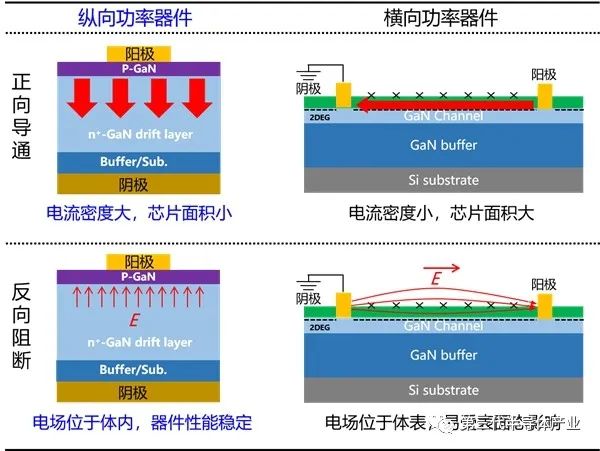
图1. GaN基纵向、横向功率器件的特点比较 相比于横向功率电子器件,GaN纵向功率器件能提供更高的功率密度/晶圆利用率、更好的动态特性、更佳的热管理,而大尺寸、低成本的硅衬底GaN纵向功率电子器件吸引了国内外众多科研团队的目光,近些年已取得了重要进展。
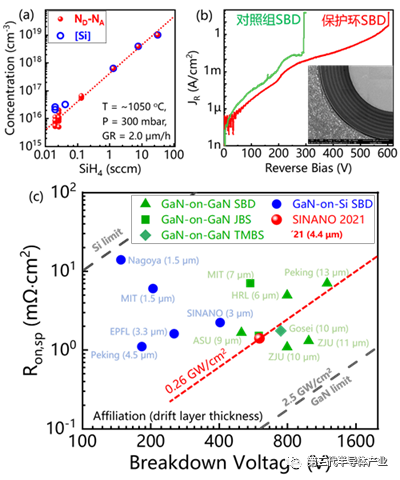
图 2.(a) 受硅烷流量影响的漂移层Si的掺杂浓度(SIMS数据)和净载流子浓度(C-V数据);(b) 离子注入保护环对器件反向电学特性的影响,插图:离子注入保护环的SEM图;(c) GaN基纵向功率二极管的关态击穿电压与开态导通电阻(Ron,sp)的评价体系。国内外相关研究团队的自支撑衬底和硅衬底GaN基肖特基势垒二极管(SBD),结势垒肖特基二极管(JBS),凹槽MOS型肖特基二极管(TMBS)器件性能的比较 中科院苏州纳米所孙钱研究团队先后在漂移区的掺杂精准调控、器件关态电子输运机制及高压击穿机制、高性能离子注入保护环的终端开发等核心技术上取得突破,曾经研制出关态耐压达603V、器件的Baliga优值(衡量器件正反向电学性能的综合指标)为0.26GW/cm2的硅衬底GaN纵向肖特基势垒二极管,相关指标为公开报道同类型器件的最佳值(IEEE Electron Device Letters, vol. 42, no. 4, pp. 473-476, Apr 2021; Applied Physics Letters, vol. 118, no. 24, 2021, Art. no. 243501; IEEE Transactions on Electron Devices, vol. 68, no. 11, pp. 5682-5686, 2021)。
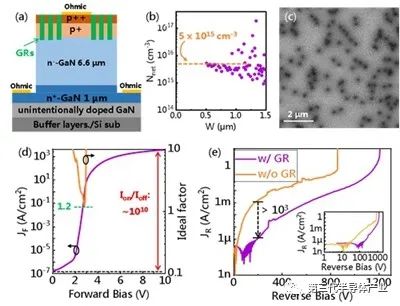
图3.(a) 硅衬底GaN纵向p-n功率二极管的示意图; (b) 随漂移区深度分布的净载流子浓度;(c) 漂移区外延材料的CL-mapping图;(d) 带保护环器件的正向电学数据;(e)保护环对器件反向电学特性的影响 在前期工作基础上,近期团队基于6.6 μm厚、穿透位错密度低至9.5 x 107 cm-3的高质量硅基GaN漂移区材料(为公开报道器件中的最低值),成功研制了1200 V的pn功率二极管。器件的理想因子低至1.2;在反向偏置电压为1000 V的条件下,器件在温度为175 oC的工作环境,仍然能正常工作,10次功率循环的测试表明器件具有较佳的可靠性,且受偏置电压和导通时间影响的动态导通电阻降低现象得到了研究,相关工作以1200-V GaN-on-Si Quasi-Vertical p-n Diodes为题发表于微电子器件领域的顶级期刊IEEE Electron Device Letters 43 (12), 2057-2060 (2022),第一作者为中科院苏州纳米所特别研究助理郭小路博士,通讯作者为孙钱研究员和特别研究助理钟耀宗博士。

图4.(a) 温度依赖的反向电学特性;(b) 受反向偏压影响的动态导通电阻及其时间分辨图;(c) 连续的功率循环测试及其(d)测试前、后器件的正向电学特性曲线
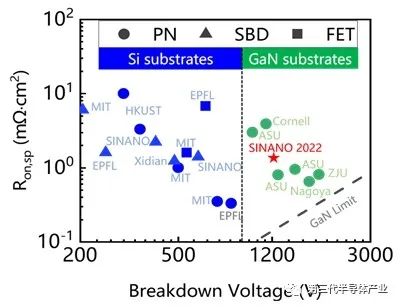
图5.GaN基纵向功率二极管的关态击穿电压与开态导通电阻(Ron,sp)的评价体系。国内外相关研究团队的自支撑衬底和硅衬底GaN基肖特基势垒二极管(SBD),p-n功率二极管(PN),场效应晶体管(FET)器件性能的比较 上述研究工作得到了国家重点研发计划项目、国家自然科学基金项目、中国科学院重点前沿科学研究计划、江苏省重点研发计划项目等资助。
审核编辑 :李倩
-
MACOM:硅基氮化镓器件成本优势2017-09-04 4732
-
不同衬底风格的GaN之间有什么区别?2019-07-31 3610
-
基于Si衬底的功率型GaN基LED制造技术,看完你就懂了2021-04-12 2159
-
GaN和SiC区别2022-08-12 10136
-
Si衬底设计的功率型GaN基LED制造技术2010-06-07 1978
-
硅衬底GaN基LED技术,Micro LED将是晶能光电的重大应用2018-08-27 8061
-
上海芯元基新型GaN复合衬底的制备技术2020-04-17 4374
-
探究Si衬底的功率型GaN基LED制造技术2021-04-21 5770
-
1200V高压硅基氮化镓功率器件动态特性实测2023-07-19 3557
-
晶能光电:硅衬底GaN材料应用大有可为2023-10-13 2210
-
面向1200V功率应用的异质衬底横向和垂直GaN器件发展趋势2023-12-26 2422
-
1200V GaN又有新玩家入场,已进入量产2024-07-31 5572
-
1200V碳化硅sic功率器件测试及建模2024-10-17 809
-
浮思特 | 在工程衬底上的GaN功率器件实现更高的电压路径2025-05-28 978
-
新品 | 针对车载充电和电动汽车应用的EasyPACK™ CoolSiC™ 1200V和硅基模块2025-07-31 1117
全部0条评论

快来发表一下你的评论吧 !

