

半导体行业:等离子工艺(十一)
描述
由于磁场将增加靠近电极表面附近的电子密度,因此增强磁场也能降低直流偏压。
剧烈的离子轰击将产生大量的热能,如果晶圆没有适当冷却,则晶圆的温度就会很高。进行图形化刻蚀前,晶圆被涂上一层薄的光刻胶作为图形化掩膜。如果晶圆的温度超过150℃,光刻胶将产生网状结构。所以进行图形化刻蚀的反应室必须有冷却系统,避免光刻胶受热而产生网状结构。由于化学刻蚀速率对晶圆的温度很敏感,所以有些整面全区刻蚀的反应室(如自旋涂敷氧化硅回蚀反应室)也需要晶圆冷却系统调节晶圆的温度并控制刻蚀速率。因为刻蚀必须在低压下进行,然而低压不利于热能转移,所以通常将加压的氮气注入晶圆的背面,将热能从晶圆转移到晶圆的冷却台上(也称夹盘、阴极等)。这时需要夹环或静电夹盘(E夹盘),以防止背面高压氨气将晶圆从冷却台上吹走。気有仅次于氢的高热传导率,因此在晶圆和晶圆冷却台之间提供了一条传导热能的路径。
电介质薄膜经常使用氧气溅射刻蚀反应室进行某些处理,例如在间隙填充前首先在间隙边缘形成倾斜的侧壁,以及薄膜表面的平坦化。由于溅射刻蚀速率对晶圆的温度不敏感,所以并不需要带有夹环或E夹盘的氮气背面冷却系统。
遥控等离子体工艺
有些工艺过程只需要自由基增强化学反应,并且避免离子轰击引发等离子体诱生损伤。遥控等离子体系统就是为了达到这个需求产生的。
下图显示了一个遥控等离子体系统。等离子体在遥控室中利用微波或射频功率产生,等离子体中产生的自由基再流入反应室用于刻蚀或沉积。
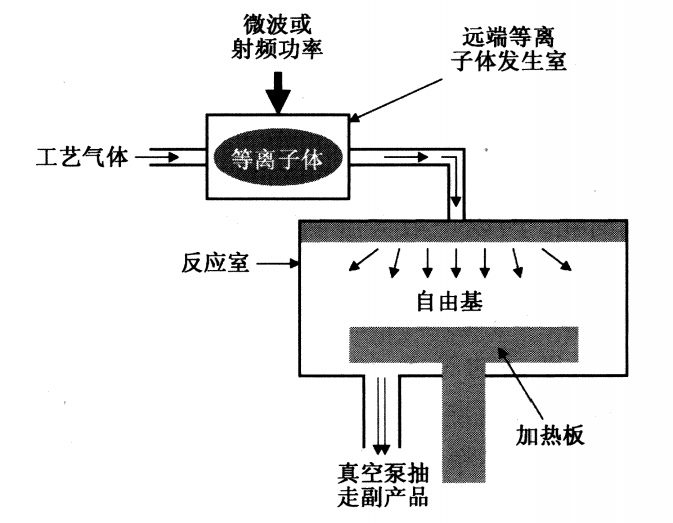
去光刻胶
遥控等离子体去光刻胶利用O2和H20在刻蚀后立即将光刻胶除去。如下图所示,遥控等离子体去光刻胶系统能轻易整合到刻蚀系统中。晶圆将停留在相同的主平台内,依序执行临场蚀刻/剥除过程。晶圆接触到大气之前必须先将光刻胶和残余的刻蚀剂剥除,否则这些残留的刻蚀剂将和空气中的湿气反应而在晶圆表面产生腐蚀,因此临场去光刻胶能够增加产量和提高产品的成品率。
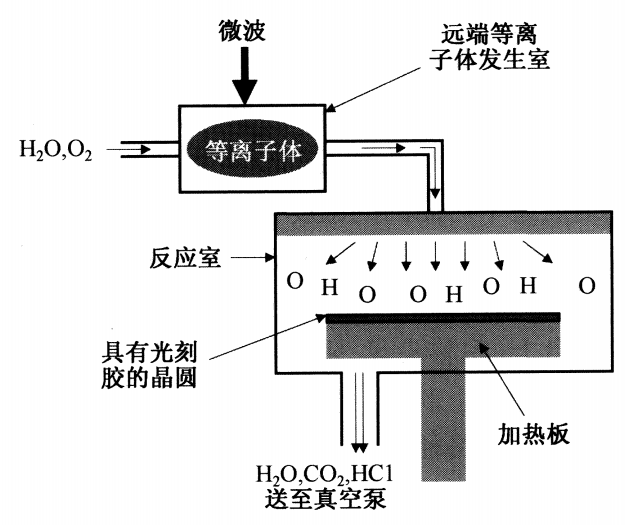
遥控等离子体刻蚀
有些刻蚀并不需要非等向性刻蚀,例如硅的局部氧化(LOCOS)和浅沟槽隔离(STI)中氮化物的剥除、酒杯状接触窗孔和其他工艺等,因此这些工艺也不会用到离子轰击。遥控等离子体刻蚀系统属于干式化学刻蚀系统,在这些应用上和湿式刻蚀相互竞争。以前的IC生产曾倾向于用干式刻蚀取代所有的湿式刻蚀,但却从来没有实现。事实上,由于先进的IC芯片生产工艺中广泛使用CMP,所以实现这一点几乎是完全不可能的。
遥控等离子体清洁
由于反应室中的等离子体总会产生自由基和离子轰击,而离子轰击将损坏室内的零件进而增加生产成本,另一个问题是用来清除净化CVD反应室的碳氟气体,如CF4,C2F6及C3F8会造成全球温室效应和臭氧消耗,所以一般会限制这些气体的使用。遥控等离子体清洁就是为了解决这些问题。
审核编辑 :李倩
-
等离子体清洗工艺的关键技术 等离子体清洗在封装生产中的应用2023-10-18 3646
-
半导体行业:等离子工艺(七)2022-12-19 10793
-
半导体制造之等离子工艺2022-11-15 5616
-
改进晶圆制造工艺,探索蚀刻终点的全光谱等离子监测解决方案2022-10-19 1202
-
等离子清洗机在包装行业的实际应用(瓶盖/瓶子/包装盒/快递袋)2022-09-19 1063
-
等离子体应用2022-05-18 3703
-
TDK|低温等离子体技术的应用2022-05-17 2988
-
《炬丰科技-半导体工艺》半导体行业的湿化学分析——总览2021-07-09 4817
-
微波射频能量:固态等离子照明2018-02-07 5068
-
PCB电路板等离子体切割机蚀孔工艺技术2017-12-18 3074
-
微波射频能量:等离子照明2017-12-14 5040
-
6英寸半导体工艺代工服务2015-01-07 3845
-
半导体工艺讲座2009-11-18 94610
-
有关半导体工艺的问题2009-09-16 5713
全部0条评论

快来发表一下你的评论吧 !

