

A-SAP和mSAP工艺都可用于电镀孔吗
描述
高密度互连(high-density interconnect,简称HDI)设计要求设计师具有一些不同的想法。首先要考虑的重点是是否需要HDI,如果需要,需要多少。
只要采购任何引脚间距为0.5mm的元器件,就会影响HDI选项。
这些元器件的数量及设计的其他技术规范将决定所需要的HDI量。
以下是HDI选项清单:
· 更小的通孔
· 更小的走线
· 更薄的介质
· 更密的阻焊层间隙
· 受控膏状掩模结构
每个选项都会带来影响制造及组装的选择,因此在做出这些选择之前需要进行一些研究。
本文将只探讨前两个选项,因为它们通常会决定贵公司想要使用哪种制造工艺。
更小的通孔有多种可选项 :
具有贯穿通孔的盲孔
这是最佳选择。它会增加一点成本,但同时能够将元器件放在PCB的两侧,而不必受具有不同网相对焊盘的限制。
具有贯穿通孔的盲孔和埋孔
此选项提供了最大的布线控制;然而,它也会增加成本。
仅有贯穿通孔
虽然这种选择可以降低制造成本,但它限制了分支、布线、通孔尺寸和元器件放置。
更小的通孔取决于板的纵横比。
保持PCB尽可能薄,如果电路板厚度小于等于50 mil[1.27mm],大多数制造商可以生产更小的通孔,最小可达6mil[0.15mm],而无需额外增加成本。
A-SAP和mSAP工艺都可用于电镀孔。
同样,厚径比也会有所不同。
还有,需要多厚镀层?是用导电材料还是非导电材料填塞通孔?
更窄的走线
选用多窄的走线取决于所选择的制造工艺以及元器件引线间距。
在确定工艺之前,了解A-SAP和mSAP之间的差异非常重要。
标准的减成法蚀刻工艺从超薄的铜箔开始,蚀刻电路图形,然后为形成的走线和铜特征增加铜厚。
图1是IPC-6012中规定的起始铜厚表。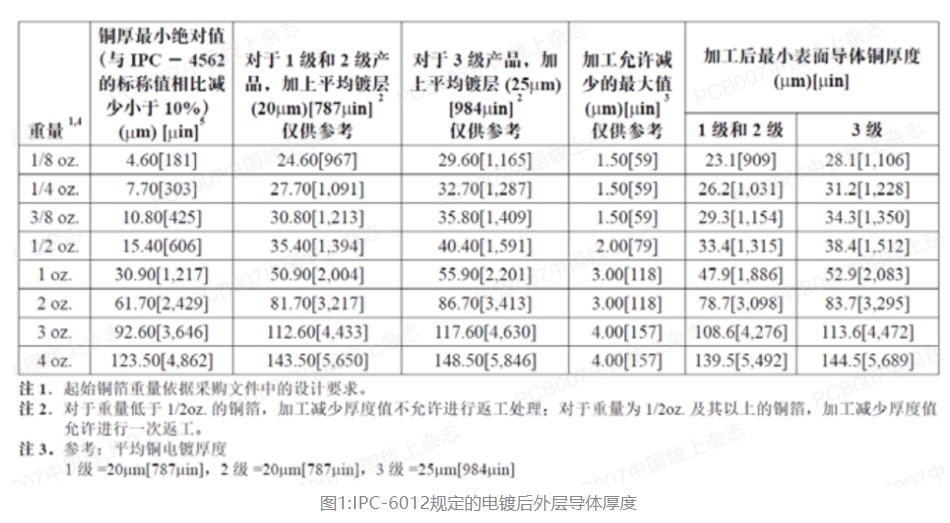
当使用基本芯材时,mSAP通常从四分之一盎司铜厚度开始,A-SAP从裸介质开始,增加0.2µm的薄化学镀铜。
图1显示了加成法工艺后的典型铜厚度。
最终会形成梯形结构,具体取决于光致抗蚀剂。
A-SAP工艺不会形成梯形结构走线。
基底铜越厚,越必须从梯形结构开始。
两种工艺都可以从典型的金属箔开始。
当采用加成法工艺时,mSAP通常从更厚的铜箔开始,A-SAP则从更薄的铜基底开始。
Averatek公司的Steve Iketani和Mike Vinson在2019年7月的《PCB007 Magazine》杂志上发表了一篇详细介绍该主题的文章。
A-SAP和mSAP在使用液态金属油墨(Liquid metal ink ,简称LMI)的初始铜厚度制造中都可采用加成法或减成法工艺。
当使用LMI涂布起始铜时,如图2所示,与层压板界面处的密度显著增加。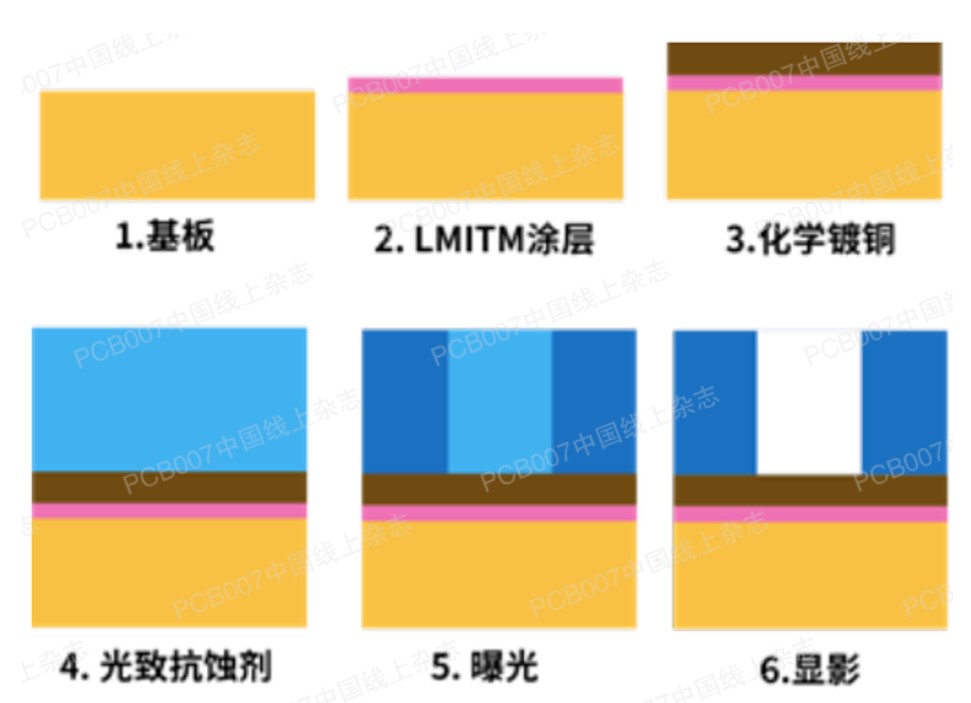
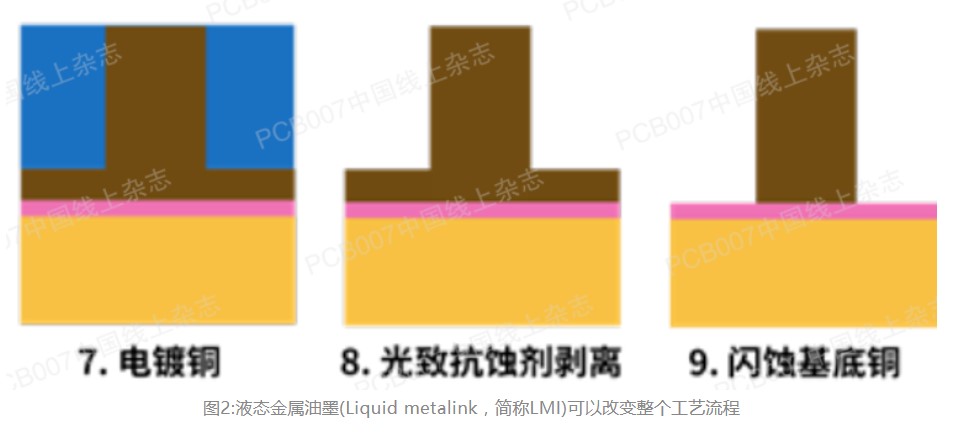
现在,工艺流程变得非常不同。走线形状、铜厚度和宽度也非常不同。图3显示了走线结构实例。
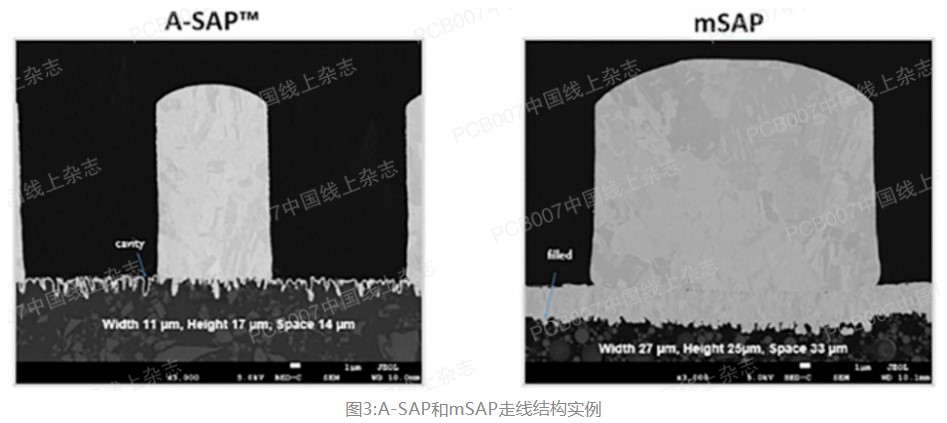
审核编辑:刘清
-
通孔电镀填孔工艺研究与优化2025-04-18 2968
-
陶瓷基板脉冲电镀孔技术的特点2025-01-27 2145
-
PCB电镀填孔工艺2024-01-04 3397
-
陶瓷基板电镀封孔/填孔工艺解析2023-06-05 4466
-
单双面板生产工艺流程(四):全板电镀与图形电镀2023-02-10 10640
-
干货:PCB电镀铜前准备工艺有哪些?2022-06-10 8890
-
柔性电路的电镀工艺选项2020-10-26 2699
-
重磅发布 MacuSpec VF-TH 300 通盲并镀电镀铜工艺2020-10-19 2842
-
PCB电镀填孔工艺是怎样的一项技术2020-03-02 9698
-
电镀工艺_电镀工艺的原理是什么2019-08-06 21058
-
【转帖】影响PCB电镀填孔工艺的几个基本因素2018-10-23 3194
全部0条评论

快来发表一下你的评论吧 !

