

等离子体工艺回顾
描述
ICP的设计在半导体工业中相当普遍,这种系统包括高密度等离子体(HDP)电介质CVD系统;硅、金属和电介质HDP刻蚀系统;原生氧化物溅镀清洁系统;离子化金属等离子体PVD系统。
在ICP反应室中加入射频偏压系统就可以产生自偏压并控制离子的轰击能量。由于在高密度等离子体中的离子轰击会产生大量的热能,因此必须有一个背面気气冷却系统和静电夹盘控制晶圆的温度。下图(b)显示了一个ICP反应室腔。ICP系统中,由等离子体密度决定的离子束流通过射频功率源控制,而离子轰击能量由偏压射频功率控制。
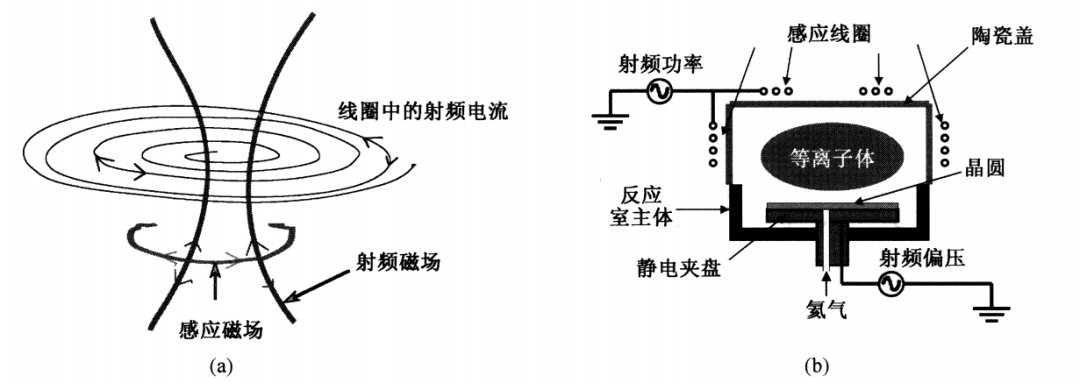
电子回旋共振
带电粒子在磁场中将形成回旋转动,而转动的频率称为螺旋转动频率或回旋频率,它由磁场的强度决定。由公式可以得出,电子螺旋转动频率为:
ΩeMHz)=2.8B(高斯)
在磁场中,当所用的微波频率等于电子的螺旋转动频率,即ωMW=Ωe,电子就发生回旋共振。电子将通过微波使能量增加,进而电子和原子或分子产生碰撞,而离子化碰撞将产生更多的电子,这些电子也会和微波形成共振获得能量,且通过离子化碰撞产生更多的电子。由于电子将沿磁场线进行螺旋转动,如下图(a)所示,因此即使平均自由程比反应室的距离长,也一定会先和气体分子产生多次碰撞后才会与反应室墙壁或电极碰撞。这就是ECR系统能在低压状态下产生高密度等离子体的原因。
ECR系统和ICP系统一样都具有射频偏压系统控制离子的轰击能量,并具有静电夹盘背面氮气冷却系统以控制晶圆的温度,如下图(b)所示。离子轰击的流量主要由微波功率控制。ECR系统的优点之一在于通过改变磁场线圈中的电流就能调整共振的位置,所以可以通过调整磁场线圈的电流来控制等离子体的位置,提高工艺的均匀性。

等离子体工艺回顾
1. 等离子体由离子、电子和中性分子组成。
2. 等离子体中三种主要的碰撞为离子化、激发-松弛和分解碰撞。
3. 平均自由程是指粒子与其他粒子碰撞前所能移动的平均距离,平均自由程和压力成反比。
4. 分解碰撞中产生的自由基能够增强CVD、刻蚀和干法清洗工艺的化学反应。
5. 等离子体电位必须高于电极的电位,高电位的等离子体才能产生离子轰击。
6. 电容耦合式等离子体系统中,增加射频功率可以增加离子轰击的能量和流量。
7. 低频功率将使离子有更多的能量,说明有更剧烈的离子轰击。
8. 刻蚀工艺比PECVD工艺需要更多的离子轰击,刻蚀反应室通常使用磁场增加低压条件下的等离子体密度。
9. 电容耦合式等离子体源不能产生高密度等离子体。
10. 刻蚀和CVD工艺需要低压条件下的高密度等离子体。
H.ICP和ECR是最常使用的两种高密度等离子体源。
12.ICP和ECR等离子体源都可以单独控制离子轰击的流量和能量。
审核编辑 :李倩
-
等离子的基本属性_等离子体如何发生2025-01-03 3373
-
等离子体清洗的原理与方法2024-11-29 2783
-
什么是电感耦合等离子体,电感耦合等离子体的发明历史2024-09-14 3586
-
等离子体清洗工艺的关键技术 等离子体清洗在封装生产中的应用2023-10-18 4172
-
低温等离子体技术的应用2023-02-27 2149
-
等离子体应用2022-05-18 3813
-
TDK|低温等离子体技术的应用2022-05-17 3149
-
低温等离子体废气处理系统2022-04-21 12443
-
微波标量反射计可测量大范围的等离子体密度2019-06-10 1578
-
PCB板制作工艺中的等离子体加工技术2018-09-21 2976
-
PCB电路板等离子体切割机蚀孔工艺技术2017-12-18 3155
-
PCB多层板等离子体处理技术2013-10-22 2619
-
等离子体技术废水处理工艺工艺流程2010-02-22 3832
全部0条评论

快来发表一下你的评论吧 !

