

湿法刻蚀工艺的流程包括哪些?
描述
湿法刻蚀工艺
湿法刻蚀利用化学溶液溶解晶圆表面的材料,达到制作器件和电路的要求。湿法刻蚀化学反应的生成物是气体、液体或可溶于刻蚀剂的固体。
包括三个基本过程:刻蚀、冲洗和甩干(见下图)。
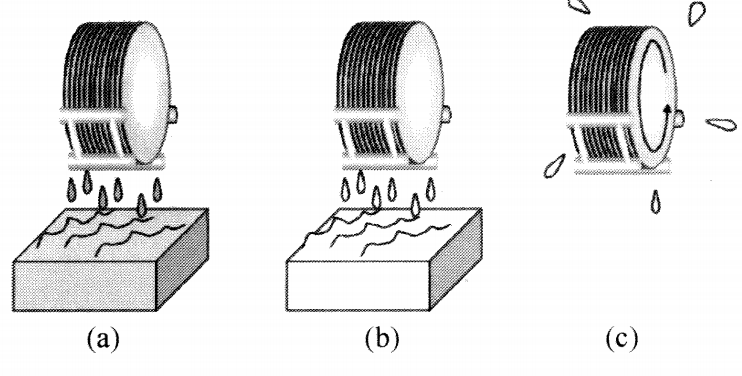
20世纪80年代以前,当图形尺寸大于3um时,湿法刻蚀广泛用于半导体生产的图形化过程。湿法刻蚀具有非常好的选择性和高刻蚀速率,这根据刻蚀剂的温度和厚度而定。
比如,氢氟酸(HF)刻蚀二氧化硅的速度很快,但如果单独使用却很难刻蚀硅。因此在使用氢氟酸刻蚀硅晶圆上的二氧化硅层时,硅衬底就能获得很高的选择性。
多,因为它不需要真空、射频和气体输送等系统。然而当图形尺寸缩小到3um以下时,由于湿法刻蚀为等向性刻蚀轮廓(见下图),因此继续使用湿法刻蚀作为图形化刻蚀就变得非常困难,利用湿法刻蚀处理图形尺寸小于3um的密集图形是不可能的。
由于等离子体刻蚀具有非等向性刻蚀轮廓,80年代以后的图形化刻蚀中,等离子体刻蚀就逐渐取代了湿法刻蚀。湿法刻蚀因高选择性被用于剥除晶圆表面的整面全区薄膜。
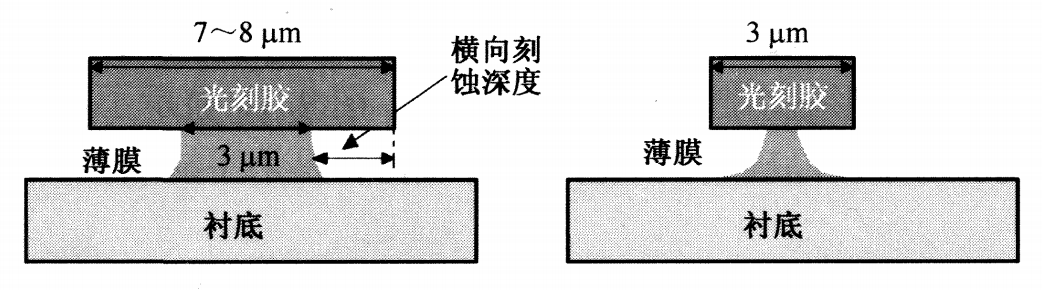
半导体工艺师一直努力消除半导体制造中的所有湿法工艺,但当先进的IC制造普遍釆用化学机械研磨(CMP)和电化学沉积法时,消除所有的湿法工艺就变得很困难。
湿法刻蚀具有高选择性,IC生产中仍普遍采用这种技术剥除薄膜。可以利用薄膜的湿法刻蚀速率鉴定薄膜的质量。湿法刻蚀的另一个重要应用是剥除测试晶圆上的薄膜,这些测试晶圆作为工艺设备的鉴定也能重复使用。
氧化物湿法刻蚀
二氧化硅的湿法刻蚀通常使用HF。因为1:1的HF(H2O中49%的HF)在室温下刻蚀氧化物速度过快,所以很难用1:1的HF控制氧化物的刻蚀。一般用水或缓冲溶剂如氟化氨进一步稀释HF降低氧化物的刻蚀速率,以便控制刻蚀速率和均匀性。氧化物湿法刻蚀中所使用的溶液通常是6:1稀释的HF缓冲溶液,或10:1和100:1的比例稀释后的HF水溶液。
氧化物湿法刻蚀的化学反应为:
SiO2+6HF->H2SiF6+2H2O
H2SiF6可溶于水,所以HF溶液能刻蚀二氧化硅,这就是为什么HF不能放在玻璃容器内,而且HF在实验中不能用玻璃烧杯或玻璃试管盛放。
一些IC制造中仍使用HF氧化物湿法刻蚀和等离子体氧化物刻蚀“酒杯状”接触窗孔,以易于PVD铝的填充(见下图)。
最先进的半导体制造中,每天仍进行6:1的缓冲二氧化硅刻蚀(BOE)和100:1的HF刻蚀。如果监测CVD氧化层的质量,可以通过比较CVD二氧化硅的湿法刻蚀速率和热氧化法生成的二氧化硅湿法刻蚀速率,这就是所谓的湿法刻蚀速率比(WetEtchRateRatio,WERR)。热氧化之前,10:1的HF可用于预先剥除硅晶圆表面上的原生氧化层。
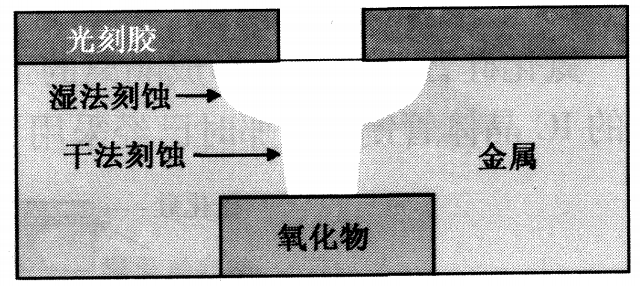
HF具有腐蚀性,和皮肤或眼睛接触时无法及时发现,经过24小时后,当HF开始侵入骨头时才会感觉到严重的刺痛。HF和骨头中的钙反应生成氟化钙,两者最后会中和。因此治疗HF伤害可以注入含钙的溶液来防止或减少骨质的损失。一般的安全常识是:把生产厂房内所有的透明液体都当HF处理,绝对不要认为任何液体都是水。如果感觉直接接触到了HF就应尽快彻底清洗、告知管理人员并寻求医疗协助。
审核编辑:刘清
-
一文详解湿法刻蚀工艺2025-05-28 6628
-
两种基本的刻蚀工艺:干法刻蚀和湿法腐蚀2018-12-14 72917
-
干法刻蚀工艺介绍2022-06-13 1764
-
常见的各向同性湿法刻蚀的实际应用2022-10-08 7846
-
湿法刻蚀和清洗(Wet Etch and Cleaning)2022-11-11 20813
-
半导体图案化工艺流程之刻蚀(一)2023-06-26 3635
-
PDMS湿法刻蚀与软刻蚀的区别2024-09-27 1373
-
湿法刻蚀步骤有哪些2024-12-13 1822
-
晶圆湿法刻蚀原理是什么意思2024-12-23 1562
-
芯片湿法刻蚀方法有哪些2024-12-26 2087
-
半导体湿法刻蚀残留物的原理2025-01-02 1538
-
湿法刻蚀:晶圆上的微观雕刻2025-03-12 1407
-
湿法刻蚀的工艺指标有哪些2025-09-02 1474
-
湿法刻蚀工作台工艺流程2026-01-14 331
-
湿法刻蚀工作槽全解析:各槽分工协同,揭秘高效精准刻蚀的运作逻辑2026-05-06 142
全部0条评论

快来发表一下你的评论吧 !

