

纯化学刻蚀、纯物理刻蚀及反应式离子刻蚀介绍
描述
纯化学刻蚀、纯物理刻蚀及反应式离子刻蚀
刻蚀有三种:纯化学刻蚀、纯物理刻蚀,以及介于两者之间的反应式离子刻蚀(ReactiveIonEtch,RIE)。
纯化学刻蚀包括湿法刻蚀和遥控等离子体光刻胶去除。纯化学刻蚀中没有物理轰击,由化学反应移除物质。纯化学刻蚀的速率根据工艺需要可以很高也可以很低。纯化学刻蚀一定会有等向性刻蚀轮廓,因此当图形尺寸小于3um时,就无法使用纯化学刻蚀进行薄膜图形化技术。
由于纯化学刻蚀具有很好的刻蚀选择性,所以纯化学刻蚀通常用在剥除工艺上。例如,去光刻胶、去氮化硅、垫基氧化层、屏蔽氧化层和牺牲氧化层等。遥控等离子体(RP)刻蚀是在远端反应室中利用等离子体产生自由基,再将自由基送入反应室和晶圆产生反应,因此属于纯化学刻蚀。
氯轰击属于纯物理刻蚀,广泛使用在电介质溅射回刻削平开口部分,以利于后续的空隙填充。氯轰击也用于金属PVD前的清洗过程,用于移除氧化物以减少接触电阻。氯是一种惰性气体,制造中不会产生化学反应。材料受氯离子轰击后从表面脱离,如用一只锤子把材料从表面敲击移除一样。
纯物理刻蚀的速率一般很低,主要取决于离子轰击的流量和能量。因为离子会轰击并移除任何与衬底接触的材料,所以纯物理刻蚀的选择性很低。等离子体刻蚀中,离子轰击的方向通常和晶圆表面互相垂直。所以纯物理刻蚀主要是朝垂直方向刻蚀,它是一种非等向性刻蚀过程。
反应离子蚀刻(RIE)的名称可能是有些误导。这种类型的蚀刻工艺的正确名称应为离子辅助蚀刻,因为在此蚀刻工艺中的离子不一定有化学反应。例如在许多情况下氯离子被用来增加离子轰击。而作为一种惰性原子,氯离子是没有化学反应的。大多数蚀刻制程中的化学活性物是中性的自由基。
在半导体蚀刻加工等离子体中,中性的自由基的浓度比离子浓度高得多。这是因为电离活化能明显高于解离的活化能,而物种浓度与活化能指数相关。然而,RIE这个词在半导体业界已被用了很长时间,可能没有人会改变它。下图显示离子辅助蚀刻的原理与早期实验的结果。
首先将XeF2气体单独由闭锁阀门注入。XeF2是一种不稳定的气体。徹是一种惰性气体,所以不会与其他原子形成化学键。干法化学刻蚀中通常用于输送氟自由基。当XeF2接触到已加热的单晶硅时,就会分解并释放出两个氟自由基。因为氟自由基只有一个不成对的电子,所以能从其他原子获得一个电子,在化学上很容易起反应。氟会与样品表面的硅反应形成易挥发性的四氟化硅(SiF4)。下图中的测量结果表明了这种纯化学刻蚀的刻蚀速率很低。
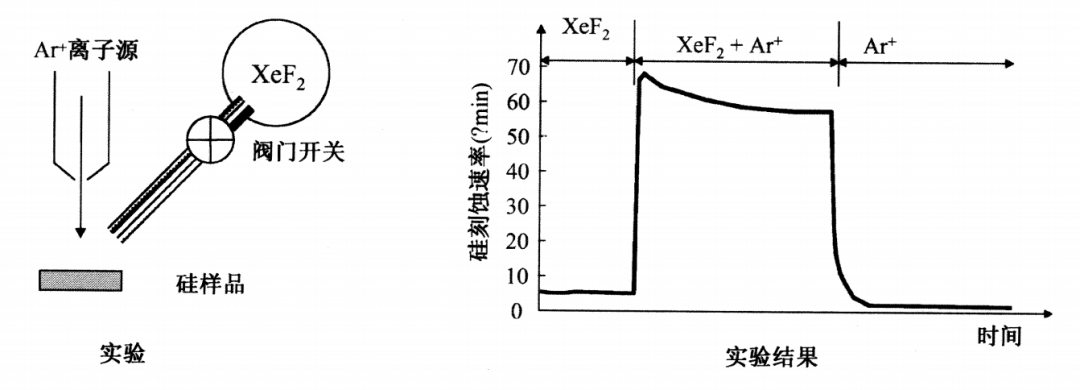
接着开启氯离子枪。结合了物理的离子束轰击和氟自由基的化学刻蚀,硅的刻蚀速率明显增加。当关闭阀门停止输送XeF2气流后,硅就单独由氯离子溅射刻蚀。这是一种纯物理刻蚀,刻蚀速率比使用XeF2气流的纯化学刻蚀还要慢。
审核编辑:刘清
-
湿法刻蚀工作槽全解析:各槽分工协同,揭秘高效精准刻蚀的运作逻辑2026-05-06 138
-
芯片刻蚀原理是什么2025-05-06 2998
-
半导体湿法刻蚀残留物的原理2025-01-02 1537
-
芯片制造过程中的两种刻蚀方法2024-12-06 4045
-
刻蚀工艺的参数有哪些2024-12-05 3406
-
SiO2薄膜的刻蚀机理2024-12-02 2887
-
半导体干法刻蚀技术解析2024-10-18 4277
-
离子束刻蚀机物理量传感器 MEMS 刻蚀应用2024-09-12 1412
-
等离子刻蚀ICP和CCP优势介绍2024-04-12 9896
-
干法刻蚀常用设备的原理及结构2024-01-20 17572
-
刻蚀分为哪两种方式 刻蚀的目的和原理2023-08-01 11559
-
湿法刻蚀工艺的流程包括哪些?2023-02-10 7865
-
干法刻蚀之铝刻蚀的介绍,它的原理是怎样的2020-12-29 12167
-
【转帖】干法刻蚀的优点和过程2018-12-21 5749
全部0条评论

快来发表一下你的评论吧 !

