

半导体刻蚀工艺简述(2)
制造/封装
描述
严重的离子轰击将产生大量的热量,所以如果没有适当的冷却系统,晶圆温度就会提高。对于图形化刻蚀,晶圆上涂有一层光刻胶薄膜作为图形屏蔽层,如果晶圆温度超过150摄氏度,屏蔽层就会被烧焦,而且化学刻蚀速率对晶圆温度很敏感,所以图形化刻蚀反应室中必须配备冷却系统,避免光刻胶形成网状结构,并且控制晶圆温度和刻蚀速率。由于刻蚀必须在低压下进行,但低压环境不利于热传导,所以通常在晶圆背面使用加压过的氮气把热量从晶圆移走。为了避免晶圆被来自背面的气流吹走,必须使用能将晶圆固定的夹具,或利用静电作用固定晶圆的静电夹盘。下图是夹具和静电夹盘的示意图。

因为静电夹盘在晶圆上提供更好的温度均匀性和刻蚀均匀性,且有较少的微粒污染,所以20世纪90年代变得更加普遍。由于晶圆边缘没有夹具的阴影效应,所以具有很好的刻蚀均匀性。而且因为晶圆被均匀冷却,且不会因夹盘应力造成中心弯曲效应,所以晶圆具有很好的温度均匀性。静电夹盘并不像夹具那样有机械接触,所以能够减少刻蚀过程中的微粒数量。热传导率良好的氮,能将热量从晶圆转移到冷却平台。下表列出了氦元素的参数。


一个问题
问:氢的热导率比氮高,为什么刻蚀工艺中晶圆冷却不使用氢?
答:不能使用,这是基于安全的考虑。由于氢具有爆炸性和易燃性,而氨是惰性气体,比较安全,并且是仅次于氢的高热导率气体,所以在等离子刻蚀工艺中用于冷却晶圆。
因为等离子体刻蚀总会产生一些沉积物,所以必须使用等离子体干法清洗去除反应室内的沉积物。然而经过数千微米的薄膜刻蚀后,沉积薄膜将逐渐变厚并造成微粒剥落污染,因此必须定期预防维护,用手工的方式移除零件表面、反应室内以及腔壁上的沉积物。有些刻蚀反应室直接在室内设有遮蔽护套。预防维护期间,技术人员只要更换遮蔽护套,将脏护套送到专门清洗店处理后再使用。这种方法能显著减少湿法清洗所引起的系统停机时间而增加生产量。
随着图形尺寸的继续缩小,为了得到更好的刻蚀轮廓和精密的CD控制,图形化刻蚀必须在低压力下进行以减少离子间的散射碰撞。电容耦合型等离子体源无法在数毫托的低压下产生和维持等离子体,这是因为电子的MFP太长所以无法产生足够的离子化碰撞。半导体工业中通常使用感应耦合等离子体(ICP)与电子回旋共振(ECR)在低压下产生高密度等离子体进行深亚微米图形化的刻蚀,下图是这两种系统的示意图。
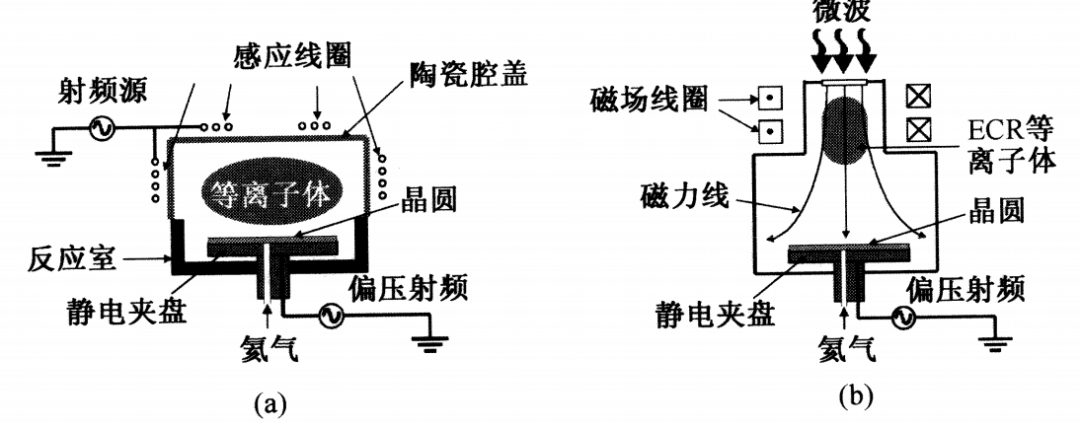
高密度等离子体系统最重要的优点在于能够通过等离子体源射频和偏压射频独立控制离子轰击流量和能量。在电容双耦型等离子体中,离子流量和能量都受射频功率的影响。
审核编辑:汤梓红
-
半导体boe刻蚀技术介绍2025-04-28 7489
-
最全最详尽的半导体制造技术资料,涵盖晶圆工艺到后端封测2025-04-15 1815
-
半导体前端工艺(第四篇):刻蚀——有选择性地刻蚀材料,以创建所需图形2023-11-27 1949
-
芯片制造的刻蚀工艺科普2023-09-24 4291
-
半导体前端工艺之刻蚀工艺2023-08-10 2009
-
半导体图案化工艺流程之刻蚀(一)2023-06-26 3593
-
半导体前端工艺:刻蚀——有选择性地刻蚀材料,以创建所需图形2023-06-15 3508
-
半导体刻蚀工艺简述(1)2023-03-06 3221
-
半导体光刻蚀工艺2021-02-05 7125
-
振奋!中微半导体国产5纳米刻蚀机助力中国芯2017-10-09 16876
-
【新加坡】知名半导体晶圆代工厂招聘资深刻蚀工艺工程师和刻蚀设备主管!2017-04-29 5416
-
6英寸半导体工艺代工服务2015-01-07 3991
-
半导体工艺讲座2009-11-18 97694
-
有关半导体工艺的问题2009-09-16 5863
全部0条评论

快来发表一下你的评论吧 !

