

PCB图形电镀工艺流程说明
描述
我们以多层板的工艺流程作为PCB工艺介绍的引线,选择其中的图形电镀工艺进行流程说明,具体分为八部分进行介绍,分类及流程如下:
A.内层线路(光成像工序)→ B.层压→ C.钻孔→ D.孔金属化(湿区工序)→ E.外层干膜(光成像工序)→ F.外层线路→ G.丝印→ H.表面工艺→ I.后工序
A.内层线路
利用UV光照射,在曝光区域抗蚀剂中的感光起始剂收光子分解成游离基,游离基引发单位发生交联反应生成不溶于稀碱的空间网状大分子结构,而未曝光部分因为发生可溶于稀碱。
利用二者在同种溶液中具有不同溶解性能从而将底片上的图形转移到基板上,即图像转移。
B.层压
层压,顾名思义,就是把各层线路薄板粘合成一个整体的工艺。其整个过程,包括吻压、全压、冷压。在吻压阶段,树脂浸润粘合面并填充线路中的空隙,然后进入全压,把所有的空隙粘合。
所谓冷压,就是使线路板快速冷却,并使尺寸保持稳定。
C.钻孔
一般情况下,钻孔是指用钻头在产品表明上加工孔的一种加工方式。一般而言,钻床上对产品进行钻孔加工时,钻头应同步完结两个运动:
①主运动,即钻头绕轴线的旋转运动(切削运动);
②次要运动,即钻头沿着轴线方向对着工件的直线运动(进给运动)。
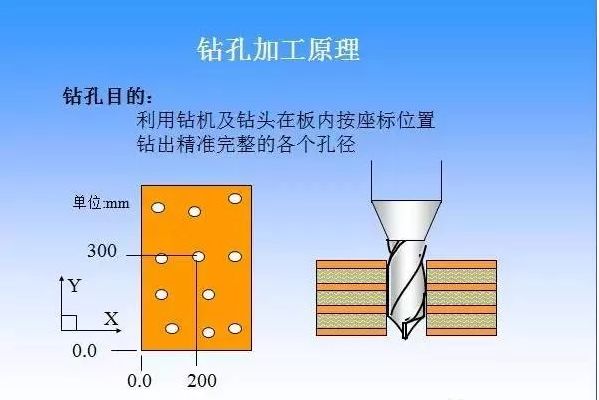
D.孔金属化
PCB加工过程中一个非常重要的工序就是shi非金属化孔变为金属化孔,实现孔的导通,即导通孔。
现在PCB孔金属化在行业中使用较普遍的几种工艺流程:化学沉箔铜,化学沉中铜,化学沉厚铜及直接电镀工艺等。
E.外层干膜
将菲林上的外层线路图像,转移到已完成沉铜或板电镀工艺的覆铜板上,形成抗电镀干膜图像。
F.外层线路
将在处理过的同面上贴上一层感光性膜层,在紫外光的照射下,将菲林底片上的图形转移到铜面上,形成一种抗腐蚀的掩膜图形。
G.丝印
防焊接时线路桥搭,提供长时间的电气环境和抗化学保护,形成印制板漂亮的“外衣”,包括热固性环氧绿油和液态感光阻焊油墨两大系统。
H.表面工艺
目前国内板厂常见的PCB便面处理工艺有:喷锡(HASL,hot air solder leveling 热风平整)、OSP(防氧化)、化学沉金(ENIG)、电镀金等等,当然,特殊应用场合还会有一些特殊的PCB表面处理工艺。
对比不同的PCB表面处理工艺,他们的成本不同,当然所用的场合也不同。
只选对的不选贵的,目前还没有最完美的PCB表面处理工艺能够(这里讲的是性价比,即以最低的价格就能满足所有的PCB应用场景),所以才会有这么多的工艺来让我们选择,当然每一种工艺都各有千秋,存在的既是合理的,关键是我们要认识他们用好它。
I. 后工序
即外层加工,测试和检验。
审核编辑:刘清
-
pcb制作工艺流程介绍 简述pcb设计流程2023-07-28 33665
-
单双面板生产工艺流程(四):全板电镀与图形电镀2023-02-10 10607
-
PCB电镀工艺流程及具体操作方法2023-02-07 10496
-
PCB工艺流程.zip2022-12-30 974
-
pcb制作的基本工艺流程2021-10-03 63279
-
关于黑孔化工艺流程和工艺说明,看完你就懂了2021-04-23 3505
-
PCB电镀工艺的分类,工艺流程和流程的详细说明2018-07-15 18757
-
详解PCB线路板多种不同工艺流程2017-06-21 3874
-
PCB工艺流程详解2013-05-22 10161
-
PCB线路板电镀铜工艺简析2009-11-17 4875
-
电镀工艺知识资料2009-04-08 1925
全部0条评论

快来发表一下你的评论吧 !

