

什么是Hybrid Bonding?Hybrid Bonding是铜铜键合吗?
描述
在Hybrid Bonding前,2D,2.5D及3D封装都是采用焊锡球凸点(solder bump)或微凸点(Micro bump)来实现芯片与基板,芯片与中介层(interposer), 芯片与芯片间的电连接。Solder bump/micro bump在制备工艺中都有植球的步骤,所植的球就是焊锡球(Solder bump),所以在Hybrid Bonding之前芯片间的连接都是靠焊锡球进行连接。
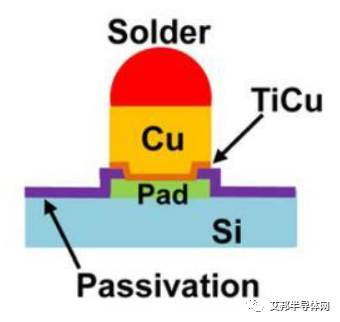
图1,Cu+Solder 统称为bump, 细分又可以分为Cu bump 和Solder Bump. 当然Solder bump是植在铜柱 (Copper bump)上的。如图2所示,当copper bump pitch 小于10~20um时,焊锡球 solder bump就变成了工艺难点及缺陷的主要来源。这时候就需要一种新的工艺来解决bump 间距小于10微米芯粒间键合的问题。当然Hybrid Bonding在电学性能方面也有独特的优势,如图3所示,Hybrid Bonding信号丢失率几乎可以忽略不计,这在高吞吐量,高性能计算领域优势明显。在业界强烈需求的呼唤下,Hybrid Bonding腾空出世。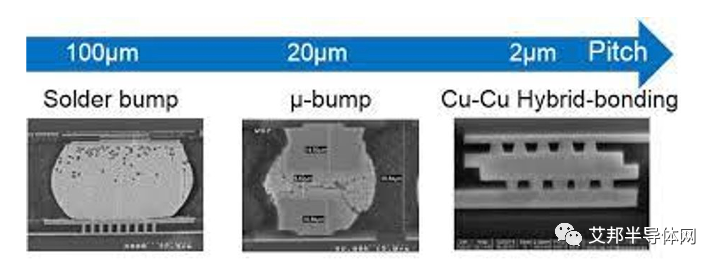
图2,不同bump间距(pitch)所采用BUMP形式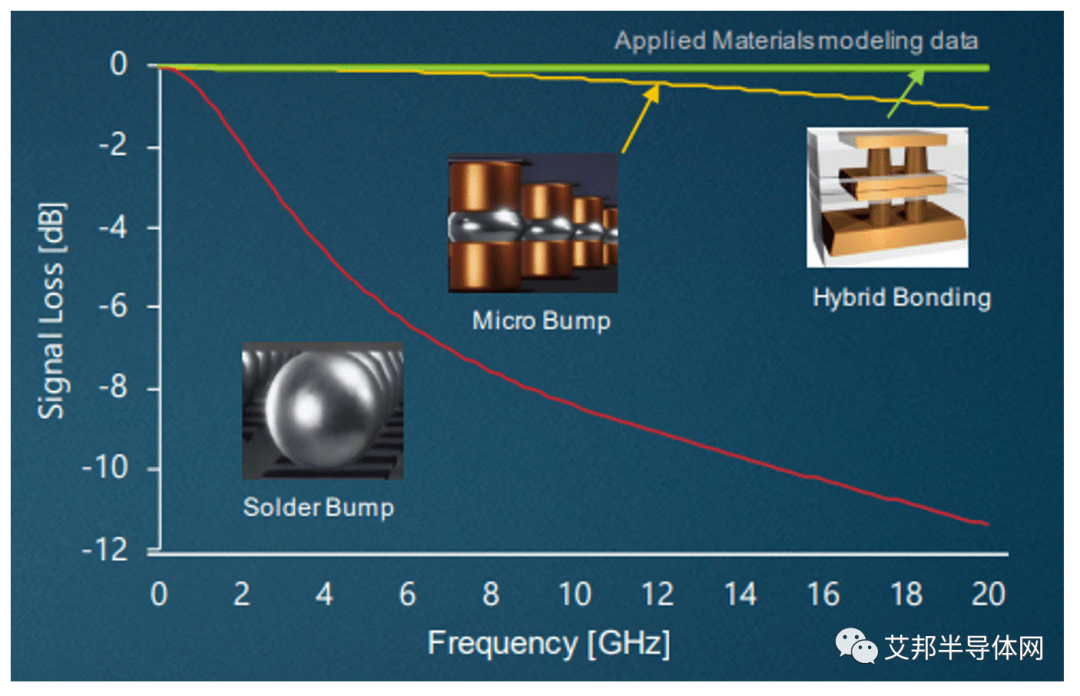
图3,频率与信号丢失对应曲线图
Hybrid Bonding中的Hybrid是指除了在室温下凹陷下去的铜bump完成键合,两个Chip面对面的其它非导电部分也要贴合。因此,Hybrid Bonding在芯粒与芯粒或者wafer与wafer之间是没有空隙的,不需要用环氧树脂进行填充。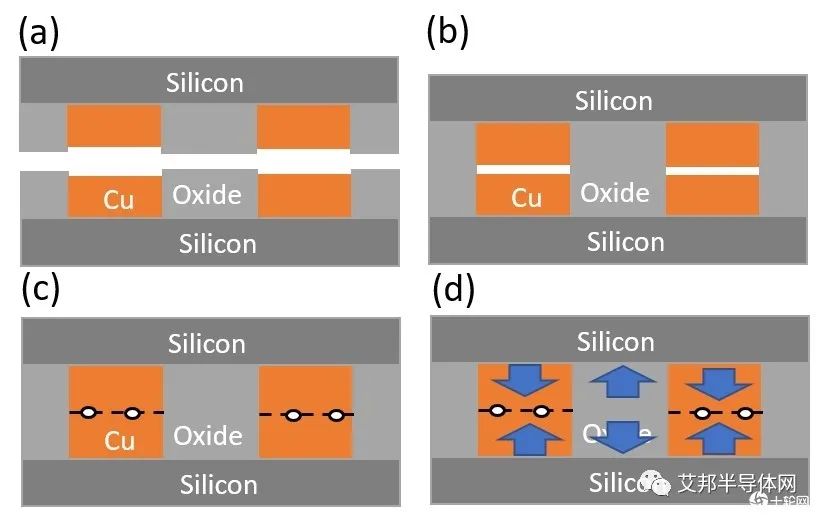
图4,图源十轮网
混合键合流程图:(a)试片未接合面貌(b)介电材料接合步骤(c)提高温度铜接点接合过程(d)高温时接点内部应力分布状态 Hybrid Bonding是近几年被叫响的,在之前业界通常称其为DBI(Direct Bond Interconnect,直接键合连接),它是在20世纪80年代中期由Paul Enquist,Q.Y. Tong和Gill Fountain在三角研究所(RTI)的实验室首次构思,DBI因其优雅和简洁而成为键合大海上的明灯。他们三个后来在2000年成立了一家叫Ziptronix的公司,并于2005年实现了10um bump间距用DBI技术连接的铝布线层,接着又在2011年发布2um bump间距用DBI技术完成wafer to wafer 连接。2015年Ziptronix被Xperi (前Tessera)收购。在2019年,DBI/Hybrid Bonding技术由Xperi (前Tessera)完成了最终的专利布局,其本身没有量产的产品推出。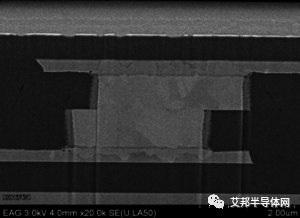
图5,2005年Ziptronix发布10um间距 用DBI技术连接的铝布线层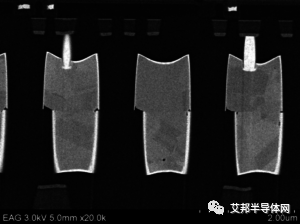
图6,2011年Ziptronix发布2um间距用DBI技术完成的wafer to wafer 连接
业界第一个DBIDBI/Hybrid Bonding量产的产品是由Sony在图像传感器上进行应用。这项技术在堆叠的CMOS图像传感器的下部电路芯片和上部像素芯片中增加了Cu连接焊盘,以同时建立物理和电气连接。由于Cu-Cu直接键合是在wafer生产过程中进行的,索尼开发了原始的制造工艺来克服这些问题,并成为世界上第一个推出该技术的公司。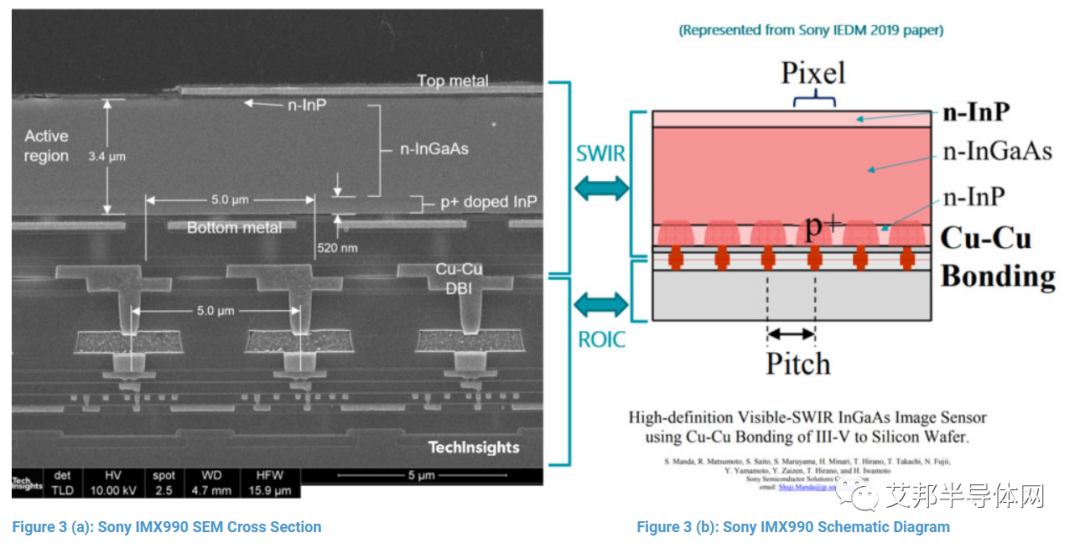
图7,Sony首款采用HybridBonding/DBI铜铜键合的传感器
接着台积电,英特尔、三星等大厂都开始采用该工艺用于进行3D封装,并陆续推出用于CPU、GPU及高性能计算中。到今天,Hybrid Bonding已经被叫的越来越响。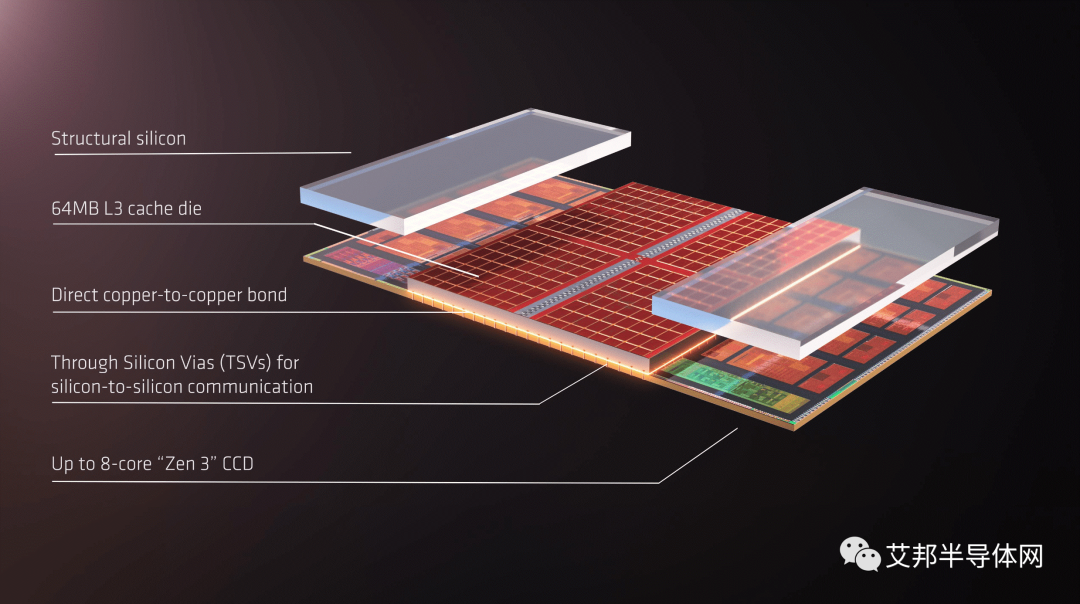
图8,AMD Hybrid Bonding产品
最后我们再谈谈相应的设备厂家,Hybrid Bonding代表着未来,代表着研发实力,设备巨头们都在积极跟进。当前主要有两个实力强劲的联盟:Besi与Applied Material的BA联盟以及香港的ASMPT与EV GROUP (EVG)的AE联盟,巨头们强强联合来争夺先进封装设备中的塔尖。另外,根据新闻报道近期异军突起的华封也在积极研发布局。如果您是我们的老朋友应该看到过我们艾邦半导体公众号对TCB(热压键合)设备的介绍,相信大家对TCB设备的复杂性已经有一定的了解。
TCB设备升级改造后可以具备Hybrid Bonding的功能,但是后者的难点除了贴装精度要求更高外,对晶粒及晶圆本身共面性、表面粗糙度、洁净度等要求都极为苛刻。这也就是为什么一套Hybrid Bonding设备的研发需要巨头们强强联合的原因。
审核编辑:刘清
-
混合键合(Hybrid Bonding)工艺介绍2025-07-10 4026
-
先进封装爆发,但TC Bonding让Hybrid Bonding推迟进入市场2025-04-09 3031
-
Cu-Cu Hybrid Bonding技术在先进3D集成中的应用2024-11-24 4770
-
介绍芯片键合(die bonding)工艺2023-03-27 17824
-
英特尔推出Hybrid Bonding技术 推进高端封装演进2021-06-28 3050
-
请教下铝里面硅、铜的含量会不会对铜线bonding有影响?2019-10-29 3806
-
芯片封装设计中的wire_bonding知识介绍2012-01-13 48722
-
HYBRID VEHICLE AND HYBRID POWE2009-11-30 905
-
什么是bonding?2009-11-17 14987
全部0条评论

快来发表一下你的评论吧 !

