

用紫外线/臭氧源对硅表面进行简单的清洁和调节
电子说
描述
引言
由于成本优化工艺是光伏行业的主要目标,简单的、具有内联能力的清洁可以替代成本和时间密集型的湿化学清洁方法,如来自微电子应用的RCA清洁。替代湿化学过程去除有机残留物是由紫外线/臭氧的光源已经用于清洁玻璃或塑料组件和提供一个简单的集成,少量的过程消耗品和进一步知道的生成高质量的超薄氧化硅层。对于这一过程,目前为止使用低成本SC1(标准清洁1混合物,其中氢氧化铵被氢氧化钾取代)方法。本文测试了汞蒸汽灯(UV/O3)对有机残留物的去除效果,并与SC1的清洗效果进行了比较。
实验与讨论
对于与氧发生的光化学反应,紫外光的波长为185和254 nm是重要的,可以由低压汞蒸汽灯产生(图1)。波长为185纳米的紫外光被分子氧(O2)吸收,从而产生臭氧(O3)。另一方面,在254 nm处的紫外光被碳氢化合物化合物和o3吸收,因此碳氢化合物污染被裂解,o3在o2和氧自由基中再次解离。这样,就产生了一种动态的平衡。对前面描述的汞蒸汽灯的一种替代方法是发射单色紫外线辐射的准分子系统。与氢蒸气灯类似,可以诱导分子氧的解离并产生臭氧。窄谱线和单色光谱可以增加对光过程和紫外辐射的定向应用。
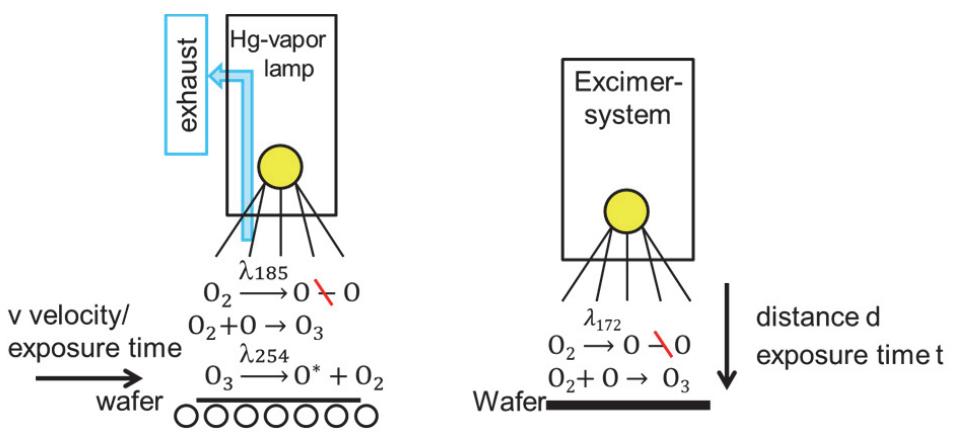
图1:汞蒸汽灯及反应机理示意图(左),准分子体系及反应机理示意图(右)
经HF浸渍后得到的氧化层厚度为0.2 nm,硝酸氧化物的厚度约为0.59 nm。紫外/o3氧化物的氧化物生长速度取决于到照射源的距离和曝光时间。由此得到的氧化层厚度越高,样品与辐照源之间的距离越小,曝光时间也越长。仅比较紫外/O3氧化物,发现亚化学计量物种的峰的相关性:Si2+(SiO)峰随着曝光时间减小,Si3+(Si2O3)和Si4+(二氧化硅)峰随着曝光时间增加,Si+(Si2O)峰保持不变。样品与辐照源之间的距离越低,得到的Si3+(Si2O3)的量就越高。
结论
结果表明,汞蒸汽灯曝光可以去除碱性纹理过程中产生的有机残留物。特别是在长时间暴露和高o3浓度的指纹被完全去除,胶水残留物大多被去除。英思特公司通过两种研究的氧化方法(UV/O3和硝酸),从而结合两种研究的钝化堆,提高发射器饱和电流。钝化性能的改善预计是由于界面氧化层导致的界面缺陷密度的降低。英思特研究表明,通过紫外/o3暴露,生长的超薄SiOx层非常适合作为隧道氧化物。用UV/O3生长的隧道氧化物测定,平面样品超过720 mV,纹理样品超过710 mV。仅3 min的短暴露时间就足以实现良好的界面钝化,因此本研究的过程是一种很有前途的、简单的、成本效益的隧道氧化物的应用。
江苏英思特半导体科技有限公司主要从事湿法制程设备,晶圆清洁设备,RCA清洗机,KOH腐殖清洗机等设备的设计、生产和维护。
审核编辑:汤梓红
-
紫外线传感器2012-03-13 7319
-
自行打造紫外线擦除器2012-10-13 5455
-
【VEML6075紫外线检测试用体验】紫外线灯管测试(结项)2017-04-25 4466
-
在紫外线杀菌领域中传感器的应用2018-05-14 4677
-
专用于水质消毒领域的紫外线传感器2018-08-31 2939
-
紫外线在皮肤医疗领域的应用2018-09-27 2944
-
皮肤杀手紫外线UVA波段领域中的传感器2018-11-09 2889
-
紫外线传感器在餐具消毒机中的应用2018-12-06 2733
-
厂商口罩紫外杀菌机JH-850 隧道式口罩UV紫外线杀菌炉2020-03-13 1289
-
微波雷达模块应用,紫外线消毒灯智能感应,人体存在感应雷达技术2021-09-18 1942
-
用于户外紫外线UVI指数检测的户外紫外线指数计2019-07-18 5098
-
用于太阳光紫外线指数检测领域的紫外线传感器2019-08-11 2661
-
紫外线消毒杀菌介绍2022-07-28 4111
-
使用紫外线臭氧检测仪的原因是什么?2022-11-12 2111
-
紫外线灯的使用方法 紫外线杀菌技术应用2024-12-17 2913
全部0条评论

快来发表一下你的评论吧 !

