

多层PCB的制造工艺流程
描述
多层板制造方法有电镀通孔法以及高密度增层法两种,都是通过不同工艺的组合来实现电路板结构。 其中目前采用最多的是电镀通孔法,电镀通孔法经过超过半个世纪的发展与完善,电镀通孔法无论从设备、材料方面,还是工艺方面都已相当成熟,并已建立起坚实的产业化基础。 电镀通孔法既可制作双面板,又可制作多层板,他们在工艺流程和设备上是可以做到复用的。 电镀通孔法是将绝缘基板表面、内层的导体图形由通孔贯穿,在通孔内壁电镀金属层并实现不同层中相应导体图形的连接。
以一PCB厂的制作工艺为例,典型的刚性多层板的主要制作工艺如下图所示的流程:
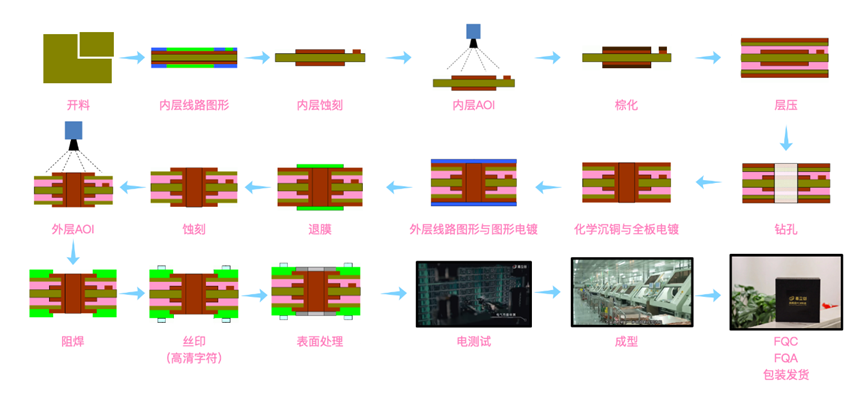
开料
PCB厂并不直接制造覆铜板、半固化片、铜箔等基材,而是向产业链上游的基材厂商采购所需的基材,基材在出厂时都是标准的大尺寸,比如1m1m(或1m1.2m)的规格。 然后在PCB制造之前,需要根据自身加工设备的规格,将其切割成适合生产线所需的尺寸。
开料之后,对于多层板的工艺流程,先制作内层电路,如内层图形制作、压合等工序,然后流程又回到了与双层板一致的流程,如钻孔、电镀、外层图形制作等,最后就是各种检测和包装发货。
内层图形制作
多层板的内层通常使用薄的双面覆铜基板,在其表面形成内层线路之后,进行压合,即可得到多层板。
在内层的双面覆铜板上贴上光敏干膜,然后在贴上内层线路的薄膜并曝光,曝光后进行显影,然后用蚀刻机进行蚀刻,去除不必要的铜箔。
蚀刻完成之后,内层的线路便已呈现,这时候就需要把保护线路不被蚀刻的保护膜清除掉,这就是退膜工序。
接着就是内层的检查,采用自动光学检查(AOI)进行,在层压之前,为了提高铜箔与半固化片的结合能力,需要做棕化处理。
棕化的目的如下:
1.增大铜箔与树脂的接触面积,加大两者之间的结合力;
2.增加铜面对流动树脂之间的润湿性,使树脂能流入各死角而在硬化后有更强的附着力;
3.在铜表面生成细密的钝化层,防止硬化剂与铜在高温高压状态下反应生成水而产生爆板。
层压
内层板将按照设计的层叠结构进行堆叠,将制作好的内层板、半固化片以及外层的铜箔依顺序层叠,然后热压形成一体。
层压完成之后,便进入外层线路的制作流程,这部分则与双层板的制作流程流程是一致的。
钻孔
PCB压合完成后,各个层之间还没有形成互联,这时候就需要钻孔,然后在孔壁上制作导电铜层,实现互联。
化学沉铜与全板电镀
化学沉铜是利用化学方法在绝缘孔壁上沉积上一层薄铜,全板电镀是在已经完成化学沉铜,具有导电性能的孔壁上使用电镀的方式增加孔壁铜厚。 主要包括三个过程:除胶渣、化学沉铜与电镀铜。
除胶渣将清除孔中的胶渣并同时在孔壁上产生微粗糙,以增加铜与树脂的结合力。 化学沉铜将在孔壁形成薄金属层,作为电镀的种子层。 电镀则是为了增加孔壁铜厚。 由于此时板面还没有线路图形,因此该步骤被称为“ 全板电镀 ”。
外层线路图形
目的:将外层线路转移到覆铜板上的全过程。
图形电镀
目的:图形电镀是在线路图形裸露的铜皮上或孔壁上电镀一层达到要求厚度的铜层与锡层。
退膜
目的:用NaOH溶液退去抗电镀覆盖膜层使非线路铜层裸露出来。
蚀刻
目的:蚀刻是利用化学反应法将非线路部位的铜层腐蚀去。
阻焊
PCB的主要功能是承载和连接电子零件。 图形电镀之后,非接触或焊接区域需要用材料保护起来,以保护该区域并防止损坏或氧化。 元件组装多用焊锡膏进行焊接,这些涂覆的聚合物就被称为“阻焊剂"。
字符
目的:字符是提供的一种便于辩认的标记。

表面处理
这个与上边的“ 阻焊 “工艺不同,这里是要保护需要焊接或者接触的区域,防止裸露的铜箔与空气接触氧化而造成焊接不良或者接触不良。
成型
目的:通过模具冲压或数控锣机锣出客户所需要的形状。 成型的方法有机锣、啤板、手锣、手切。
说明:数控锣板与啤板的精确度较高、手锣其次、手切板最低且只能做一些简单的外形。
测试
目的:通过电子测试,检测目视不易发现到的开路,短路等影响功能性之缺陷。
终检
目的:通过检验产品外观缺陷,并对轻微缺陷进行修理,避免缺陷不符合要求的产品流出。
审核编辑:汤梓红
-
pcb制作工艺流程介绍 简述pcb设计流程2023-07-28 33616
-
多层PCB的制造工艺流程2023-05-04 3565
-
PCB图形电镀工艺流程说明2023-03-07 5459
-
PCB工艺流程详解.zip2023-03-01 959
-
PCB工艺流程.zip2022-12-30 971
-
PCB制造工艺流程是怎样的?2021-11-04 24505
-
pcb制作的基本工艺流程2021-10-03 63222
-
芯片制造全工艺流程解析2020-12-28 19163
-
带你了解PCB制造复杂的工艺流程2020-09-14 9961
-
PCB电路板的分类特点及生产工艺流程解析2019-07-29 7029
-
多种电路板工艺流程2017-12-19 4816
-
详解PCB线路板多种不同工艺流程2017-06-21 3869
-
PCB工艺流程详解2013-05-22 10144
-
双面板及多层板pcb工艺流程图2009-10-04 3763
全部0条评论

快来发表一下你的评论吧 !

