

高速硅湿式各向异性蚀刻技术在批量微加工中的应用
电子说
描述
引言
蚀刻是微结构制造中采用的主要工艺之一。它分为两类:湿法蚀刻和干法蚀刻,湿法蚀刻进一步细分为两部分,即各向异性和各向同性蚀刻。硅湿法各向异性蚀刻广泛用于制造微机电系统(MEMS)的硅体微加工和太阳能电池应用的表面纹理化。
蚀刻速率受蚀刻剂中的杂质(或添加剂)的显着影响。然而,四甲基氢氧化铵(TMAH)和氢氧化钾溶液(KOH)最广泛地用于硅湿体微加工中微结构的形成,两种蚀刻剂各有利弊。
实验与讨论

图1:纯碱性溶液中的蚀刻机理
英思特公司研究了碱性溶液中控制蚀刻过程的化学反应,并提出了几种模型。各向异性蚀刻由两个交替反应组成,即(i)氧化(ii)蚀刻,其特点是氧化与蚀刻相比非常慢。通常,硅表面原子被氢封端。氢氧根(OH-)离子和水(H2O)分子是碱性溶液(KOH、TMAH)中的化学活性物质。图1显示了纯碱性溶液中的蚀刻机制。氧化步骤可以通过化学氧化和/或电化学氧化发生。(江苏英思特半导体科技有限公司)
在纯碱性溶液中,蚀刻表面形貌主要取决于蚀刻剂浓度和蚀刻温度。在KOH溶液的情况下,当浓度稀释到小于8M(30wt%)时,微金字塔开始出现在Si{100}上,如图2所示,已经提出了各种模型来解释蚀刻过程中形成小丘的主要原因。
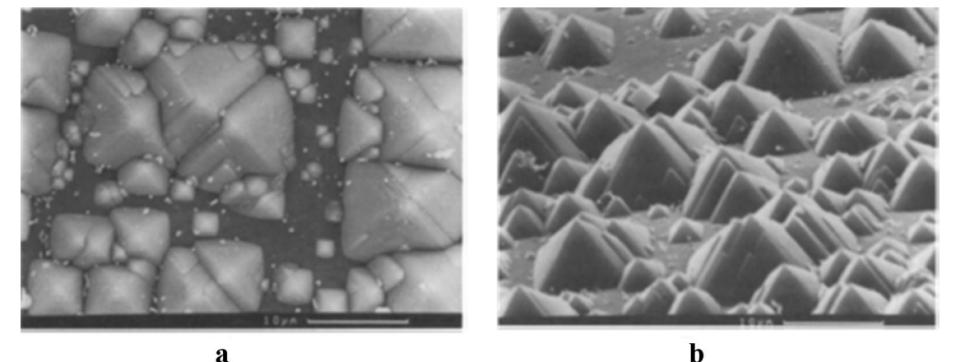
图2:在70℃的4.0 M氢氧化钾中蚀刻30 min后,Si{100}表面微金字塔的SEM图像
为了研究硅(Si){100}表面的底切,通常使用由<110>方向形成的矩形掩模图案,如图3中示意性所示。底切的增加表明,当将羟胺(NH2OH)添加到TMAH/KOH中时,高折射率平面的蚀刻速率也显着提高。底切的增量是纯TMAH/KOH的三倍以上,这非常有利于从基板上快速释放结构,从而最大限度地减少工业制造时间。
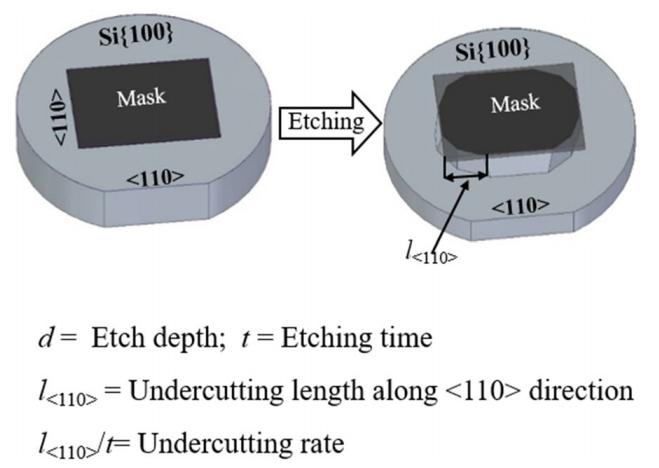
图3:矩形掩模图案的凸角处的下切示意图
结论
蚀刻剂浓度显着影响蚀刻速率。有两种方法可以达到蚀刻速率的局部最大值,各有利弊。第一种方法是使用稀释的氢氧化钾(KOH)或四甲基氢氧化铵(TMAH)溶液蚀刻硅(Si)。优点是易于应用,缺点是蚀刻速率适度增加,微金字塔的出现不可避免地导致蚀刻表面粗糙度。第二种方法是使用50 wt% KOH 的高浓度溶液在接近沸点(通常为145℃)下进行蚀刻。优点是可用的蚀刻速率约为10μ/min,缺点是Si和氧化物掩模之间的蚀刻选择性较低,需要替代掩模材料。(江苏英思特半导体科技有限公司)
蚀刻特性受不同种类的添加剂的强烈影响。英思特已经研究了各种添加剂来提高硅的蚀刻速率。在KOH溶液中添加氧化还原体系和络合剂可有效提高蚀刻速率,但这些添加剂未被其他研究人员进一步研究,因此在湿法各向异性蚀刻中并不常见。
江苏英思特半导体科技有限公司主要从事湿法制程设备,晶圆清洁设备,RCA清洗机,KOH腐殖清洗机等设备的设计、生产和维护。
审核编辑 黄宇
-
什么是各向异性刻蚀?2023-08-22 2324
-
硅结构的深且窄的各向异性蚀刻研究2022-05-11 1577
-
单晶硅的各向异性蚀刻特性说明2022-05-05 4397
-
详解微机械中的各向异性刻蚀技术2022-04-22 4491
-
微机械中的各向异性蚀刻技术与发展方向2022-03-29 1847
-
详解单晶硅的各向异性蚀刻特性2022-03-25 4306
-
单晶硅各向异性蚀刻特性的表征2022-03-22 1044
-
各向同性和各向异性工艺如何用于改善硅湿蚀刻2022-03-09 3614
-
半导体各向异性蚀刻的表面化学和电化学2022-03-03 2158
-
低浓度KOH中的各向异性蚀刻2021-12-28 2268
-
晶圆湿式用于硅蚀刻浴晶圆蚀刻2021-12-23 1102
-
用各向异性湿法蚀刻技术制作的低损耗硅波导2021-12-22 1513
-
基于图形处理器进行硅的各向异性腐蚀模拟2018-02-07 920
全部0条评论

快来发表一下你的评论吧 !

