

PCBA焊接润湿不良分析
电子说
描述
No.1 案例概述
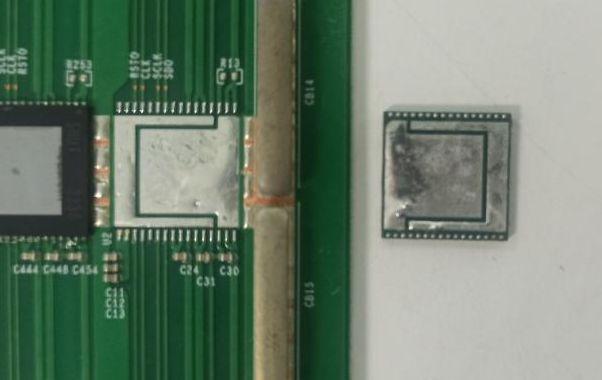
PCBA出现焊接润湿不良,分析剥离的器件与PCB板,推测虚焊发生原因与助焊剂(警惕!电子产品的“隐形杀手”——助焊剂残留)相关性较大。详细分析方案,请浏览文章获知。
No.2 分析过程
# 1 X-ray 检测
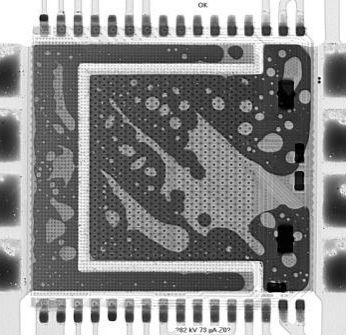
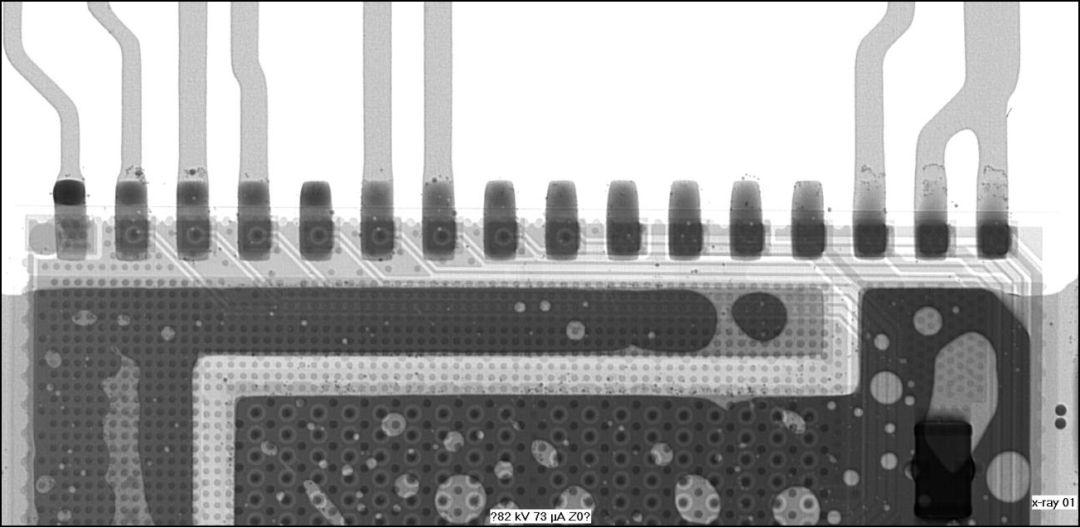
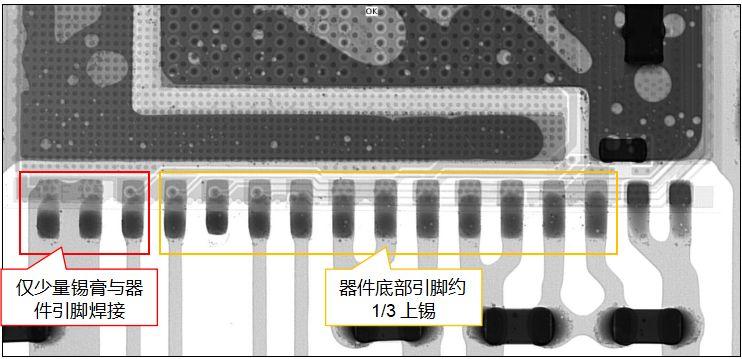
说明:
器件左下角底部焊盘几乎没有或仅少量锡膏焊接,该现象具有方向性。
# 2 外观观察
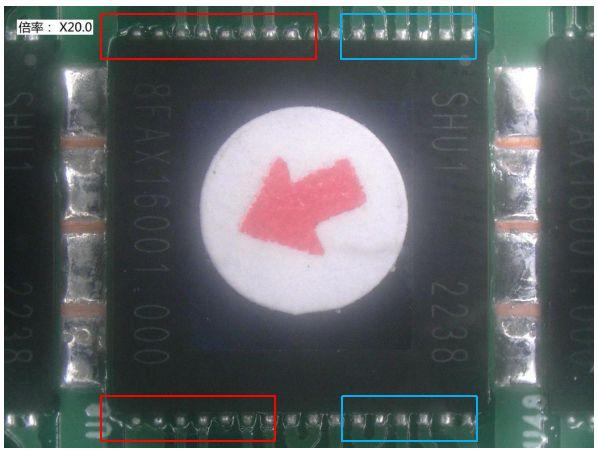
【异常外观】

【正常外观】

说明:
器件左侧焊点呈现堆积球形状。
# 3 剥离器件位置分析
1.剥离器件未进行处理时分析
PCB板侧外观观察
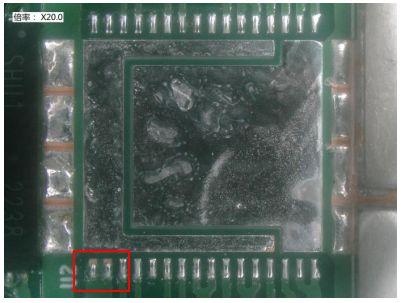

器件侧外观观察
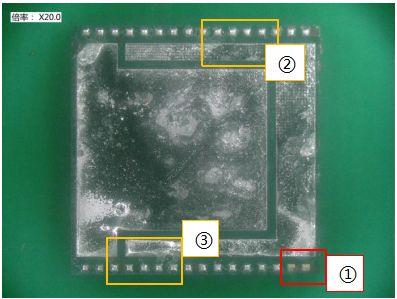
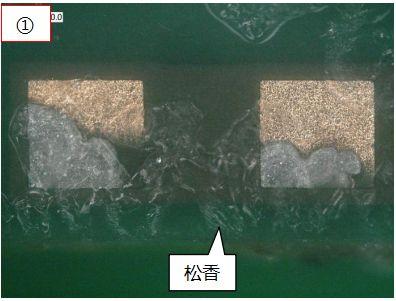
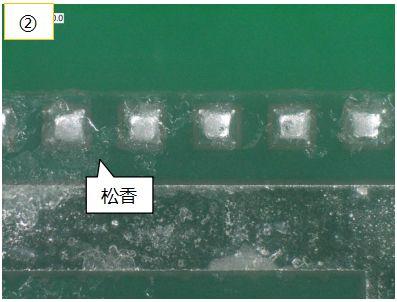
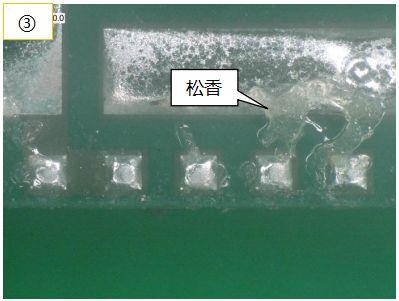
说明:
剥离器件PCB板侧焊盘未被完全润湿,器件侧焊盘仅沾少量锡膏,且两侧较多松香存留。
SEM分析
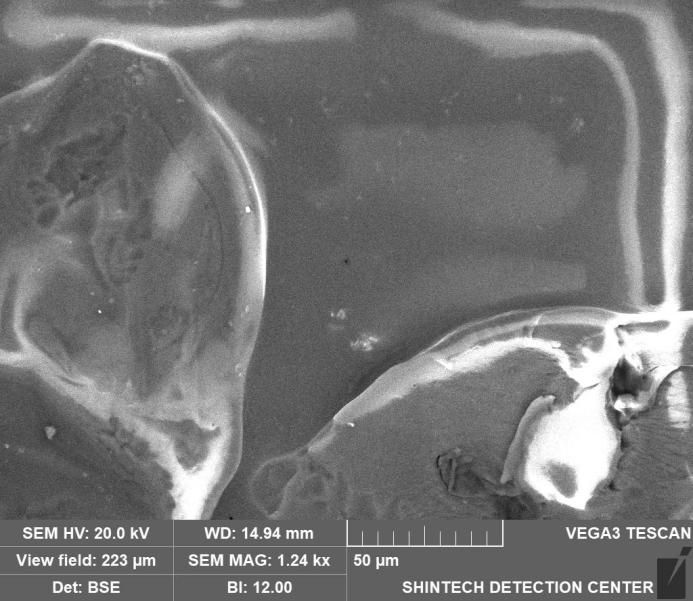
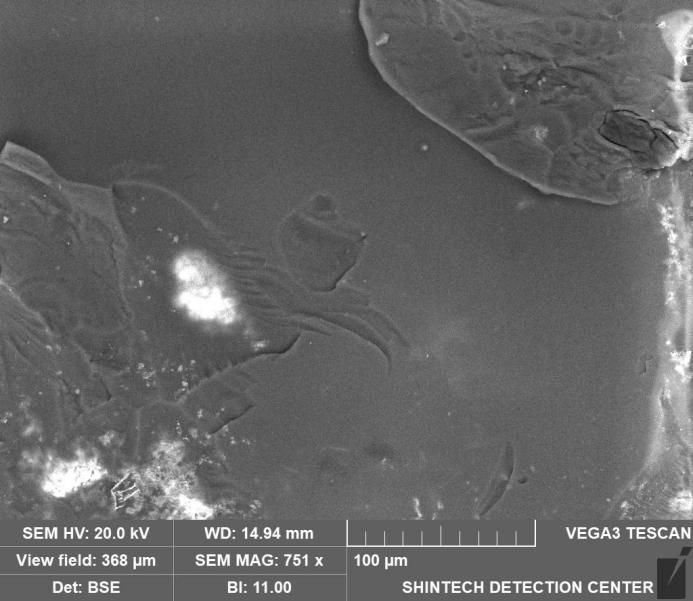
EDS分析

说明:
焊盘表面被松香所覆盖,检出Au、Ni元素,表明该未润湿位置镀层Au未溶蚀。
2.异丙醇清洗去除表面松香后分析
/ 测量方法 /
对剥离的器件使用异丙醇超声清洗后,去除表面松香,对底部焊接不良的两个焊盘进行分析。
金相观察



说明:
焊盘未润湿位置局部颜色发暗。
SEM分析
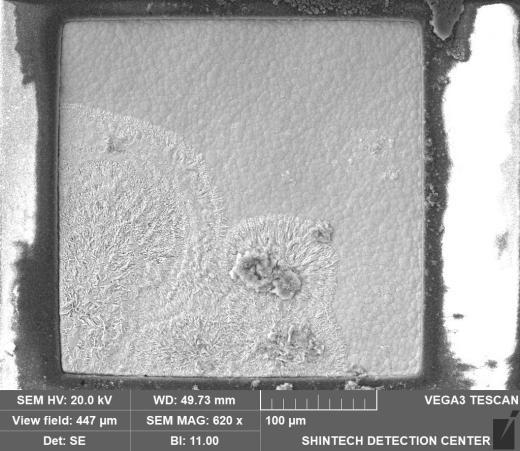
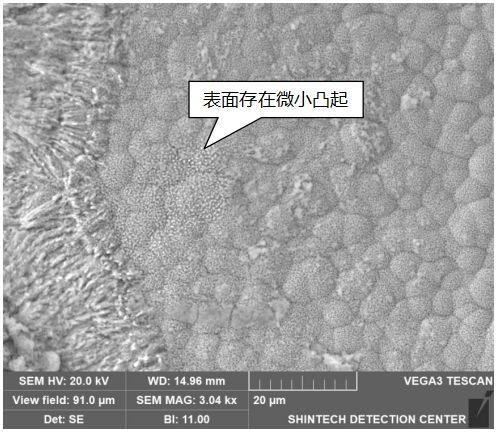
说明:
器件焊盘未润湿位置表面存在密密麻麻微小凸起,晶格形貌无异常。
EDS分析
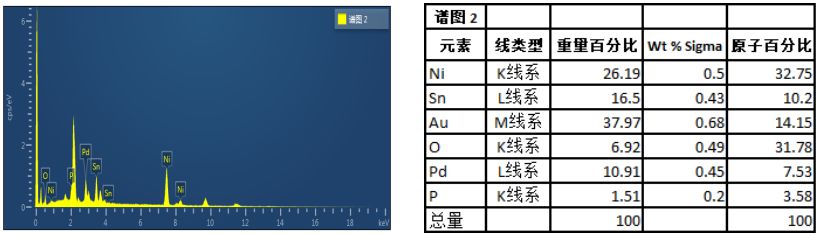
说明:
对焊盘未润湿位置进行EDS分析,检出Ni、Au、Sn、Pd、O、P元素,表明未润湿位置曾有少量Sn附着,但焊盘表面的金镀层仍存在,即该位置在焊接过程中Au层未能熔融。
# 4 钢网开口分析

说明:
1.未润湿不良点主要集中于上图所示位置(对向有少部分),该位置是助焊剂挥发气体排出的主要通道;
2.开口隔断仅0.25mm,助焊剂受热后溢出且锡膏熔化汇集,进一步导致该通道的“排气”作用减弱,造成内部气流主要引向图示不良点位,形成“抬起”效应。
No.3分析结果
未润湿失效点位置具有倾向性,基本集中在左下角位置,如下图所示:
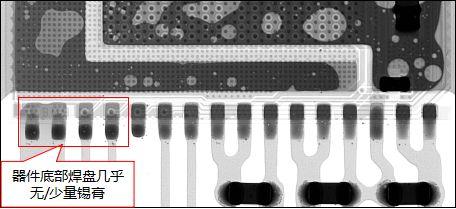
未润湿的焊盘表面金层未溶蚀,说明锡膏熔化之后,该焊盘未与液态锡充分接触,进而芯片引脚部位发生翘起,锡膏与焊盘分离;
PCB板材为铝材质,器件封装主要为玻璃材质,二者都不容易发生形变,排除因形变引发的翘起;
通过对钢网开口的分析判断,目前失效点位置是受助焊剂挥发气流影响最大的位置。大量挥发的气体,会将芯片“抬起”,造成图示位置的轻微起翘。
综合以上分析:
推测该焊接不良是由于大量助焊剂气体挥发,其产生的气泡集中由排气孔散出,造成芯片起翘,使芯片焊盘与锡不能充分接触造成虚焊。
No.4 改善方案
建议改善钢网开口方式
1.内部九宫格开口;
2.增加隔断,所有的隔断宽度增加为0.4mm。

新阳检测中心有话说:
本篇文章介绍了PCBA焊接润湿不良分析。如需转载本篇文章,后台私信获取授权即可。若未经授权转载,我们将依法维护法定权利。原创不易,感谢支持!
新阳检测中心将继续分享关于PCB/PCBA、汽车电子及相关电子元器件失效分析、可靠性评价、真伪鉴别等方面的专业知识,点击关注获取更多知识分享与资讯信息。
审核编辑 黄宇
-
PCBA加工中产生不良的原因有哪些?2026-04-03 1561
-
PCBA加工常见质量问题揭秘:焊接不良与解决方案2024-12-13 2081
-
常见PCBA锡膏焊接不良现象有哪些?2024-10-12 2912
-
PCBA焊接不良现象中假焊产生的原因和危害有哪些?解决假焊问题的方法2023-12-25 2124
-
BGA焊接出现故障,印制板焊盘润湿不良的原因是什么2023-09-08 1141
-
PCB的焊盘润湿性不良的分析过程2020-10-27 9010
-
PCBA焊接中液态钎料润湿的达成条件和哪些影响因素2020-06-05 5367
-
PCBA加工润湿不良的主要原因有哪些2020-05-28 1496
-
PCBA加工焊接的不良现象有哪些?原因分析2019-10-09 11102
-
PCBA加工润湿不良的原因_PCBA加工润湿不良的解决办法2019-09-10 2476
-
铝合金表面镀化学镍处理焊接不良问题2014-10-14 4179
-
表面贴装焊接的不良原因和防止对策2006-04-16 1070
全部0条评论

快来发表一下你的评论吧 !

