

一文了解DPC陶瓷基板工艺流程
制造/封装
描述
一、直接镀铜DPC工艺简介
直接镀铜陶瓷基板(Direct Plating Copper, DPC)是在陶瓷薄膜工艺加工基础上发展起来的陶瓷电路加工工艺。以氮化铝/氧化铝陶瓷作为线路的基板,采用溅镀工艺于基板表面复合金属层,并以电镀和光刻工艺形成电路。
其工艺流程为:首先利用激光在陶瓷基片上制备通孔(孔径一般为60μm~120μm),随后利用超声波清洗陶瓷基片;采用磁控溅射技术在陶瓷基片表面沉积金属种子层(Ti/Cu靶材),接着通过光刻、显影完成线路层制作;采用电镀填空和增厚金属线路层,并通过表面处理提高基板可焊性与抗氧化性,最后去干膜、刻蚀种子层完成基板制备。
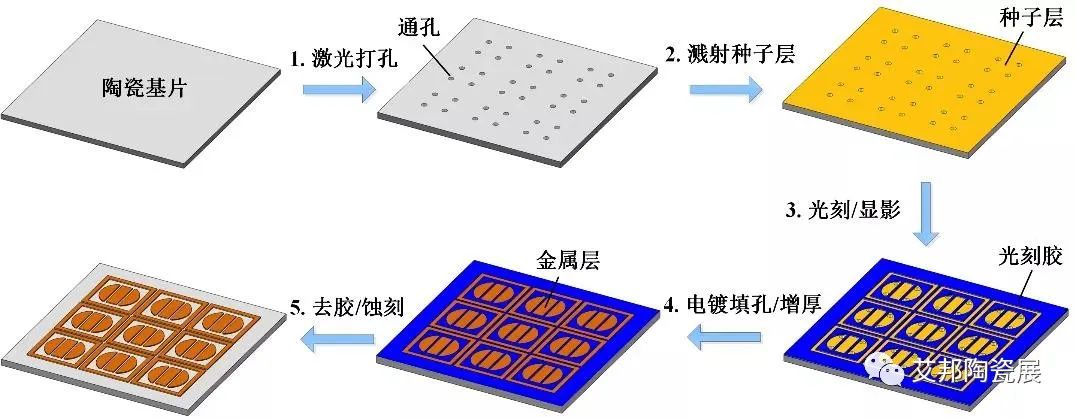
图 DPC陶瓷基板工艺流程
DPC陶瓷基板制备前端采用了半导体微加工技术(溅射镀膜、光刻、显影等),后端则采用了印刷线路板(PCB)制备技术(图形电镀、填孔、表面研磨、刻蚀、表面处理等),因此具有以下优势特点:
1)采用半导体微加工技术,陶瓷基板上金属线路更加精细(线宽/线距低至30μm~50μm,与线路层厚度相关),因此DPC陶瓷基板非常适合对精度要求较高的微电子器件封装;
2)采用激光打孔和电镀填孔技术,实现了陶瓷基板上下表面垂直互连,可实现电子器件三维封装与集成,降低器件体积;
3)采用电镀生长控制线路层厚度(一般为10μm~100μm),并通过研磨降低线路层表面粗糙度,满足高温、大电流器件封装需求;
4)低温制备工艺(300℃以下)避免了高温对基片材料和金属线路层的不利影响,同时也降低了生产成本。
然而,DPC也存在一些不足:
1)金属线路层采用电镀工艺制备,环境污染严重;
2)电镀生长速度低,线路层厚度有限;
2)金属层与陶瓷间的结合强度较低,产品应用时可靠性较低。
在技术改进上,北京大学深圳研究生院吴忠振副教授携手泰安巨浪电子推出基于超高功率PVD技术的DSC(Direct Sputtering Ceramic)陶瓷基板金属化新技术,直接在陶瓷基板表面沉积一定厚度的金属导电层,实现高结合强度和绿色生产。具体介绍可点击查看前文:陶瓷基板金属化有了新技术:DSC!
此外,利用DPC陶瓷基板的技术优势(高图形精度、垂直互连等),可以通过电镀增厚等技术制备围坝,可得到含围坝结构的三维陶瓷基板,例如武汉利之达采用电镀键合、免烧陶瓷直接成型等技术制备含金属或陶瓷围坝的三维陶瓷基板(3DPC)。陶瓷基板和围坝一体化成型为密封腔体,结构紧凑,无中间粘结层,气密性高,且围坝结构形状可任意设计,目前已经成功应用与深紫外LED封装和VCSEL激光器封装。 编辑:黄飞
-
为什么你需要一块DPC陶瓷基板2021-01-18 1317
-
一文看懂铝基板生产工艺流程2018-02-27 45836
-
陶瓷基板工艺流程2019-05-21 14326
-
覆铜基板工艺流程简介2021-12-13 3669
-
DPC陶瓷基板主要加工工艺流程2022-07-14 12440
-
DPC陶瓷基板表面研磨技术2023-04-12 3821
-
带你了解什么是覆铜陶瓷基板DPC工艺2023-05-23 3395
-
什么是覆铜陶瓷基板DPC工艺?2023-06-06 2295
-
高温下DPC(磁控溅射工艺)覆铜陶瓷基板的设计和应用2023-06-19 2872
-
DPC(磁控溅射)陶瓷基板的铜面处理及其对性能的影响2023-06-25 2222
-
为什么DPC比DBC工艺的陶瓷基板贵?2023-07-28 2797
-
什么是DPC陶瓷基板?DPC陶瓷基板有哪些特点?2023-12-07 3711
-
陶瓷基板技术PK:DBC vs DPC,你站哪一边?2024-06-27 4774
-
为什么选择DPC覆铜陶瓷基板?2025-04-02 1352
-
DPC陶瓷基板电镀铜加厚工艺研究2025-07-19 1209
全部0条评论

快来发表一下你的评论吧 !

