

芯片制造光刻步骤详解
电子说
描述
芯片前道制造可以划分为七个环节,即沉积、涂胶、光刻、去胶、烘烤、刻蚀、离子注入。主要工艺可分为沉积、光刻、刻蚀、离子注入。根据公开资料, 光刻耗时环节占晶圆制造全流程的40%到50%。光刻工艺成本占芯片生成成本的30% 。
光刻步骤
沉积工艺后,在硅片或晶圆上形成了一层薄膜,下一步就是光刻。 光刻所用到的工具主要是光掩膜,***还有光刻胶 。
光掩模是芯片的蓝图,是一张刻有集成电路版图的玻璃遮光板。光刻胶别称光致抗蚀剂,在光刻工艺中用作抗腐蚀涂层材料,也是把光影化为现实的一种胶体。
***又名掩膜对准曝光机,曝光系统,光刻系统等,采用类似照片冲印的技术,把掩膜版上的精细图形通过光线的曝光印制到硅片(或晶圆)上。
光刻原理类似于日常使用相机进行拍摄。光刻胶类似于相机胶片的感光材料,能将镜头所对准的影像转移到塑胶底片上并最终在相纸上显现出来。一般的光刻工艺主要经历以下流程,
1.旋涂光刻胶,使光刻胶均匀分布在衬底表面。
2.软烘使溶剂从光刻胶中挥发出来。从而提高光刻胶衬底上的附着性。
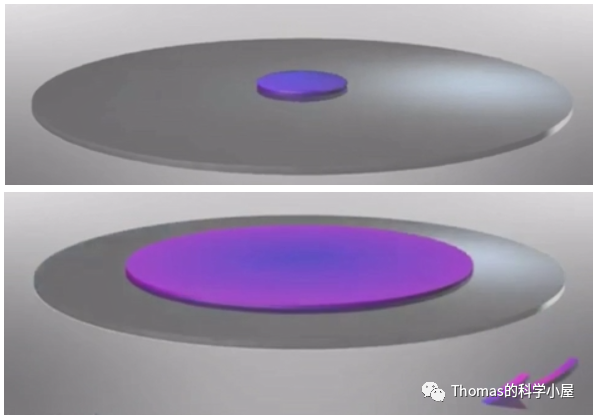
3.曝光,光刻胶中的感光剂会发生光化学反应。被照射区域化学成分发生变 化 。

4.显影正光刻胶的感光区,负光刻胶的非感光区,会溶解于显影液中,以形成图形 。

5.后烘可以除去光刻胶中剩余的溶剂。增强光刻胶对硅片表面的附着力 。

光刻胶
光刻胶(photoresist)是一类对辐照敏感,由碳、氢、氧等元素组成的有机高分子化合物 。在其中含有一种可以由特定波长的光引发化学反应的感光剂(PAC:Photoactive compound)。光刻胶对黄光不感光,所以半导体光刻工艺车间都使用黄光照明。
按照曝光后化学反应原理和溶解度变化分类,光刻胶可以分为正性光刻胶和负性光刻胶。(如下图所示,UV辐射下,正胶和负胶留下的图形并不相同)

光刻胶在经过曝光后, 正性光刻胶被曝光区域可溶于显影液,留下的光刻胶薄膜的图形与掩膜版相同 。正胶通常含有三种主要成分,酚醛树脂,感光剂和有机溶剂。曝光前的光刻胶基本上不溶于显影液。
在曝光时,正胶因为吸收光能而导致化学结构发生变化(如下图所示,正胶发生断链),在显影液中的溶解度比曝光前高出很多(约100倍)。显影后,感光部分光刻胶被溶解去除。

负性光刻胶被曝光区域不溶于显影液,所形成的图像与掩膜版相反 。负胶是一种含有感光剂的聚合物。曝光时,感光剂将吸收的光能转变为化学能而引起链反应,聚合物分子间发生交联(如下图所示),形成不溶于显影液的高分子交联聚合物。显影后,未感光部分的光刻胶被去除。

总结
光刻的原理比较简单,但是在实际集成电路制造方面比较繁琐。随着制程工艺进一步缩小,从早期的2um以上,到现在的7nm以下,以及最新的Intel 20A技术路线图,对光刻的要求也越来越高。
-
【「大话芯片制造」阅读体验】+ 芯片制造过程和生产工艺2024-12-30 3406
-
单片机晶圆制造工艺及设备详解2018-10-15 7197
-
魂迁光刻,梦绕芯片,中芯国际终获ASML大型光刻机 精选资料分享2021-07-29 70632
-
一文带你了解芯片制造的6个关键步骤2022-04-08 23239
-
看懂光刻机:光刻工艺流程详解2018-04-08 172857
-
芯片光刻技术的基本原理及主要步骤2020-11-11 26472
-
芯片制造全流程及详解2021-12-10 18429
-
制作芯片的七个步骤2021-12-15 18988
-
芯片制造工艺流程步骤是什么2021-12-22 36277
-
芯片制造公司光刻机的情况2021-12-30 5362
-
芯片制造的6个关键步骤2022-03-23 8981
-
半导体制造工艺之光刻工艺详解2023-08-24 3484
-
芯片制造步骤解析2023-12-18 687
-
芯片制造:光刻工艺原理与流程2025-01-28 4952
-
芯片制造的步骤2025-11-14 874
全部0条评论

快来发表一下你的评论吧 !

