

半导体离子注入工艺讲解
描述
阱区注入的工艺说明如下图所示,是高能量离子注入过程,因为它需要形成阱区建立MOS晶体管。NMOS晶体管形成于P型阱区内,而P型晶体管形成于N型阱区。

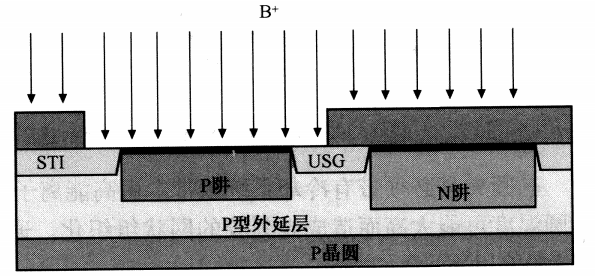
为了防止结串通的离子注入技术称为中度阱区注入,用来抑制结击穿效应,因为结击穿将造成晶体管崩溃。大角度倾斜(Large angle tilt,LAT,通常为35°~45°)注入或大倾角注入用来抑制集成电路芯片的结击穿问题。
临界注入也称为VT调整注入,是一个低能量、低剂量的注入过程。临界注入决定了一定电压下可以开启或关闭MOS晶体管,这个电压称为临界电压(VT)。阈值决定MOSFET在什么电压下可以打开或关闭,它可以表示为:

VT表示栅极材料和半导体衬底之间的电位差。在多晶硅栅情况下,它由多晶硅的掺杂浓度控制。表示表面电荷,它由预氧化清洁和栅氧化过程所决定;表示耗尽电荷量。通过离子注入调节VT,可以控制多数载流子浓度Nc。是单位的栅极电容,由栅介质材料及栅极介电层厚度L决定。是衬底的费米电势。阈值电压是MOSFET最重要的参数之一,而且片离子注入调制是离子注入最关键的工艺之一。
例如,一些旧的电子元器件需要12V的直流供电电压,而大部分的电子电路需要5V或3.3V即可工作,大部分先进集成电路芯片在1.0V就可以工作。低功耗IC芯片的工作电压甚至低于0.4Vo这些操作电压必须比临界电压高才能确保晶体管开启或关闭,然而它们却不能高于使栅极氧化层击穿。下图显示了CMOS集成电路芯片的阈值电压调整注入,阈值电压调整注入通常使用与阱区注入相同的注入机,都是在使能量注入工艺中进行,如下图所示。
多晶硅需要离子重掺杂以降低电阻系数,这可以通过在沉积过程中使用临场掺杂方式将硅的反应气体和掺杂物气体一同引入CVD反应器中,或者利用高电流多晶硅掺杂离子注入实现。对于先进的互补型CMOS芯片,注入掺杂普遍使用,因为注入掺杂可以分别掺杂P型晶体管的多晶态栅极和N型多晶态栅极。一般情况下,P型晶体管的多晶硅栅是P型重掺杂,而N型晶体管的多晶硅栅是N型重掺杂,这样可以使元器件有很好的性能控制。这些形成局部连线的多晶硅导线也将产生PN结界面,而这个PN结位于CMOS电路的相邻PMOSFET栅极与NMOSFET栅极的交汇处。PN结必须在后续的金属硅化物过程中,通过在多晶硅导线上方形成金属硅化物加以短路,否则将在相邻栅极之间形成非常高的电阻。
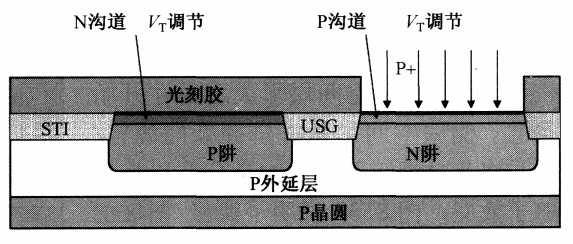
一般情况下,多晶硅离子注入需要两个光刻版,一个用于NMOS,另一个用于PMOS。为了降低生产成本,多晶硅补偿反掺杂技术已经发展并已在IC生产中应用。在没有光刻版的条件下,它首先采用离子注入将整个晶圆掺杂成重N型,然后图形化晶圆曝光显示出PMOS并掺杂成P型多晶硅层。P型掺杂浓度非常高,是通过杂质补偿将多晶硅从N型反转成P型的。由于等离子掺杂系统可以实现高掺杂浓度,所以已开发用于实现这种工艺。下图所示为重P型(硼掺杂)多晶硅反转工艺。
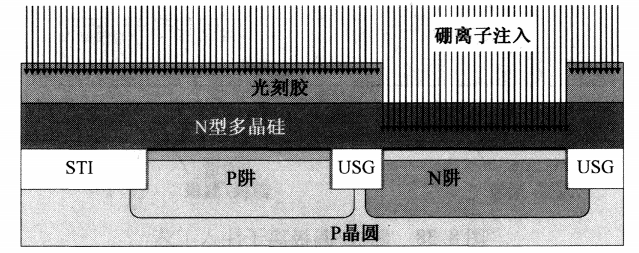
审核编辑:汤梓红
-
芯片离子注入后退火会引入的工艺问题2025-04-23 2486
-
离子注入工艺中的重要参数和监控手段2025-01-21 4441
-
离子注入的目的及退火过程2025-01-02 3089
-
SiC的离子注入工艺及其注意事项2024-11-09 2353
-
什么是离子注入?离子注入的应用介绍2024-02-21 8293
-
离子注入仿真用什么模型2023-12-21 2770
-
什么是离子注入?离子注入相对于扩散的优点?2023-12-11 8177
-
半导体离子注入工艺评估2023-07-07 8424
-
离子注入工艺资料~还不错哦~2012-08-01 16458
-
离子注入的特点2011-05-22 5514
-
铒离子注入碳化硅后的射程分布和射程离散2010-04-22 2456
全部0条评论

快来发表一下你的评论吧 !

