

案例分享第九期:氮化铝陶瓷切割实例
描述
氮化铝陶瓷的特性
大多数陶瓷是离子键或共价键极强的材料,具有较高的绝缘性能和优异的高频特性,同时线膨胀系数与电子元器件非常相近,化学性能非常稳定且热导率高,是电子封装中常用的基板材料。
长期以来,绝大多数大功率混合集成电路的基板材料一直沿用Al₂O₃氧化铝和BeO氧化铍陶瓷。但Al₂O₃基板的热导率低,热膨胀系数和硅不太匹配。BeO虽然具有优良的综合性能,但其较高的生产成本和剧毒的缺点限制了它的应用推广。因此,从性能、成本和环保等因素考虑,二者已不能完全满足现代电子功率器件发展的需要。
与之相比,氮化铝陶瓷导热率可以达到氧化铝陶瓷基覆铜板的10倍左右,线性膨胀系数与硅很接近,非常适用于半导体基板和结构封装材料。
多层陶瓷基板多采用氮化铝陶瓷基片来做,工艺一般分高温共烧HTCC制作工艺和低温共烧LTCC制作工艺。氮化铝陶瓷覆铜板按照金属层厚度不同,采用的工艺一般有所不同。一般要做厚铜800um~100um, 多采用AMB活性钎焊工艺,金属结合力更好;薄铜多采用DPC制作工艺,铜层较薄,最薄可以做1um的铜层,适合做精密线路。
以下是应用西斯特树脂刀切割氮化铝陶瓷覆铜板实例。
案例实录
►
测试目的
1、测试正面背面切痕情况。
2、测试崩缺卷铜情况。
►
材料情况
切割产品 | 陶瓷覆铜板 |
切割道表面材质 | 氮化铝陶瓷+铜 |
产品尺寸 | 115*75mm |
产品厚度 | 0.35mm |
胶膜类型 | 蓝膜 |
►
工艺参数
切割工艺 | 单刀切断 |
设备型号 | DAD321 |
主轴转速 | 28K rpm |
进刀速度 | 5mm/s |
刀片高度 | 0.05mm |
►
样刀准备
SSTRP 1A8-SDC-500-50-M 56*0.15*40
►
样刀规格
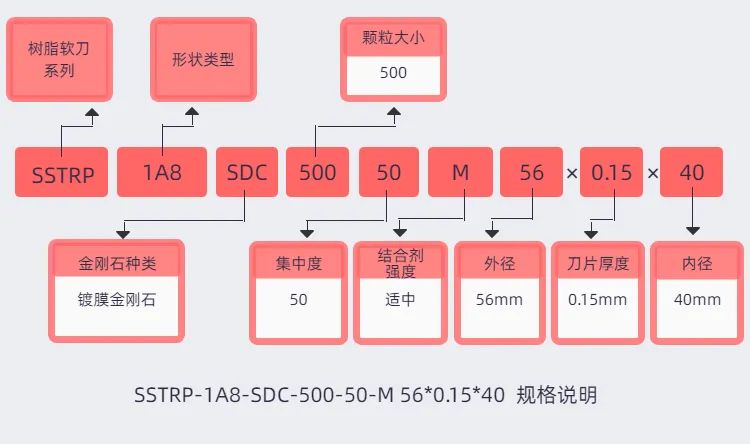
刀片尺寸 | 56*0.15*40 |
金刚石粒度 | 500# |
结合剂强度 | M(中) |
集中度 | 50 |
►
测试结果
1、正崩、侧崩、背崩均在崩缺控制范围内,正崩<25μm,侧崩<25μm,背崩<50μm。
2、倒膜检查背面整体刀痕平滑,侧面刀痕良好。


正面效果


背面效果

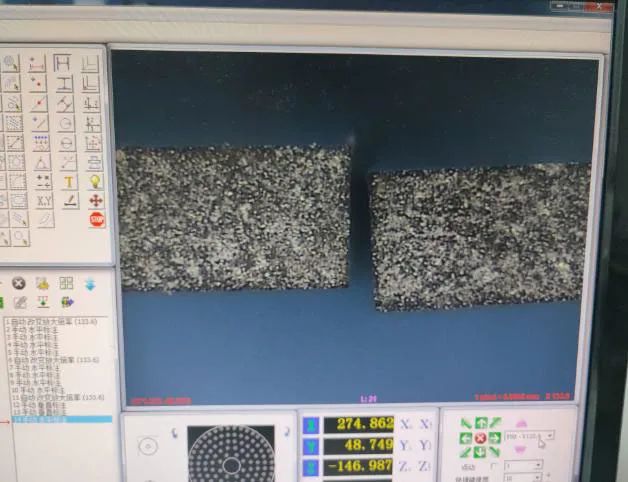
侧面效果
西斯特科技
深圳西斯特科技有限公司 (简称西斯特SST) ,以“让一切磨削加工变得容易”为主旨,倡导磨削系统方法论,2015年金秋创立于深圳,根植于技术创新的精神,屹立于创造价值、追求梦想的企业文化。
基于对应用现场的深度解读、创新性的磨具设计和磨削系统方法论的实际应用,西斯特秉承先进的磨削理念,践行于半导体、消费电子、汽车零部件等行业,提供高端磨具产品以及“切、磨、钻、抛”系统解决方案,在晶圆与封装基板划切、微晶玻璃和功能陶瓷磨削、汽车零部件精密磨削等领域应用广泛。
西斯特科技始终以先进的技术、创新的产品、优质服务的理念,引领产业革命,创造无限可能。
- 相关推荐
- 热点推荐
- 切割
-
氮化铝陶瓷基板:高性能电子封装材料解析2025-03-04 2293
-
半导体划片机助力氧化铝陶瓷片切割:科技与工艺的完美结合2023-12-06 1825
-
氮化铝陶瓷基板的导热性能在电子散热中的应用2023-06-19 2418
-
成长计划知识赋能 | 第九期:渐进式深入理解OpenHarmony系统2023-03-25 894
-
氮化铝陶瓷基板的金属化工艺介绍2023-02-07 3201
-
GD32 ARM 设计硬件全流程 I 第九期:布局的操作技巧、优化方法及三维模型的检查设计2022-11-17 1511
-
了解氮化铝陶瓷基板的金属化是否通过化学镀铜方式2022-08-25 2892
-
硬件实战教程(第九期)常用运放电路原理图讲解92021-06-18 2557
-
【视频教程】单片机实战教程(第九期)M1A板子走线32021-05-08 2873
-
开关电源免费教程(第九期)LLC死区时间对DS波形的影响2021-05-06 5787
-
【视频教程】单片机新手教程(第九期)STM32集成开发环境32021-04-23 3621
-
斯利通助力氮化铝陶瓷基板生产行业健康发展2020-11-16 1542
-
第九期:字符串替换2018-09-11 2725
-
在IGBT模块中氮化铝陶瓷基板的应用如何?2017-09-12 8374
全部0条评论

快来发表一下你的评论吧 !

