

IGBT模块的封装形式及失效形式
描述
贞光科技从车规微处理器MCU、功率器件、电源管理芯片、信号处理芯片、存储芯片、二、三极管、光耦、晶振、阻容感等汽车电子元器件为客户提供全产业链供应解决方案。
作为新能源发电、电动汽车和智能电网的重要单元,IGBT模块得到越来越广泛的应用。IGBT器件封装形式主要有焊接式和压接式两种,其中焊接式发展成熟,应用广泛。IGBT模块的封装结构比较复杂,是由多种材料组合封装而成,IGBT模块的内部发热量随着封装电流密度的增加、功率的升高、体积的减小而成倍的增加,在温度或功率循环等复杂且多变的工作状态下持续正常运行时,对其可靠性提出了更高的要求。
1.IGBT模块主要失效形式
IGBT模块主要包含两类失效形式:芯片级失效、封装级失效。芯片级失效有辐射损伤、电子迁移、电过应力、静电放电、离子污染几种情况,芯片级故障可使模块在较短时间内失去正常工作的能力。随着不断提升的器件制造工艺以及晚上的保障措施,芯片级失效已经大大降低。

IGBT模块封装为层状结构,主要由芯片、芯片焊料层、上铜层、陶瓷层、下铜层、基底焊料层、基板组成。其中最脆弱的部位分别是用于连接固定的焊料层和芯片间电气连接的键合线。
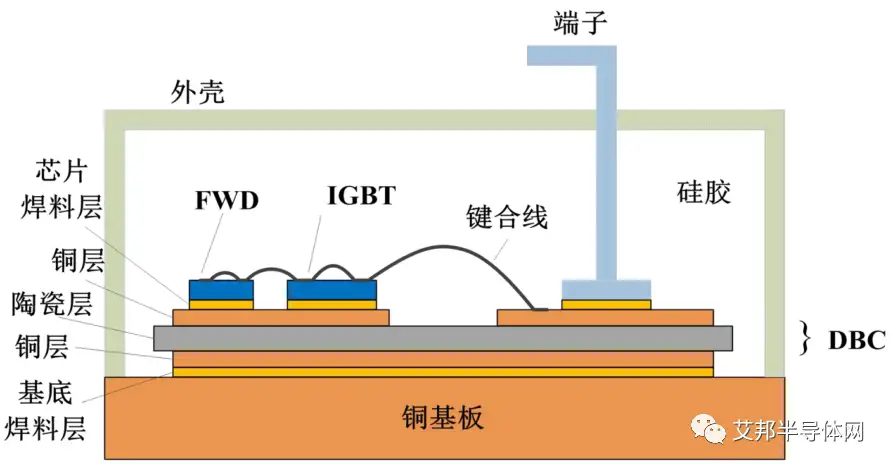
图 IGBT模块结构封装级失效则是一个缓慢积累的过程,与材料在热循环下的损伤积累有关,已成为IGBT模块目前最主要的失效形式。一般情况下,如果IGBT结温温度波动较小,即△Tj≤80K,更易于引起焊料层的老化,降低模块的散热作用,增加模块的热阻,甚至造成模块疲劳失效的后果;如若IGBT结温温度波动相对较大,即△Tj≥100K,更易引发铝键合线的脱落、开裂等失效形式。
2.IGBT模块封装级失效
IGBT模块封装级失效分别为焊料层失效和键合线失效。
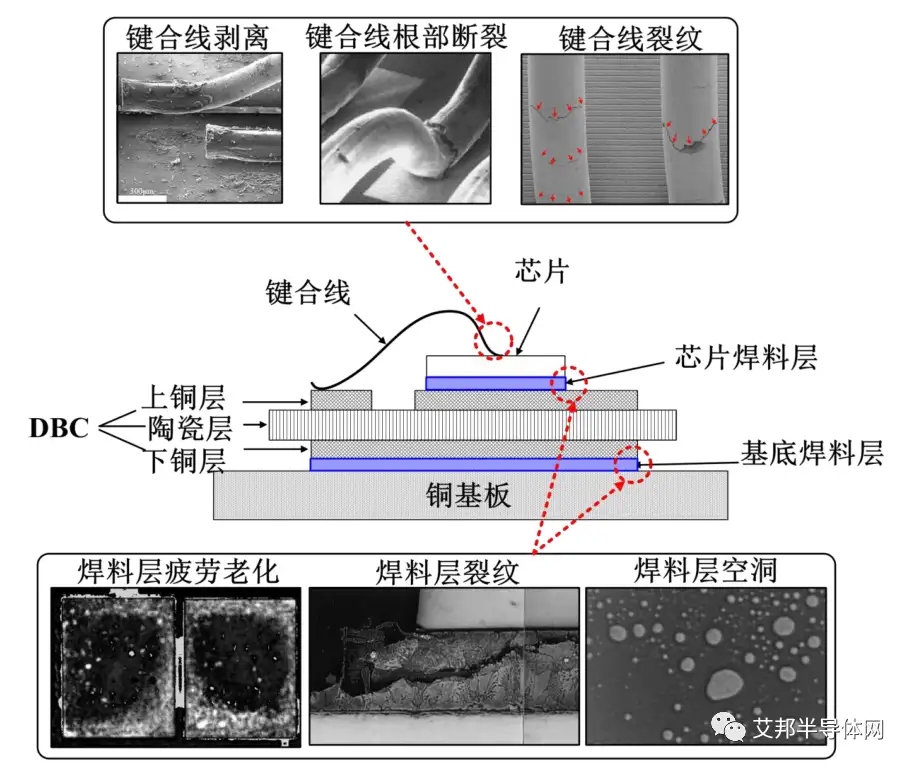
1)键合线故障
键合线在IGBT模块的封装中采用并联多根焊接方式,可进一步加强每层结构间的电流的传输。当前超过90%的芯片均使用超声引线键合技术使IGBT芯片和FWD(Fly Wheel Diode,流二极管)互连封装。由于键合线和模块芯片的热膨胀系数因材料各异而不同,从而成为引发键合线故障的主要因素。
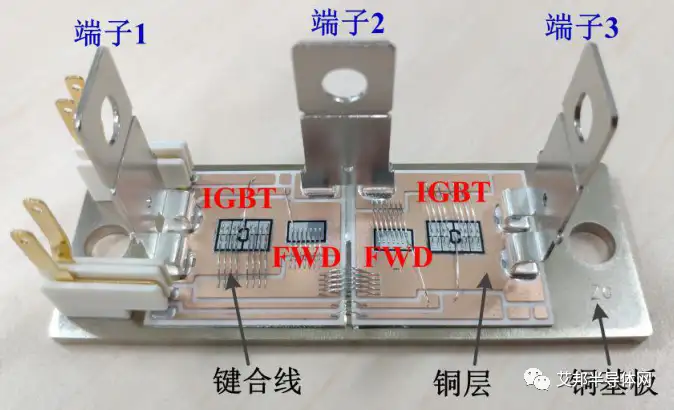
而模块在正常工作运转时,受温度变换产生的热应力的影响,键合线会发生剥离的现象,如果损伤积累严重,会引发故障的产生。只要有一根键合线发生损伤老化时,那么将增大传输到其他键合线的电流,引起模块热量的升高,促使IGBT模块进一步老化失效。
键合线的失效模式多样,常见的键合线故障部位为键合线和芯片间的剥离、键合线和DBC陶瓷覆铜板表面连接处底部脱落、键合线根部断裂以及键合线裂纹等。
2)焊料层故障
IGBT模块的层状材料间的焊料层一方面是用于电气连接、固定支撑,另一方面是形成整个模块的散热通道,为实现模块的功能提供了可靠的连接支撑的作用。
表 IGBT模块材料参数

随着IGBT的耗散功率和开关频率不断增大,以及工作环境严苛,使得IGBT模块产生大量的热量,由于模块内的热量无法及时得到释放,从而引起模块内部温度升高。当工况温度变换时,IGBT内各层材料因具有各不相同的热膨胀系数,在不断的热流冲击下,各层状结构的形变程度不同,受限于彼此间的固定约束,层状结构间发生周期变化的剪切应力,焊料层将发生不可恢复塑性形变,随着循环次数的不断增加,不可逆的塑性形变将不断积累,从而导致焊料层发生损伤变形直至失效。
焊料层失效主要分为裂纹和空洞两种失效形式。一般情况下,焊料层发生初步损伤时并不能对模块的正常运行产生明显的影响,但损伤的积累会引发IGBT模块内部热量不平衡,从而发生热集中效应。最终可能会导致焊料层断裂甚至整个IGBT模块失效。
IGBT模块应用的趋势是功率密度更大、开关频率更高、体积更小,其安全可靠性也受到了更多的关注。
*免责声明:本文由作者原创。文章内容系作者个人观点,贞光科技二次整理,不代表贞光科技对该观点赞同或支持,仅为行业交流学习之用,如有异议,欢迎探讨。
-
DC/DC模块电源封装形式2013-04-28 2996
-
IGBT有哪些封装形式?2019-08-26 6701
-
贴片电容失效有几种形式2020-03-17 7015
-
电子元器件的封装形式,元器件封装形式2009-05-05 1952
-
晶闸管的封装形式2009-09-19 4693
-
微型减速电机齿轮的失效形式2021-01-01 2883
-
如何选择电阻电容的封装形式?2022-02-09 1055
-
IGBT功率模块封装结构及失效机理2022-09-07 7570
-
igbt单管和igbt模块的区别 igbt工作原理和作用2023-02-19 14667
-
IGBT失效模式和失效现象2023-02-22 1199
-
IGBT模块主要失效形式2023-05-16 2539
-
国产igbt模块品牌2023-07-22 4348
-
IGBT的失效模式与失效机理分析探讨及功率模块技术现状未来展望2023-11-23 7489
-
常见的齿轮失效有哪些形式?失效的原因是什么?如何解决?2023-12-20 7804
-
IGBT模块的封装形式类型2025-09-05 2414
全部0条评论

快来发表一下你的评论吧 !

