

铝等离子体蚀刻率的限制
电子说
描述
引言
随着集成电路互连线的宽度和间距接近3pm,铝和铝合金的等离子体蚀刻变得更有必要。为了防止蚀刻掩模下的横向蚀刻,我们需要一个侧壁钝化机制。尽管AlCl和AlBr都具有可观的蒸气压,但大多数铝蚀刻的研究都使用Cl基蚀刻化学物质。当在等离子体放电中分解时,CCl为还原物质提供了来源,并用于去除表面氧化物和Cl,与下面的Al反应。
最近一项通过He-BC13-C12-CHC13的化学方法对铝蚀刻的研究表明,铝蚀刻速率随着氯气流的增加而增加,并且对施加的射频功率不敏感。英思特利用BClr CI2、SiClr C12和He-SiClClcCl2的化学方法,研究了纯Al薄膜的等离子体蚀刻率行为。
实验与讨论
本研究中使用的不锈钢腔室直径30厘米,高22厘米,蚀刻的切片位于较低的射频供电电极上。两个电极直径15厘米,由6061硬质阳极氧化铝构成。工艺气体通过顶部“淋浴头”模式的接地电极进入。电极间距为4 cm,电极温度均保持在40℃。使用针阀调整流速,并从隔离室的压力上升速率中确定。工艺压力使用节流阀进行控制,并使用电容压力计进行测量。
图1中看到的铝蚀刻速率和电压(即离子能量)之间的密切相关性与等离子体实验的结果形成对比,后者发现铝蚀刻速率与离子轰击能量无关。这种明显不一致的原因在于是否存在蚀刻残留物。等离子体束实验使用纯氯气等离子体,不可能去除掩模残余物。
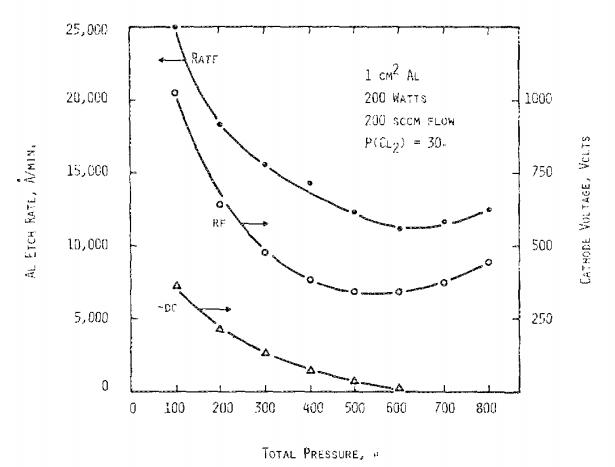
图1:AI蚀刻率,射频峰峰电压,发展降压与总压碳化硅
我们发现,总气体流量超过200sccm导致了铝蚀刻过程中Cl2消耗的问题。假设氯气在AI上的粘附系数统一,最大可能的蚀刻速率等于2/3 ,Cl通量与氯气分压成正比。对于P(CI2)= 30fl,我们计算出最大的铝蚀刻率为5X105A/min。参见图2显示,测量的蚀刻速率仅为1.5X104A/min。最大可能的蚀刻速率和实际蚀刻速率之间的差异系数为30,这进一步证实了我们的假设,即实验结果是无载荷蚀刻条件的特征。
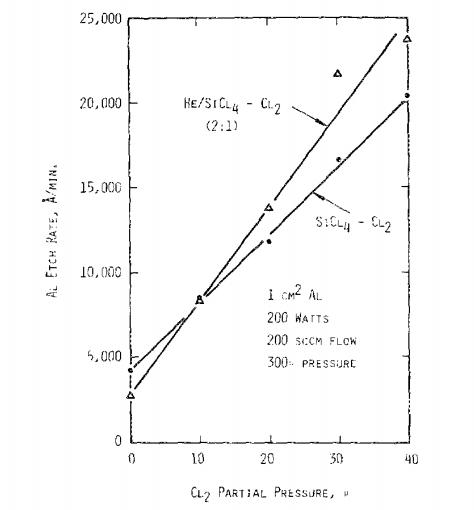
图2
结论
英思特通过使用蚀刻化学物质实验研究表明,Al的等离子体蚀刻速率由两个因素决定:(1)蚀刻表面上形成的残余物(例如si的浓度),(2)CI2的冲击通量增加了离子的能量,从而在蚀刻表面减少了这些掩模残留物的浓度,从而增加了蚀刻率。这些掩模残留物的存在,被认为是实现可控蚀刻工艺的关键。
江苏英思特半导体科技有限公司主要从事湿法制程设备,晶圆清洁设备,RCA清洗机,KOH腐殖清洗机等设备的设计、生产和维护。
审核编辑:汤梓红
-
等离子的基本属性_等离子体如何发生2025-01-03 3434
-
等离子体的定义和特征2024-11-29 8976
-
什么是电感耦合等离子体,电感耦合等离子体的发明历史2024-09-14 3664
-
低温等离子体技术的应用2023-02-27 2185
-
精确跟踪芯片蚀刻过程,用高分辨率光谱仪监测等离子体2022-09-21 1474
-
真空等离子清洗机的制造商正在引入氧和氢等离子体来蚀刻石墨烯2022-06-21 1703
-
等离子体蚀刻和沉积问题的解决方案2022-05-19 2669
-
等离子体应用2022-05-18 3826
-
TDK|低温等离子体技术的应用2022-05-17 3164
-
金属蚀刻残留物对对等离子体成分和均匀性的影响2022-05-05 1614
-
低温等离子体废气处理系统2022-04-21 12460
-
微波标量反射计可测量大范围的等离子体密度2019-06-10 1586
-
PCB板制作工艺中的等离子体加工技术2018-09-21 2986
-
PCB电路板等离子体切割机蚀孔工艺技术2017-12-18 3178
全部0条评论

快来发表一下你的评论吧 !

