

辐射效应快速概述 – 单事件效应
描述
在这篇博客中,我们将更多地研究通常更临时的单偶效应(SEE)。虽然其中一些单一事件效果可能会造成永久性伤害,但本博客系列的重点将更多地放在非永久性单一事件效果上。这些影响通常会持续很短的时间,之后设备可以恢复正常运行。我们将讨论一些可能仅出于完整性而产生永久影响的 SEE。
回想一下,当设备被放置在恶劣的太空环境中时,它可能会看到可能导致不同类型的不良行为的辐射。在将设备放入空间应用之前,需要了解这些影响。因此,测试在德克萨斯A&M大学的回旋加速器等辐射设施中进行。加州大学伯克利分校也有一个设施。加州大学伯克利分校和德克萨斯A&M大学的这些设施通常用于观察单个事件的影响。
现在让我们来看看各种单个事件效果。当测试这些类型的干扰时,设备暴露在以MeV-cm表示的LET(线性能量转移)表示的某些水平的辐射下2/毫克。通常,应用的LET范围从几MeV-cm2/毫克高达 80 MeV-厘米2/毫克,有时更高。SEE的开始是通过从较低的LET值开始并在监测SEE的同时增加水平来发现的。LET增加以达到SEE的饱和点。根据这些数据,可以生成威布尔拟合曲线,以查看设备的SEE行为的可视化图。此图显示了器件开始显示 SEE 的位置、SEE 如何随着 LET 的增加而增加,以及 SEE 数量不随 LET 的增加而增加的饱和点。就像累积效应测试一样,设备将偏向于正常工作模式,以模拟设备在太空应用中看到的相同条件。在此测试中观察到的单事件效应包括单事件闩锁 (SEL)、单事件翻转 (SEU)、单事件故障中断 (SEFI)、单事件瞬态 (SET)、单事件烧毁 (SEB) 和单事件门破裂 (SEGR)。
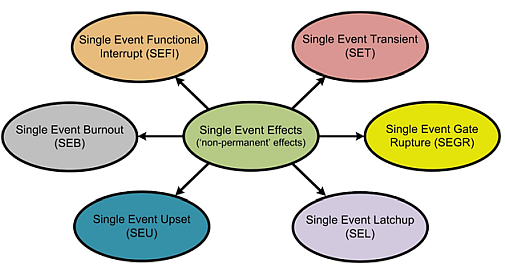
辐射暴露引起的单事件效应
单事件闩锁 (SEL) 几乎与听起来一样,该器件表现出闩锁条件,其中电源电流异常高。通常,这种情况的发生与设备通常仅在这种情况下闩锁时发生的情况非常相似,在这种情况下,来自辐射的离子是导致闩锁的原因。SEL 的一个这样的例子是当离子撞击感应寄生 BJT(双极结型晶体管)时,导致高电流从电源流向地。这种类型的 SEE 可能会导致设备永久损坏,但可以采取措施防止 SEL 造成永久性损坏。如果 SEL 没有发生永久性损坏,则设备的电源循环可以将设备恢复到正常运行。
单事件翻转(SEU)是在辐射暴露期间发生的软错误,其中设备可以快速恢复。这可能是配置寄存器中的位不安或多位不安。这是非永久性的,持续时间很短。这些不安不需要设备重置即可恢复正常运行。
单事件故障中断 (SEFI) 也是一个软错误,但在这种情况下,设备可以重置清除设备设置、以某种可检测的方式发生故障或完全锁定。在SEFI的情况下,设备可能需要复位才能恢复正常运行,但不需要电源循环。
单事件瞬变(SET)是由离子冲击引起的电路中节点上的短暂电压尖峰。在这种情况下,它可能是诸如输出电压瞬时增加的驱动器或放大器的输出。此类事件本质上是暂时的,设备在短时间内恢复正常运行,无需设备重置或电源重启。瞬态可以穿过器件,并影响信号链中的下一个器件。
单事件烧毁(SEB)是指离子撞击导致在集成电路的一小部分区域产生高电流。高电流会导致设备损坏,并可能导致灾难性故障。通常,这些类型的SEE与功率器件一起出现。
单事件栅极破裂 (SEGR) 是指离子撞击导致 MOSFET 栅极氧化物退化,导致电流流过晶体管的栅极。该事件可能导致氧化物击穿,从而导致漏电流增加。如果足够严重,MOSFET 可能会损坏到足以使器件不再正常工作并造成灾难性损坏。这些事件通常发生在功率 MOSFET 器件中。
这绝不是对集成电路中辐射暴露产生的各种SEE细节的广泛研究。有许多期刊论文和技术文章提供了有关这些SEE的更多详细信息。出于本博客的目的,讨论保持在较高水平,以简单地概述观察到的 SEE。在接下来的博客中,我们将主要关注 SEL、SEU、SEFI 和 SET,因为它们适用于 ADC 的操作。
随着我们继续讨论,我们将研究这些特定的SEE如何应用于ADC以及如何观察它们。鉴于我在ADC方面的背景,将这两个领域放在一起是一个很好的逻辑联系。我认为一些真实的例子也将有助于说明集成电路发生的辐射效应。
审核编辑:郭婷
-
辐射效应的快速概述2023-06-30 2214
-
ADuM7442S单粒子效应辐射报告2021-05-24 639
-
AD6645S单粒子效应辐射报告2021-05-19 743
-
AD8182S单粒子效应辐射报告2021-05-18 629
-
AD8306S单粒子效应辐射报告2021-05-17 648
-
AD8671S单粒子效应辐射报告2021-05-14 690
-
AD8229S单粒子效应辐射报告2021-05-13 670
-
AD8210S单粒子效应辐射报告2021-04-24 646
-
ADA4096-2S单粒子效应辐射报告2021-04-23 679
-
辐射效应概观2018-10-30 1310
全部0条评论

快来发表一下你的评论吧 !

