

台积电,重新定义晶圆代工
描述
多年来,单片芯片定义了半导体创新。新的微处理器定义了新的市场,新的图形处理器和手机芯片也是如此。到达下一个节点是目标,当晶圆厂运送工作部件时,就宣告胜利了。然而,这种情况正在改变。
现在,半导体创新是由一系列与新封装方法紧密集成的芯片驱动的,所有芯片都运行高度复杂的软件。这些变化的影响是巨大的。深厚的技术技能、基础设施投资和生态系统协作都是必需的。但所有这些如何结合在一起以促进下一件大事的发明呢?让我们看看台积电如何重新定义代工厂以实现下一代产品。
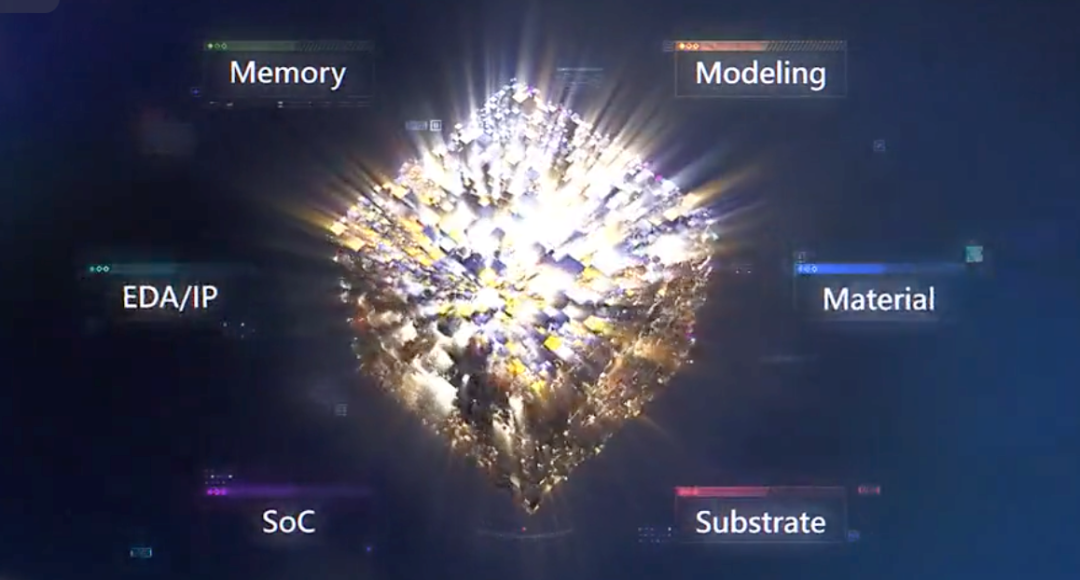
什么是晶圆代工厂?
代工厂的传统范围是晶圆制造、测试、封装和批量交付工作单片芯片。支持技术包括实现工艺节点的工厂、PDK、经过验证的 IP 和 EDA 设计流程。有了这些功能,新产品就可以通过新的单片芯片来实现。几十年来,所有这些都运作良好。但现在,新产品架构的复杂性因通常支持人工智能功能的软件堆栈而放大,需要的不仅仅是单个单片芯片。这种从单片芯片解决方案的转变有很多原因,其结果是多芯片解决方案的显著增长。
关于这种创新范式的转变已经有很多文章。由于时间关系,这里就不展开了。有许多信息来源可以解释这种转变的原因。这是对正在发生的事情的一个很好的总结。
所有这一切的底线是产品创新的定义发生了重大变化。几十年来,该代工厂提供了推动创新所需的技术——新工艺中的新芯片。如今的要求要复杂得多,包括提供新系统功能各个部分的多个芯片(或小芯片)。这些设备通常会加速人工智能算法。有些正在感测环境,或执行混合信号处理,或与云通信。其他公司正在提供大规模的本地存储阵列。
所有这些功能必须以密集封装的形式提供,以适应改变世界的新产品所需的外形尺寸、功耗、性能和延迟。这里要提出的问题是晶圆代工厂现在怎么样了?为所有这些创新提供支持技术需要比过去更多的东西。代工厂现在是否成为更复杂价值链的一部分,或者是否有更可预测的方式?一些组织正在加紧行动。让我们看看台积电如何重新定义代工厂以实现下一代产品。
下一代产品的支持技术
需要新材料和新制造方法来实现下一代产品所需的密集集成。TSMC 已开发出一整套此类技术,并以名为 TSMC 3DFabric的集成封装形式提供。
芯片堆叠是通过称为 TSMC-SoIC(集成芯片系统)的前端工艺完成的。晶圆上芯片 (CoW) 和晶圆上晶圆 (WoW) 功能均可用。转向后端先进封装,有两种技术可用。InFO(集成扇出)是一种chip first的方法,可提供重新分布层 (RDL) 连接,并可选择使用本地硅互连。CoWoS(基板上晶圆芯片)是一种chip last方法,可提供具有可选本地硅互连的硅中介层或 RDL 中介层。
所有这些功能都在一个统一的封装中提供。台积电显然正在扩大代工的含义。台积电还与 IP、基板和内存供应商合作,提供集成的交钥匙服务,为先进封装提供端到端技术和后勤支持。生态系统搭配是成功的关键因素。所有供应商必须有效合作,实现下一件大事。台积电拥有建立强大生态系统来实现这一目标的历史。
前面我提到了基础设施投资。台积电凭借智能封装工厂再次领先。此功能广泛使用人工智能、机器人技术和大数据分析。包装曾经是铸造过程中的事后想法。它现在已成为创新的核心,进一步扩展了晶圆厂的含义。
迈向完整的解决方案
到目前为止讨论的所有功能使我们非常接近完全集成的创新模型,这种模型真正扩展了代工厂的交付能力。但还需要一件作品才能完成这幅画。可靠、集成良好的技术是成功创新的关键要素,但此过程的最后一英里是设计流程。您需要能够定义将使用哪些技术、如何组装这些技术,然后构建和验证半导体系统的模型,并在构建之前验证其是否有效。
要实现这一目标,需要使用多个供应商提供的工具,以及更多供应商提供的 IP 和材料模型。这一切都需要以统一、可预测的方式进行。对于先进的多芯片设计,还有更多的问题需要解决。有源和无源芯片的选择、它们的连接方式(水平(2.5D)和垂直(3D))以及它们如何相互连接只是需要考虑的几个新项目。
台积电在最近的 OIP 生态系统论坛上的声明给我留下了深刻的印象来解决最后一英里的问题。我们可以点击以下视频,查看 Jim Chang 对于3D Fabric的演讲。
全部0条评论

快来发表一下你的评论吧 !

