

半导体离子注入工艺评估
描述
离子注入工艺评估
掺杂物的种类、结深与掺杂物浓度是离子注入工艺的最重要因素。掺杂物种类可以通过离子注入机的质谱仪决定,掺杂物浓度由离子束电流与注入时间的乘积决定。四点探针是离子注入监测中最常使用的测量工具,可以测量硅表面的薄片电阻。离子注入过程中,薄片电阻R由Rs=p/t定义。电阻系数主要由掺杂物浓度决定,厚度方主要由掺杂结深决定,结深由掺杂物离子的能量决定。薄片电阻的测量可以提供有关掺杂物浓度的信息,因为结深可以由已知的离子能量、离子种类和衬底材料估计。
二次离子质谱仪
通过使用一个主要的重离子束轰击样品表面并收集不同时间溅射的二次离子质谱,可测量掺杂种类、掺杂浓度和掺杂浓度的深度剖面。SIMS是一个标准的离子注入测量方法,因为它可以测量并评估所有离子注入过程中的关键因素。但是,它是破坏性的,溅射的光斑尺寸大,速度慢。SIMS被广泛应用于实验室和早期离子工艺发展时期。这种方法不能用于临场检测系统。下图(a)说明了SIMS的工作过程,结深可以通过溅射时间计算。下图(b)显示T1keV11B离子注入在硅片上的SIMS测量结果。
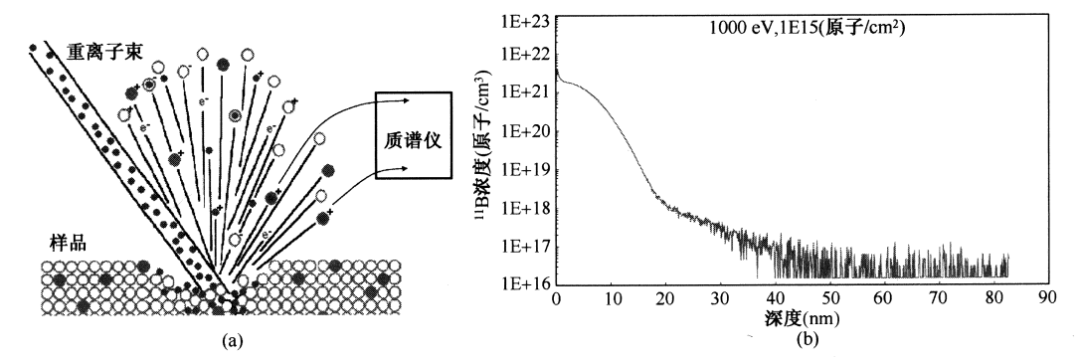
四点探针法
下图所示的四点探针是最常用于测量薄片电阻的工具。通过在两个探针之间施加定量的电流并测量另外两个探针之间的电压差,薄片电阻便能被计算出来。四点探针测量通常在热退火过程后进行,因为热退火能修复损坏的晶体结构并激活掺杂物。由于四点探针直接与晶圆表面接触,所以这种测量方法主要用在测试晶圆上进行工艺过程的发展、验证以及控制。在测量过程中,必须使用足够的力使探针与硅表面接触,这样探针才能穿透10〜20A的原生氧化层与硅衬底真实接触。下图说明了一个离子注入退火后的晶圆利用四点探针法测量的例子。

热波法
另一个常使用的工艺监测过程是热波探针系统。热波系统中,氯激光在晶圆表面上产生热脉冲,而He-Ne探针激光将在同一点测量由加热激光造成的直流反射系数(E)和反射系数的调制量。二者的比例称为热波(ThermalWave,TW)。热波信号与晶体的损伤有关,因为晶体损伤是离子注入剂量的函数。下图所示为热波法系统示意图。
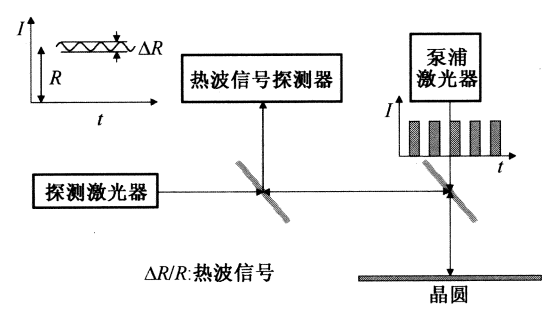
热波测量是在离子注入后的热退火前进行。这是优于四点探针技术的方面,因为四点探针在测量之前需要先进行退火。热波探针的另一个优点是非破坏性测量,所以可以应用在产品晶圆上,而四点探针只能用在测试晶圆上。热波量测的缺点之一是在低剂量时灵敏度较低,例如当神与磷注入的剂量为10的12次方离子/cm2时,10%的剂量变化只能引起热波信号2%的改变。另一个缺点为热波信号对时间的漂移,这由室温退火或周围环境退火引起,所以热波测量需要在离子注入后尽快进行。由激光束在测量期间引起的晶圆加热也会加速损伤松弛,这个松弛效应也会改变衬底的反射系数。测量过程将干扰被测数值,因此热波测量缺乏较高的测量准确性。许多因素将影响热波测量,例如离子束电流、离子束能量、晶圆图形及屏蔽氧化层的厚度。热波主要的优点是可以测量产品晶圆,其他的测量则无法做到。热波测量提供给工艺工程师一个有用的工具,通过离子注入后立刻测量产品晶圆进行工艺控制,从而可以避免其他工艺监测所需的长时间。
审核编辑:汤梓红
-
芯片离子注入后退火会引入的工艺问题2025-04-23 2496
-
离子注入工艺中的重要参数和监控手段2025-01-21 4452
-
离子注入的目的及退火过程2025-01-02 3097
-
SiC的离子注入工艺及其注意事项2024-11-09 2358
-
什么是离子注入?离子注入的应用介绍2024-02-21 8300
-
离子注入仿真用什么模型2023-12-21 2775
-
什么是离子注入?离子注入相对于扩散的优点?2023-12-11 8186
-
半导体离子注入工艺讲解2023-06-09 9822
-
离子注入工艺资料~还不错哦~2012-08-01 16461
-
离子注入的特点2011-05-22 5515
-
铒离子注入碳化硅后的射程分布和射程离散2010-04-22 2457
全部0条评论

快来发表一下你的评论吧 !

