

PCB分层的常见故障分析
PCB设计
描述
电子产品可靠性核心是印制电路板组件 PCBA(Printed Circuit Board Assembly),而印制电路板 PCB 作为各种元器件的载体与电路信号传输的枢纽已成为电子产品最重要、最关键的部件,其质量的好坏与可靠性水平将决定整机设备的质量与可靠性。
一、PCB分层起泡
IPC-A-610 标准已对分层起泡给出明确的定义。起泡:一种表现为层压基材的任何层与层之间,或基材与导电薄膜或保护性图层之间的局部膨胀与分离的分层形式;分层:印制板内基材的层间,基材与导电箔间或其它间的分离。
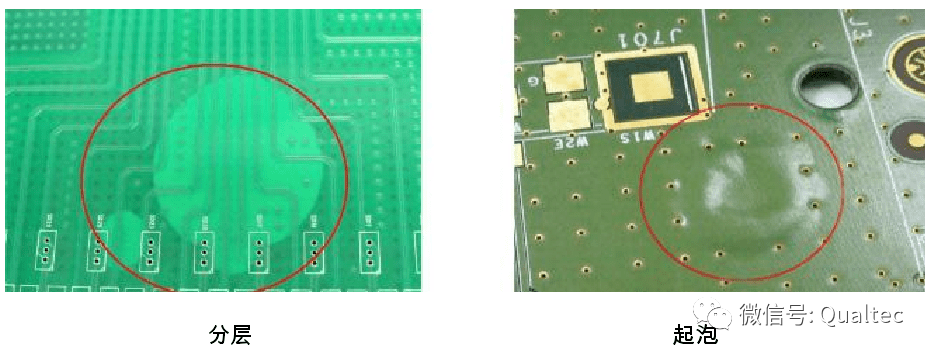
具体可参见上图,PCB分层在板表面的表征为出现“泛白”,而起泡的表征为出现“隆起”。
1.1 分层起泡的特性要因图
以下分析来源于厂内的失效案例总结,同时也收集了 PCB板厂的现场经验及时业内同行的分析数据。

1.2 分层起泡的失效分析流程

最后,特别强调,除非确定PCB受潮之外,不建议对PCB做不必要的烘烤动作,烘烤本身是一个“双刃剑”,一方面确实可以起到除湿作用,但其产生的负作用也不少,若烘烤温度、时间设置不当会加速其分层起泡的风险,同时 PCB 镀层也是一个考验,会加速镀层的氧化影响其焊接性,特别是OSP表面处理需谨慎处理。
二、PCB 内短缺陷
内短,即 PCB 电测时发现的内层短路,其缺陷发生在内层图转至多层压合这个过程,如下图所示,为内短切片的照片。表面上看,内层系统这个环节的制程很简单,但经过实际研究发现,产生内短的原因多种多样,甚至超出内层系统的制程,程度远远超出我们现象。
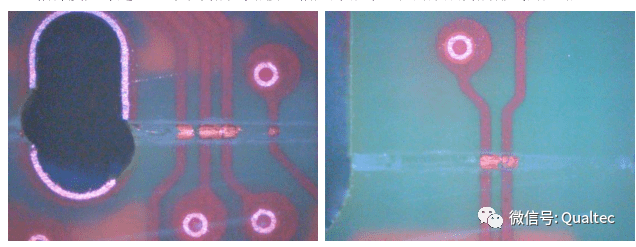
要想找到内短产生的原因,首先要掌握分析内短的方法,话句话说,要找到内层短路的位置。由于最终的成品板经过了压合、阻焊涂覆等工艺,我们不会一目了然的看到内层短路的位置,进而会通过一定手段去分析,具体分析流程如下:
(1)电测试找点:
电测试发现短路的产品,由找点人员通过找点软件和缺陷坐标找出短路位置,并在外层网络上进行指向标记
(2)网络分析
对找点后的产品进行网络分析,以找到内层短路位置,我们可通过工程数据处理软件(如 UCAM、GENESIS 等)对缺陷位置建立网络,从而找到内短所在层和位置
(3)平磨切片
将缺陷位置切片取样,并对切片进行平磨,磨至上面网络分析出的内短层面,如图 5 所示,最好不要将内短所在层面上的 PP 全部磨掉,以免破坏缺陷状态,影响对缺陷的判断。
三、PCB 爆板失效
爆板位置进行切片观察,发现芯板的铜箔和树脂之间发生分离,见下图。这种界面分离原因从两方面考虑:第一,焊接时基材受热膨胀过大;第二,两者界面本身的结合力弱,而造成两者结合力弱的原因比较复杂。

3.1 基材的热膨胀系数
对 PCB 基材的热膨胀系数(Z-CTE)和膨胀百分比(PTE)进行测试,结果显示 PCB 基材的α1-CTE 为 54.7 ppm/℃,α2-CTE 为 288.2 ppm/℃,PTE 为 3.95%。参考 IPC-4101C 规定对于一般 Tg 小于 150 ℃的 FR-4 基材,α1-CTE 应不大于 60 ppm/℃,α2-CTE 应不大于300 ppm/℃,PTE 不大于 4.0%。表明 PCB 焊接过程中膨胀在可接受的范围内。TMA 测试曲线如下图:

3.2 扫描电镜观察
剥开爆板位置,对基材和铜箔进行观察,发现铜箔一侧没有明显的树脂残留,而两者之间未发现污染,表明压合时树脂没有对铜箔形成良好的润湿。用扫描电镜对剥开的两侧进行观察,发现铜箔的表面处理存在问题。进一步对比失效批次和正常批次的芯板铜箔,发现两者之间存在明显差异,见下图。正常批次芯板的铜箔毛面铜瘤密度要大,铜面粗糙,失效批次的芯板铜箔毛面铜箔密度小,铜面光滑,这将降低铜箔和树脂之间的结合力。
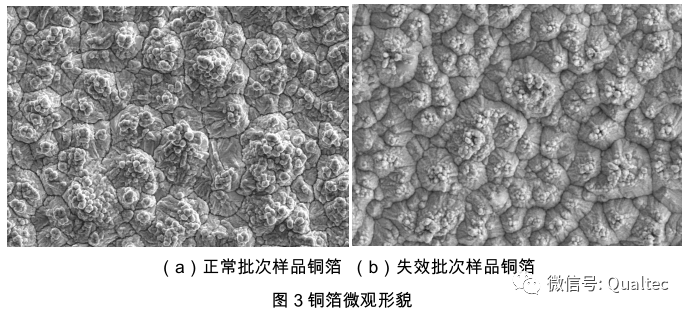
编辑:黄飞
-
中频炉常见故障分析2024-10-21 1166
-
电子管收音机常见故障分析2022-07-08 2083
-
直流稳压电源常见故障分析与排查2021-09-29 2775
-
电源常见故障现象2021-09-08 3448
-
分享三菱变频器常见故障分析与故障处理方法2021-09-03 11809
-
电动机常见故障分析及处理方法2017-02-07 1628
-
几款示波器常见故障分析与检修实例_下2016-05-05 1018
-
J2458示波器常见故障分析与维修2016-05-04 2143
-
冰淇淋机常见故障分析2015-10-29 1904
-
自动化设备常见故障分析2012-09-24 4684
-
网络设备常见故障分析2009-08-01 2058
全部0条评论

快来发表一下你的评论吧 !

