

深紫外光刻复杂照明光学系统设计
电子说
描述
摘要 :随着微电子产业的迅猛发展,我国迫切需要研制极大规模集成电路的加工设备-***。曝光波长为193nm的投影式***因其技术成熟、曝光线宽可延伸至32nm节点的优势已成为目前光刻领域的主流设备。照明系统是***的重要组成部分,其主要作用是提供高均匀性照明、控制曝光剂量和实现离轴照明,以提高光刻分辨率和增大焦深。论文以深紫外光刻照明系统光学设计为研究方向,对照明系统关键单元进行了光学设计与仿真研究。
首先,根据所用激光光源和照明区域特性,对照明系统的扩束单元、光束整形单元、匀光单元以及照明物镜四个关键部分的结构形式进行了分析研究,确定了照明系统总体方案。根据照明系统指标要求,计算了各单元的设计参数。
其次,对深紫外照明系统各单元进行了设计仿真,具体内容如下:
分析了激光光束特性,根据照明系统对光斑形状的要求,采用多组元平行反射镜扩束单元结构形式,有效降低了加工和装调难度。此外,为了提高照明均匀性,采用子光束叠加的方法,提出了非平行双反射镜扩束单元,这种结构使出射光束的均匀性提高了71.3%。
根据***对照明模式的要求,用几何光学方法设计了轴锥镜组,实现了环形照明和四极照明模式,优点是结构简单,部分相干因子可在要求的变化范围内任意调节。此外,从物理光学角度提出了基于平面波角谱理论的光束整形衍射元件的设计方法,实现了各种离轴照明模式。优点是有效降低了近场衍射的仿真误差。最后将衍射元件与轴锥镜组合构成了照明系统光束整形单元。
为了满足照明系统的高均匀性要求,设计了双排蝇眼透镜阵列和像方远心聚光镜组合的匀光单元,建模分析了各种照明模式的匀光效果,传统照明、环形照明和四极照明均匀性分别达到1.8%、3.0%和3.5%。
为了实现光瞳匹配和减小照明系统放大倍率误差以及半影效应,用CODEV设计了两种双远心结构照明物镜,第一种采用单一熔融石英透射材料,物方、像方远心度分别达到2.2mrad 和2.6mrad。第二种采用非球面透镜和氟化钙材料,化简了物镜结构,并采用了优化入射角度的方法降低了非球面照明物镜公差灵敏度。物方、像方远心度分别达到1.5mrad和1.9mrad。
最后,用LIGHTTOOLS软件对照明系统进行了贯穿仿真分析,结果表明传统照明、环形照明和四极照明模式下掩模面均匀性分别为2.2%、3.4%和 4%,掩模面上传统照明和离轴照明的远心度分别为2.6mrad和2.8mrad。
第1章 绪论
1.1 研究背景及意义
上世纪70年代出现的集成电路(Integrated Circuit, IC)在诞生之初主要用作信息处理执行器件。自出现至今短短几十年的时间里,受到社会信息化进程的强烈牵引,集成电路先后经历了小规模、超大规模直至极大规模等几个发展阶段,极大规模集成电路已经成为高技术领域发展的基石。从卫星、火箭等航空航天领域,到雷达、激光制导导弹等国防领域,以及人们日常生活的各个领域都离不开极大规模集成电路,它不仅是主要的信息处理器件,同时也发展成为信息存储的重要载体之一。体现信息存储能力的动态随机存储器(Dynamic Random Access Memory, DRAM)的存储容量与集成电路芯片最小特征线宽(Critical Dimension,CD)之间的关系如表 1-1 所示。由表可见,减小 CD 尺寸是提高存储能力的主要手段。新一代集成电路的出现,总是以光刻工艺实现更小的 CD 为主要标志。

表1-1信息存储容量与CD尺寸的关系
加工制造集成电路的设备很多,***是目前技术最成熟的设备。除了***,还有DNA技术将碳纳米管、硅纳米线等微小零部件集成到芯片上以实现比光刻设备加工的CD尺寸更小的集成电路的制备,该设备到2010年将能加工22nm以下节点的集成电路芯片,不过这种方法仍有许多技术瓶颈有待突破。
***所用的曝光波长与CD尺寸的大小有关,如表1-2所示,随着CD尺寸减小,要求曝光波长越来越短。根据最新国际半导体技术发展路线图(International Technology Roadmap for Semiconductors,ITRS)2009,光刻系统采用曝光波长为193nm的浸液单曝光技术已经能够加工45nm线宽的DRAM或微处理器单元(Micro processing unit, MPU),采用双曝光技术实现了32nm线宽集成电路芯片的制备。
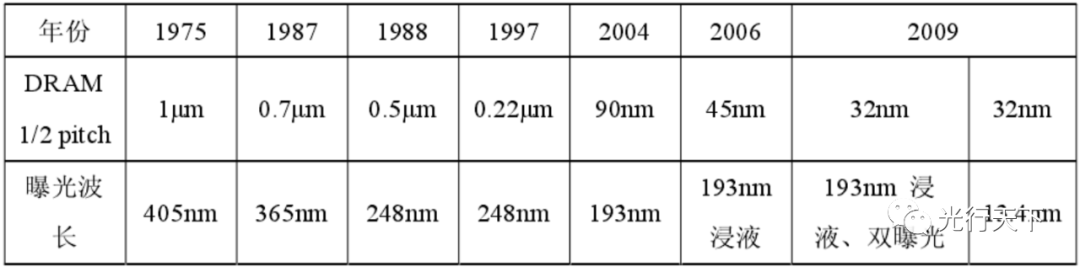
表1-2 CD尺寸与曝光波长的关系
***基本工作原理是:预先制备出集成电路芯片的母板-掩模板(mask)。在掩模板表面均匀镀一层金属铬,经过曝光、刻蚀和去除等工艺使掩模板上密布着集成电路线条图案。在待加工的硅片上均匀涂一层光刻胶。光源经由光刻照明系统均匀照射到掩模上,投影物镜将掩模板上的线条图案成像在硅片上。硅片上的入射光束与光刻胶发生化学反应,经过显影液的清洗,将发生反应的光刻胶去除,即可在硅片上得到掩模板集成电路线条图案,完成投影曝光。

图1-10 准分子激光光源照明系统示意图
......
第7章 总结与展望
论文在深入论证和分析了深紫外光刻照明系统的功能、基本组成和发展趋势之后,以深紫外光刻照明系统光学设计为研究方向,对照明系统关键单元进行了光学设计与仿真研究,这对我国开展 193nm 投影式***的研制具有重要意义。
本文以国际上90nm节点***常用的Cymer公司ArF准分子激光器为照明光源,根据对照明系统掩模面尺寸、照明均匀性以及各种离轴照明模式的要求,确定了照明系统总体设计方案,计算了各单元的设计参数,并对照明系统的关键技术单元进行了设计。
审核编辑:汤梓红
-
离轴光学系统的优势2025-02-12 1088
-
光学系统设计过程2024-01-23 1682
-
关于自由照明光学系统的简单了解2023-11-10 1247
-
基于离轴成像光学系统的设计2023-09-10 3705
-
折反式变形光学系统设计2023-08-30 1550
-
折衍射混合成像光学系统设计2023-07-02 2358
-
光学系统设计的不可忽略的参数介绍2023-06-19 806
-
光学系统设计的过程及要求2023-06-14 1177
-
光学系统设计流程2023-06-13 2172
-
高斯光学,理想的光学系统2021-06-01 6100
-
OCAD光学系统自动设计程序2020-03-23 2523
-
无限远光学系统优点2020-03-18 3066
-
光学自动设计及光学系统的分析2017-11-17 1538
-
切换变倍光学系统设计2010-04-26 2232
全部0条评论

快来发表一下你的评论吧 !

