

等离子体浸置型离子注入及等离子体掺杂系统介绍
描述
在常规离子注入中,三氟化硼常用于形成P型浅结的注入不是B,因为BF2+离子大且重。B10H14,B18H22和硼烷(C2B10&或CBH)是研究中的大分子。使用大分子形成USJ有几个好处。实现0.1keV高纯能量离子束非常具有挑战性,因为工程师需要将离子束加速到约5keV为磁质谱分析仪有效地隔离所需的离子种类,并通过4.9keV使离子束减速。加速和减速的电源电压要求非常准确和稳定,以获得统一的能量。
由于大分子明显更大且更重,它们需要比BF2+或B+离子更高的能量形成统一的结深。很容易使离子束实现1keV甚至更高的统一能量,而要实现0.1keV离子束的统一能量比较困难。包括许多硼原子的大分子,比如,CBH有10个硼原子,可以在相同的电子束电流下达到比BF2+或B+离子高10倍的产量。大分子离子注入也引起了更严重的晶格损伤,从而减少了隧道效应和更好的结面控制。
等离子体浸置型离子注入(PIII)或等离子体掺杂(PLAD)系统已经被开发应用于低能量、高剂量的场合,如USJ和深沟槽应用。通常用等离子体源功率产生高密度等离子体电离掺杂气体,而偏置电源加速离子到晶圆表面(见下图)。最常用的PLAD掺杂气体为B2H6,用于硼掺杂。等离子体源功率可以是射频(RF)或微波(MW)系统。它可以用非常高的剂量掺杂晶圆,即使在最高的电子束电流下,剂量也可以很高。
离子注入需要长的注入时间,从而不能满足产量的要求。PLAD不能选择离子种类并精确控制离子的流量或剂量,因此,PLAD的主要应用是高剂量、非关键层离子注入,已被广泛应用于DRAM芯片的多晶硅补偿掺杂,也可以用于DRAM器件阵列的接触注入。
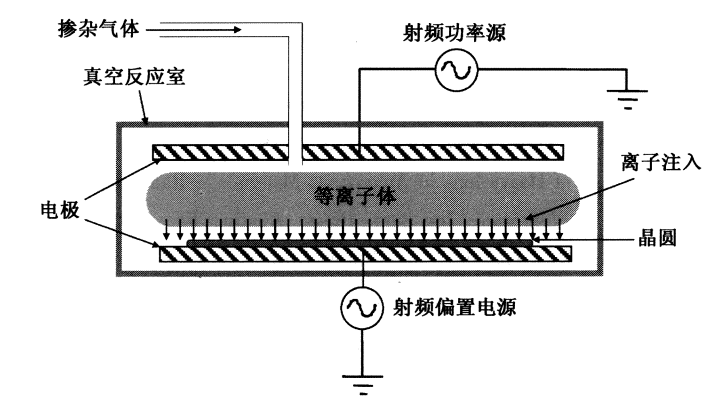
在等离子体浸置型系统中,掺杂离子将轰击晶圆并被注入到衬底内。掺杂离子流通量主要受微波功率控制,离子的能量主要由偏压的射频功率决定。通过磁铁的电流将影响共振的位置,因此可以用于控制等离子体的位置,从而便可以控制掺杂的均匀性。
等离子体浸置型注入技术是一种低能量过程,离子能量一般小于1keV,所以对于亚0.1um器件的应用,PIII可以用于形成超浅结。与标准离子注入技术相比,等离子体浸置系统的缺点是无法选择特殊的离子种类,其他的缺点为离子流量受等离子体位置和反应室压力的影响,而且离子能量分布范围很广,不是离子注入机的尖峰狭窄型分布,所以等离子体浸置型注入系统很难精确控制掺杂物的浓度和结深。
审核编辑:刘清
-
等离子的基本属性_等离子体如何发生2025-01-03 3524
-
等离子体清洗的原理与方法2024-11-29 2858
-
什么是电感耦合等离子体,电感耦合等离子体的发明历史2024-09-14 3732
-
等离子体清洗工艺的关键技术 等离子体清洗在封装生产中的应用2023-10-18 4292
-
低温等离子体技术的应用2023-02-27 2215
-
等离子体掺杂(Plasma Doping)2022-11-01 8526
-
等离子体应用2022-05-18 3859
-
TDK|低温等离子体技术的应用2022-05-17 3199
-
低温等离子体废气处理系统2022-04-21 12476
-
等离子体光谱仪的原理是什么?2019-10-09 3728
-
微波标量反射计可测量大范围的等离子体密度2019-06-10 1602
-
PCB电路板等离子体切割机蚀孔工艺技术2017-12-18 3194
-
等离子体源离子注入技术及其应用2011-05-22 1077
-
放电等离子体极紫外光源中的主脉冲电源2010-04-22 2092
全部0条评论

快来发表一下你的评论吧 !

